Summary
В этой статье описывается рост эпитаксиальных пленок Mg3N2 и N3N2 на субстратах MgO с помощью плазменной молекулярной лучейной эпитаксии с газом N2 в качестве источника азота и оптического мониторинга роста.
Abstract
В этой статье описывается процедура для выращивания Mg3N2 и N3N2 пленки плазменной молекулярной лучей эпитаксии (MBE). Пленки выращиваются на 100 ориентированных субстратах MgO с газом N2 в качестве источника азота. Описан метод подготовки субстратов и процесс роста MBE. Ориентация и кристаллический порядок субстрата и поверхности пленки контролируются отражением высокоэнергетической дифракции электронов (RHEED) до и во время роста. При росте поверхности образца измеряется зеркальная отражательная способность с длиной волны 488 нм. Устанавливая временной зависимости отражательной способности к математической модели, определяются рефракционный индекс, оптический коэффициент вымирания и темпы роста пленки. Металлические потоки измеряются независимо как функция температуры клеток выпота с помощью кварцевого кристаллического монитора. Типичные темпы роста составляют 0,028 нм/с при температуре роста 150 градусов по Цельсию и 330 градусов по Цельсию для Mg3N2 и N3N2 соответственно.
Introduction
Материалы II3-V2 представляют собой класс полупроводников, которым уделяется относительно мало внимания со стороны научно-исследовательского сообщества полупроводников по сравнению с III-V и II-VI полупроводниками1. Мг и N нитридов, Mg3N2 и N3N2, являются привлекательными для потребительских приложений, потому что они состоят из обильных и нетоксических элементов, что делает их недорогими и легко перерабатывать в отличие от большинства III-V и II-VI составных полупроводников. Они отображают анти-биксбит кристаллструктуры похож на caF2 структуры, с одним из взаимопроникающих fcc F-сублаттики время наполовину заняты2,3,4,5. Они оба прямыематериалы разрыва полосы 6, что делает их пригодными для оптических приложений7,8,9. Разрыв полосы Mg3N2 находится в видимом спектре (2,5 эВ)10, а разрыв полосыn 3N2 находится в ближнем инфракрасном (1,25 eV)11. Для изучения физических свойств этих материалов и их потенциала для применения электронных и оптических устройств, очень важно получить высококачественные, одиночные кристаллические пленки. Большая часть работы по этим материалам на сегодняшний день была проведена на порошках или поликристаллических пленках, сделанных реактивным распылением12,13,14,15,16, 17.
Молекулярная лучевая эпитаксия (MBE) является хорошо развитым и универсальным методом выращивания однокристаллических полупроводниковых пленок18, который может дать высококачественные материалы с использованием чистой окружающей среды и высококачественных элементарных источников. Между тем, быстрое действие затвора MBE позволяет изменять пленку в масштабе атомного слоя и позволяет точно контролировать толщину. В этой статье сообщается о росте Mg3N2 и N3N2 эпитаксиальных пленок на субстратах MgO плазменными MBE, используя высокую чистоту Зн и Мг в качестве источников пара и n2 газа в качестве источника азота.
Subscription Required. Please recommend JoVE to your librarian.
Protocol
1. Препарат субстрата MgO
ПРИМЕЧАНИЕ: Коммерческие односторонней эпи-полированный (100) ориентированных одного кристалла MgO квадратных субстратов (1 см х 1 см) были использованы для X3N2 (X q n и Mg) тонкий рост пленки.
- Высокая температура аннулирования
- Поместите MgO на чистую сапфировую пластину образца перевозчика с полированной стороны вверх в печи и anneal в течение 9 ч при 1000 градусов по Цельсию. Поднимите температуру до 1000 градусов по Цельсию в течение 10 мин.
ПРИМЕЧАНИЕ: Высокая температура аннулирования удаляет углерод с поверхности и реконструирует структуру кристалла поверхности одного кристалла MgO. - Охладите субстраты MgO до комнатной температуры (RT).
- Поместите MgO на чистую сапфировую пластину образца перевозчика с полированной стороны вверх в печи и anneal в течение 9 ч при 1000 градусов по Цельсию. Поднимите температуру до 1000 градусов по Цельсию в течение 10 мин.
- Очистка субстрата
- Соберите annealed субстраты MgO и промыть в деионизированной воде в чистом борозиликатном стеклянном стакане.
- Отварить субстраты MgO в 100 мл ацетона в 250 мл боросиликатного стеклянного стакана в течение 30 минут, чтобы удалить неорганическое загрязнение углерода от обработки.
ПРИМЕЧАНИЕ: Обложка стакан и не позволяют ацетон варить сухой. - Слейте ацетон и промыть MgO субстраты в 50 мл метанола.
- Blow-сухой субстраты с азотным газом, а затем хранить сухие, чистые субстраты в чистом подносе чипа.
2. Операция VG V80 MBE
- Откройте охлаждающую воду для камеры подготовки, криошруд на камере роста (см. Рисунок1), клетки выпота и датчик микробаланса кристаллического микробаланса кварца.
- Включите лазер Ar-ion с длиной волны 488 нм. Лазерный свет привозят в камеру MBE с оптическим волокном от лазера, который находится в другой комнате.
- Включите отражение высокоэнергетической электронной дифракционной пушки (RHEED), радиочастотного (рф) плазменного генератора 13,56 МГц и системы микробаланса кварцевого кристалла.
3. Загрузка субстрата
- Быстрый замок входа
- Установите чистый субстрат MgO на держатель образца молибдена(рисунок 2A) с помощью вольфрамовых весенних зажимов.
- Выключите турбонасос на быстром замке входа (FEL) и выветрите камеру FEL с азотом. Откройте FEL, когда давление камеры достигнет атмосферного давления.
- Удалите кассету держателя сэмплина из FEL и загрузите держатель образца субстратом в кассету.
- Загрузите кассету обратно в FEL и включите турбонасос обратно.
- Подождите, пока давление в FEL упадет до 10-6 Торр.
- Увеличьте температуру быстрого ввода до 100 градусов по Цельсию в течение 5 минут и дегазируйте субстраты с держателями в течение 30 минут в быстром замке входа.
- Убедитесь, что давление в быстром замке входа ниже 10-7 Торр перед открытием вакуумного клапана в камеру подготовки. Перенесите держатель с помощью механизма передачи вялой палочки в камеру подготовки, затем нарастите станцию дегазации до 400 градусов по Цельсию и дайте ей дегазоизвеемую передачу на 5 ч.
- Передача дегазированного держателя механизмом передачи тележки к манипулятору образца в камере роста. Увеличьте температуру субстрата до 750 градусов по Цельсию в течение 30 мин и дайте образцу перехиран в манипуляторе еще 30 мин. Убедитесь, что охлаждающая вода включена в криошруд, чтобы избежать перегрева криошруда.
- Сбросьте температуру субстрата до 150градусов по Цельсию для роста пленки 3 N2 и 330 градусов по Цельсию для роста пленки Mg3N2 с помощью термопары в манипуляторе образца для измерения температуры образца.
- На месте RHEED
- Установите напряжение на электрон пушки до 15 кВ и нити тока до 1,5 А, как только давление камеры роста ниже 1 х 10-7 Торр.
- Поверните держатель субстрата до 1) электронная пушка выровнена вдоль принципа кристаллографической оси субстрата и 2) ясно одиночная модель дифракции электрона одиночн.
- Сфотографировать шаблон RHEED и сохранить изображение.
- Закройте затвор на клетке выпота и остановите поток азота. Измерьте rHEED шаблон для отложенной пленки, когда давление камеры ниже 10-7 Торр.
4. Измерения потока металла
- Используйте стандартные клетки выпота типа группы III или клетки выпота низкой температуры для Mg и N.
- Загрузите тигли с 15 г и 25 г высокой чистоты Мг и Зн выстрел, соответственно.
- Когда камера роста достигла вакуума 10-8 Торр или лучше, и перед загрузкой держателя субстрата, outgas N или Mg источник выпота клетки до 250 градусов по Цельсию на рампе скоростью 20 кс / мин и позволяют ему outgas в течение 1 ч с ставнями закрыты.
- После того, как субстрат был загружен в образец манипулятора, тепло N и / или Mg выпотя клетки до 350 градусов по Цельсию или 390 градусов соответственно, на рампе скорость ю10 КС / мин, и ждать 10 минут для их стабилизации с ставнями закрыты.
- Используйте выдвижной кварцевый кристаллический монитор для измерения металлического потока. Расположите датчик кристалла кварца перед субстратом внутри камеры. Убедитесь, что субстрат полностью покрыт детектором, чтобы ни один металл не откладывался на субстрате.
- Ввиньте плотность металла интереса (зн ю 7,14 г/см3,Мг 1,74 г/см3) в кварцевый кристаллический монитор (ККМ) контроллер.
- Чтобы откалибровать поток, откройте затвор для одного из металлических источников и позвольте ячейке выпота насение на датчике. Система ККМ преобразует свое внутреннее измерение массы в толщину.
- Рассчитайте элементарный поток со склона увеличивающейся толщины в зависимости от времени, показанного на ККМ. Скорость увеличения толщины в течение нескольких минут пропорциональна элементарному потоку. В двух примерах получаются поток n 0,45 нм/с и поток Mg в 1,0 нм/с.
- Измените температуру клеток выпота и повторите шаг 4.8, если требуется температурная зависимость потока. Измеренная температурная зависимость потока Мг и Зн показана на рисунке 3 для данной специфической системы роста.
- Когда измерения потока будут завершены, закройте ставни на клетках выпота и удалите датчик кристалла кварца.
5. Азотная плазма
- Выключите нити тока и высокое напряжение на RHEED пушки для предотвращения повреждений в присутствии высокого n2 газового давления в камере роста.
- Откройте газовый клапан на цилиндре высокого давления N 2.
- Медленно откройте клапан утечки медленно, пока давление азота в камере роста не достигнет 3 х 10-5-4 х 10-5 Торр.
- Установите мощность плазменного генератора до 300 Вт.
- Воспламените плазму с помощью водоспламенера на источнике плазмы. Яркое фиолетовое свечение будет видно с поля зрения, когда плазма воспламеняется, как показано на рисунке 2B.
- Отрегулируйте управление на коробке сопоставления rf, чтобы максимально свести к минимуму отраженную мощность. Отраженная мощность менее 15 Вт хороша; в этом случае отраженная мощность уменьшается до 12 Вт.
6. На месте лазерного рассеяния света
- Сосредоточьте нарезанный 488 нм Аргона лазерный свет, отраженный от субстрата в камере роста на Si фотодиод так, что электрический сигнал может быть обнаружен усилителем блокировки. Это достигается путем регулировки угла субстрата путем вращения держателя подставки вокруг двух осей и регулировки положения детектора Si, а затем фокусировки объектива, который собирает отраженный свет, как показано на рисунке 4.
- Откройте затвор одного из металлических источников.
- Запись зависящей от времени отражательной способностью с помощью управляемого компьютером регистратора данных. Рост эпитаксиальной пленки будет производить колеблящие отраженный сигнал со временем, связанные с тонкой пленкой оптических помех между передней и задней поверхностями пленки.
- Чтобы защитить пленку от окисления в воздухе, депозит инкапсуляции слоя для защиты пленки от окисления в воздухе. Это особенно важно для Mg3N2, который быстро окисляется в воздухе.
- Для того, чтобы депонировать слой инкапсуляции MgO, закройте азотный газ, переключитесь на кислородный газ, повторите шаг 5.3 и увеличьте давление кислорода до 1 x 10-5 Torr.
- Установите мощность плазменного генератора до 250 Вт и повторите шаг 5.5. Плазма начинается с более низкой энергии рф с кислородным газом, чем с азотным газом.
- Откройте затвор на источнике Mg и повторите шаг 6.4 для 5-10 мин.
ПРИМЕЧАНИЕ: Это будет производить фильм MgO, что составляет около 10 нм толщиной. Uncapped Mg3N2 пленки желтые, но быстро исчезают до беловатого цвета в течение 20 с при воздействии воздуха. Следовательно, инкапсуляционный слой необходим, чтобы дать время для измерений на пленках, прежде чем они окисляются после удаления из вакуумной камеры. - Закройте газовые клапаны, выключите лазер и снизите температуру субстрата и клеток до 25 градусов по Цельсию за 30 минут.
- После нескольких пробежек, оптические окна становятся покрытыметаллом металла. Удалите металл, обернув окно в алюминиевую фольгу и нагревая его отопительной лентой до 400 градусов по Цельсию и скорость температуры рампы в размере 15 градусов по Цельсию/мин или медленнее в течение выходных.
7. Определение темпов роста
- Используйте уравнение 1 ниже, чтобы описать оптическую отражательную способность образца11,19.
 (1)
(1)
Где: (1 - a)
(1 - a) (1 - б)
(1 - б) (1 - c)
(1 - c) (1 - d)
(1 - d) - И где: n2 и 1,747 является рефракционным индексом субстрата MgO на длине волны 488 нм; 0 — это угол пучка, измеряемого в отношении нормальной поверхности субстрата; и т это время. Оптические константы пленки (n1 и k1) и темпы роста получаются путем установки отражательной функции времени в Уравнении 1.
Subscription Required. Please recommend JoVE to your librarian.
Representative Results
Черный объект в вузе на рисунке 5B представляет собой фотографию, как выросли 200 нм нн3N2 тонкой пленки. Аналогичным образом, желтый объект в вузе на рисунке 5C является как выросли 220 нм Mg3N2 тонкая пленка. В желтой пленке является прозрачным до такой степени, что это легко читать текст, размещенный за фильм10.
Поверхность субстрата и пленки были проверены на месте RHEED. На рисунке 5A показана rHEED-модель голого субстрата с инцидентом электронного луча вдоль направления субстрата . RHEED модели для депонированных пленок на рисунке 5B,C показывают, что кристаллические решетки N3N2 и Mg3N2 тонкие пленки ориентированы в плоскости поверхности субстрата, как и ожидалось в случае эпитаксиальных Роста. Недостатком RHEED для мониторинга роста в условиях, используемых здесь является то, что процесс роста должен быть остановлен, чтобы давление упадет до 10-7 Торр и включить электрон пистолет.
В отличие от RHEED, на месте оптические измерения отражения не зависят от давления в камере. Для получения темпов роста, на месте оптическая отражательная способность была подтянута в качестве функции времени, показанной на рисунке 6 с помощью уравнения 1. В этом уравнении время роста t является независимой переменной, а оптические константы пленки (n1, k1)и темпы роста являются подходящими параметрами. На рисунке 6индекс рефракции подстрата MgO, угол падения и длина волны n2 и 1,747, 0 и 36,5 и 488 нм соответственно. Установленный рефракционный индекс пленки n1 и 2,65, коэффициент вымирания составляет k1 и 0,54, а темпы роста - 0,031 нм/с для тонкой пленки N3N2, как показано на рисунке 6A. Аналогичным образом, наиболее подходящим рефракционным индексом для пленки Mg3N2 является n1 и 2,4, коэффициент вымирания составляет k1 и 0,09, а темпы роста - 0,033 нм/с, как показано на рисунке 6B. Общее снижение спекулятивного отражения со временем на рисунке 6B, как полагают, вызвано увеличением поверхности шероховатости рассеяния, как Mg3N2 тонкая пленка становится толще. Эффект рассеяния шероховатостей был смоделирован путем умножения рассчитанной отражательной способностью с разлагающейся экспоненциальной, e-t , где 810-5 s-1 и время роста t измеряется в секундах.
При воздействии воздуха, непокрытые желтые пленки Mg3N2 исчезли в течение нескольких минут до полупрозрачного белого цвета. С другой стороны, Mg3N2 фильмы, которые были ограничены MgO были относительно стабильными. Для дальнейшей защиты пленки Mg3N2 от окисления, гетероструктуры Mg3N2/MgO были покрыты слоем CaF2, отложенным электронным пучком испарения. Необнаруженный N3N2 более стабилен; тем не менее, первоначально черный N3N2 пленки также окисляется с течением времени и поседел в течение нескольких месяцев. Реакция окисления, как полагают, связаны с образованием гидроксида магния и высвобождение аммиака в соответствии со следующей химической реакции20. Слой ЗНО, отложенный с помощью аналогичного метода MgO, также может быть использован в качестве защитного слоя для предотвращения окисления.
Mg3N2 6H2O 3Mg (OH)2

Рисунок 1 : Вид на молекулярную пучок V80H камеры роста эпитаксии. На этом снимке показана камера роста MBE с (по часовой стрелке) RHEED экран и корпус камеры, четырехполюсный остаточный анализатор газа, оптическое оборудование на лазерном рескенте, ячейка выпота Mg, N-плазма источник, rf сопрягая коробка, и клетка выпота n. Пожалуйста, нажмите здесь, чтобы просмотреть большую версию этой цифры.

Рисунок 2 : Держатель субстрата и свечение от источника плазмы. (A) Molybdenum образец держателя пластины с двумя вольфрама проволоки клипы проведения квадратного подбора MgO на месте. (B) Фиолетовое свечение, возникающее из задней окне источника плазмы при работе с газом N2. Пожалуйста, нажмите здесь, чтобы просмотреть большую версию этой цифры.
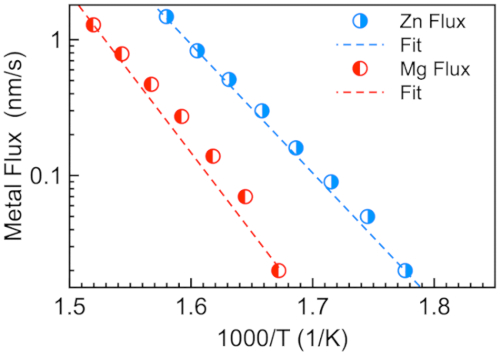
Рисунок 3 : Металлический поток как функция температуры клеток выпота. Линии подходят для температурной зависимости металлических потоков с использованием отношения Arrhenius, как обсующееся в тексте. Пожалуйста, нажмите здесь, чтобы просмотреть большую версию этой цифры.

Рисунок 4 : Схема установки лазерного рассеяния света на месте. Пожалуйста, нажмите здесь, чтобы просмотреть большую версию этой цифры.

Рисунок 5 : RHEED шаблоны. (A) RHEED дифракционный шаблон для субстрата MgO. (B) RHEED шаблон, как-выросшийN 3N2 фильм с фотографией черного N3N2 пленки. (C) RHEED шаблон как-выросmg3N2 субстрата с фотографией желтого Mg3N2 пленки. Пожалуйста, нажмите здесь, чтобы просмотреть большую версию этой цифры.

Рисунок 6 : На месте зеркальная отражательная способность. На situ specular отражающая способность на 488 нм (A) N3N2 и (B) Mg3N2 пленки во время роста. Рассчитанная отражательная способность (красная линия) лучше всего подходит для экспериментальных данных (синих кругов), как это обсуждается в тексте. Пожалуйста, нажмите здесь, чтобы просмотреть большую версию этой цифры.
Subscription Required. Please recommend JoVE to your librarian.
Discussion
Разнообразие соображений связано с выбором субстратов и созданием условий роста, которые оптимизируют структурные и электронные свойства пленок. Субстраты MgO нагреваются при высокой температуре воздуха (1000 градусов по Цельсию) для удаления загрязнения углерода с поверхности и улучшения кристаллического порядка на поверхности субстрата. Ультразвуковая очистка ацетона является хорошим альтернативным методом очистки субстратов MgO.
Пик рентгеновской дифракции для пленок N3N2 был признан более узким, когда пленка была выращена на высокотемпературных, annealed субстратах MgO по сравнению с тем, когда выращенные на незапечатанных субстратах. Решетка константа MgO (0,421 нм) значительно меньше, чем (половина) решетки константаN 3N2 (0,976 нм) или Mg3N2 (0,995 нм) и не очень хорошо соответствует полупроводниковых пленок. Решетки константы коммерчески доступных групп IV, III-V, и II-VI субстраты все больше, чем решетки константы Mg3N2 и N3N2. Более хорошо подобранные субстрат желательно. Кремний, который имеет решетку константа 0,543 нм, несколько более хорошо соответствует Mg3N2, чем MgO и стоит быть изучены. ПленкиN 3N2 также были выращены на сапфировых субстратах A-plane. Структурное качество этих пленок было не так хорошо, как в субстратах MgO, как указано на RHEED пятна и ширина (400) N3N2 рентгеновского пика дифракции. В случае сапфировых субстратов задняя сторона была покрыта Cr (50 нм) и Mo (200 нм) для улучшения теплового соединения между держателем субстрата и субстратом.
Температура субстрата измеряется при росте с термопарой, расположенной в замкнутом вакуумном пространстве между держателем субстрата и нагревателем, и она не находится в физическом контакте с держателем субстрата или субстратом. В результате ожидалось, что фактическая температура субстрата будет ниже, чем температура датчика. Успешные наросты Mg3N2 и N3N2 были получены с термопараций температуры в диапазоне 300-350 градусов по Цельсию и 140-180 градусов по Цельсию, соответственно.
Высокая температура роста повышает подвижность ад-атомов на растущей поверхности и может ожидать, что материал будет производиться с меньшим количеством структурных дефектов. Однако при высоких температурах субстрата темпы роста ниже, что истолковывается как повторное испарение атомов металла с поверхности. При высоком потоке металла темпы роста пленки ограничены поставками активного азота. Активный азот максимизируется при высокой мощности rf, применяемой к источнику плазмы (300 Вт макс) и при высокой скорости потока азота. Скорость потока N2 ограничена максимальным давлением в камере роста, которая в данном случае находилась в середине диапазона 10-5 Torr. Аммиак является возможным альтернативным источником азота. Мг и Зн будут реагировать с NH3 при высокой температуре без активации плазмы; однако, неясно, будет ли время пребывания атомов Mg и N на поверхности достаточно долго, чтобы поддерживать рост пленки при температурах, для которых NH3 будет реагировать с металлами.
В этих экспериментах, клетки выпота были использованы с пиролитическим итридом бора (PBN) тигли с емкостью 40 cc для Mg и 25 cc для n. Рисунок 3 показывает температурную зависимость мг и n fluxes от клеток выпота. Прямые линии на рисунке 3 подходят к измеренной температурной зависимости потоков. Пригонки имеют форму Flux - A exp(-B/kT), а параметры установки (A,B) являются (8,5 х 1017 нм/с, 2,3 эВ) и (1,3 х 1015 нм/с, 1,9 эВ) для источников Mg и n, соответственно. Поток приблизительно удваивается с каждым 10 и 12 градусами по Цельсию, что повышает температуру клеток выпота для Мг и Зн, соответственно. Для роста, иллюстрированного на рисунке 6, металлические потоки были вблизи максимы на рисунке 3 (1 нм/с с потоком Mg выше, чем поток N), но темпы роста пленки были только 0,03 нм/с. Это показывает, что эффективность использования металла низка, при этом Mg ниже, чем в N, и большая часть металла переисовывается.
Высокое давление N2 фонового фона во время роста исключает непрерывный мониторинг роста пленки с Помощью RHEED. Дифференциальная накачка RHEED пушки может решить эту проблему. На месте оптические измерения отражения служат дополнительным инструментом мониторинга, который не зависит от давления газа и обеспечивает точную и надежную технику для определения темпов роста. Не-спекулятивной или диффузной отражающей способностью субстрата также может быть измерена на месте и предоставит информацию о поверхностных шероховатостей во время роста.
Базовое давление в камере роста MBE составляет 10-8 Торр с N2 газ выключен. Криошруд в камере роста охлаждается водой во время роста пленки. В этих условиях, некоторые остаточное загрязнение кислорода можно ожидать в пленках. Остаточная давление водяного пара в камере роста может быть уменьшена при более низкой температуре охлаждающей жидкости в саване, таких как силиконовое масло при -80 C21.
В заключение, этот протокол описывает, как вырастить одиночные кристаллические пленки Mg3N2 и N3N2 плазменным молекулярным лучом эпитаксии и содержит предложения о том, как процесс роста может быть изменен для дальнейшего улучшения пленки Качество. Эти материалы не показали фотолюминесценции при комнатной температуре или низкой температуре. Необходимо еще больше снизить плотность дефектов в пленках. Мг3N2-N3N2 сплавы также могут быть выращены плазменной молекулярной лучей эпитаксии.
Subscription Required. Please recommend JoVE to your librarian.
Disclosures
Авторам нечего раскрывать.
Acknowledgments
Эта работа была поддержана Советом по естественным наукам и инженерным исследованиям Канады.
Materials
| Name | Company | Catalog Number | Comments |
| (100) MgO | University Wafer | 214018 | one side epi-polished |
| Acetone | Fisher Chemical | 170239 | 99.8% |
| Argon laser | Lexel Laser | 00-137-124 | 488 nm visible wavelength, 350 mW output power |
| Chopper | Stanford Research system | SR540 | Max. Frequency: 3.7 kHz |
| Lock-in amplifier | Stanford Research system | 37909 | DSP SR810, Max. Frequency: 100 kHz |
| Magnesium | UMC | MG6P5 | 99.9999% |
| MBE system | VG Semicon | V80H0016-2 SHT 1 | V80H-10 |
| Methanol | Alfa Aesar | L30U027 | Semi-grade 99.9% |
| Nitrogen | Praxair | 402219501 | 99.998% |
| Oxygen | Linde Gas | 200-14-00067 | > 99.9999% |
| Plasma source | SVT Associates | SVTA-RF-4.5PBN | PBN, 0.11" Aperture, Specify Length: 12" – 20" |
| Si photodiode | Newport | 2718 | 818-UV Enhanced, 200 - 1100 nm |
| Zinc | Alfa Aesar | 7440-66-6 | 99.9999% |
References
- Suda, T., Kakishita, K. Band-gap energy and electron effective mass of polycrystalline Zn3N2. Journal of Applied Physics. 99 (7), 076101.1-076101.3 (2006).
- Hu, J., Bando, Y., Zhan, J., Zhi, C., Golberg, D. Carbon nanotubes as nanoreactors for fabrication of single-crystalline Mg3N2 nanowires. Nano Letters. 6 (6), 1136-1140 (2006).
- Fang, C. M., Groot, R. A., Bruls, R. J., Hintzen, H. T., With, G. Ab initio band structure calculations of Mg3N2 and MgSiN2. Journal of Physics: Condensed Matter. 11 (25), 4833-4842 (1999).
- Yoo, S. H., Walsh, A., Scanlonc, D. O., Soon, A. Electronic structure and band alignment of zinc nitride, Zn3N2. RSC Advances. 4 (7), 3306-3311 (2014).
- Partin, D. E., Williams, D. J., O'Keeffe, M. The crystal structures of Mg3N2 and Zn3N2. Journal of Solid-State Chemistry. 132 (1), 56-59 (1997).
- Ullah, M., Murtaza, G., Ramay, S. M., Mahmood, A. Structural, electronic, optical and thermoelectric properties of Mg3X2 (X = N, P, As, Sb, Bi) compounds. Materials Research Bulletin. 91, 22-30 (2017).
- Li, C. T. Electrocatalytic zinc composites as the efficient counter electrodes of dye-sensitized solar cells: study on the electrochemical performance and density functional theory Calculations. ACS Applied Materials & Interfaces. 7 (51), 28254-28263 (2015).
- Sinha, S., Choudhury, D., Rajaraman, G., Sarkar, S. Atomic layer deposition of Zn3N2 thin films: growth mechanism and application in thin film transistor. RSC Advances. 5 (29), 22712-22717 (2015).
- Bhattacharyya, S. R., Ayouchi, R., Pinnisch, M., Schwarz, R. Transfer characteristic of zinc nitride based thin film transistors. Physica Status Solidi C. 9 (3-4), 469-472 (2012).
- Wu, P., Tiedje, T. Molecular beam epitaxy growth and optical properties of Mg3N2 films. Applied Physics Letters. 113 (8), 082101.1-082101.4 (2018).
- Wu, P., et al. Molecular beam epitaxy growth and optical properties of single crystal Zn3N2 films. Semiconductor Science and Technology. 31 (10), 10LT01.1-10LT01.4 (2016).
- Jiang, N., Georgiev, D. G., Jayatissa, A. H. The effects of the pressure and the oxygen content of the sputtering gas on the structure and the properties of zinc oxy-nitride thin films deposited by reactive sputtering of zinc. Semiconductor Science and Technology. 28 (2), 025009 (2013).
- Nakano, Y., Morikawa, T., Ohwaki, T., Taga, Y. Electrical characterization of p-type N-doped ZnO films prepared by thermal oxidation of sputtered Zn3N2 films. Applied Physics Letters. 88 (17), 172103.1-172103.3 (2006).
- Cao, X., Yamaguchi, Y., Ninomiya, Y., Yamada, N. Comparative study of electron transport mechanisms in epitaxial and polycrystalline zinc nitride films. Journal of Applied Physics. 119 (2), 025104.1-025104.10 (2016).
- Jia, J., Kamijo, H., Nakamura, S., Shigesato, Y. How the sputtering process influence structural, optical, and electrical properties of Zn3N2 films. MRS Communications. 8 (2), 314-321 (2018).
- Trapalis, A., Hefferman, J., Farrer, I., Sherman, J., Kean, A. Structural, electrical and optical characterization of as-grown and oxidized zinc nitride films. Journal of Applied Physics. 120 (20), 205102.1-205102.9 (2016).
- Núñez, C. G., et al. On the zinc nitride properties and the unintentional incorporation of oxygen. Thin Solid Films. 520 (6), 1924-1929 (2012).
- Oshima, T., Fujita, S. (111)-oriented Zn3N2 growth on a-plane sapphire substrates by molecular beam epitaxy. Japanese Journal of Applied Physics. 45 (111), 8653-8655 (2006).
- Heavens, O. S. Optical properties of thin solid films. , Butterworth, London. 46-48 (1955).
- Heyns, A. H., Prinsloo, L. C., Range, K. J., Stassen, M. The vibrational spectra and decomposition of α-calcium nitride (α-Ca3N2) and magnesium nitride (Mg3N2). Journal of Solid-State Chemistry. 137, 33-41 (1998).
- Lewis, R. B., Bahrami-Yekta, V., Patel, M. J., Tiedje, T., Masnadi-Shirazi, M. Closed-cycle cooling of cryopanels in molecular beam epitaxy. Journal of Vacuum Science Technology B. 32 (2), 02C102.1-02C102.7 (2014).



 (1)
(1) (1 - a)
(1 - a) (1 - б)
(1 - б) (1 - c)
(1 - c) (1 - d)
(1 - d)