Summary
Cet article décrit la croissance des films épitaxiaux de Mg3N2 et Zn3N2 sur les substrats MgO par épitaxie de faisceau moléculaire assistée par plasma avec le gaz N2 comme source d'azote et surveillance optique de la croissance.
Abstract
Cet article décrit une procédure pour la croissance mg3N2 et Zn3N2 films par épitaxie de faisceau moléculaire plasma-assistée (MBE). Les films sont cultivés sur 100 substrats MgO orientés avec du gaz N2 comme source d'azote. La méthode de préparation des substrats et le processus de croissance du MBE sont décrits. L'orientation et l'ordre cristallin du substrat et de la surface du film sont surveillés par la diffraction d'électron savante de réflexion (RHEED) avant et pendant la croissance. La réflectivité spéculaire de la surface de l'échantillon est mesurée pendant la croissance avec un laser Ar-ion d'une longueur d'onde de 488 nm. En adaptant la dépendance temporelle de la réflectivité à un modèle mathématique, l'indice de réfraction, le coefficient d'extinction optique et le taux de croissance du film sont déterminés. Les flux métalliques sont mesurés indépendamment en fonction de la température des cellules d'épanchement à l'aide d'un moniteur en cristal de quartz. Les taux de croissance typiques sont de 0,028 nm/s à des températures de croissance de 150 oC et de 330 oC pour les films Mg3N2 et Zn3N2, respectivement.
Introduction
Lesmatériaux II 3-V2 sont une classe de semi-conducteurs qui ont reçu relativement peu d'attention de la communauté de la recherche sur les semi-conducteurs par rapport aux semi-conducteurs III-V et II-VI1. Les nitrides Mg et Zn, Mg3N2 et Zn3N2, sont attrayants pour les applications grand public car ils sont composés d'éléments abondants et non toxiques, ce qui les rend peu coûteux et faciles à recycler contrairement à la plupart des III-V et II-VI semi-conducteurs composés. Ils affichent une structure cristalline anti-bixbyite similaire à la structure CaF2, avec l'un des interpénétrant fcc F-sublattices étant à moitié occupé2,3,4,5. Ils sont tous deux des matériaux d'écart de bande directe6, les rendant appropriés pour des applications optiques7,8,9. L'écart de bande de Mg3N2 est dans le spectre visible (2.5 eV)10, et l'écart de bande de Zn3N2 est dans le proche infrarouge (1.25 eV)11. Pour explorer les propriétés physiques de ces matériaux et leur potentiel pour les applications électroniques et optiques, il est essentiel d'obtenir des films en cristal unique de haute qualité. La plupart des travaux sur ces matériaux à ce jour a été effectué sur des poudres ou des films polycrystalline réalisés par pulvérisation réactive12,13,14,15,16, 17.
L'épitaxie moléculaire (MBE) est une méthode bien développée et polyvalente pour la culture de films semi-conducteurs composés à cristaux simples18 qui a le potentiel de produire des matériaux de haute qualité en utilisant un environnement propre et des sources élémentaires de haute pureté. Pendant ce temps, l'action rapide d'obturation de MBE permet des changements à un film à l'échelle de couche atomique et permet le contrôle précis d'épaisseur. Cet article rend compte de la croissance des films épitaxiaux Mg3N2 et Zn3N2 sur les substrats MgO par MBE assisté par plasma, en utilisant la haute pureté Zn et Mg comme sources de vapeur et n2 gaz comme source d'azote.
Subscription Required. Please recommend JoVE to your librarian.
Protocol
1. Préparation du substrat MgO
REMARQUE : Des substrats carrés simples mgO à cristaux uniques orientés d'un côté commercial (100) (1 cm x 1 cm) ont été utilisés pour la croissance du film mince X3N2 (X et Zn et Mg).
- Annexion à haute température
- Placer le MgO sur un support d'échantillon de gaufrettes de saphir propre avec le côté poli tourné vers le haut dans un four et anneal pendant 9 h à 1 000 oC. Augmenter la température à 1000 oC sur une période de 10 min.
REMARQUE : L'annealing à haute température élimine le carbone de la surface et reconstruit la structure cristalline de surface des substrats de cristal unique mgO. - Refroidir les substrats MgO à la température ambiante (RT).
- Placer le MgO sur un support d'échantillon de gaufrettes de saphir propre avec le côté poli tourné vers le haut dans un four et anneal pendant 9 h à 1 000 oC. Augmenter la température à 1000 oC sur une période de 10 min.
- Nettoyage du substrat
- Recueillir les substrats De MgO annealed et rincer à l'eau déionisée dans un bécher en verre borosilicate propre.
- Faire bouillir les substrats MgO dans 100 ml d'acétone dans un bécher en verre borosilicate de 250 ml pendant 30 min pour éliminer la contamination par le carbone inorganique de la manipulation.
REMARQUE : Couvrez le bécher et ne laissez pas l'acétone bouillir à sec. - Égoutter l'acétone et rincer les substrats MgO dans 50 ml de méthanol.
- Séchez les substrats avec du gaz azoté, puis rangez les substrats secs et propres dans le bac à copeaux propre.
2. Opération de VG V80 MBE
- Ouvrez l'eau de refroidissement pour la chambre de préparation, cryoshroud sur la chambre de croissance (voir Figure 1), cellules d'effusion, et capteur de microbalance de cristal de quartz.
- Allumez le laser Ar-ion avec une longueur d'onde de 488 nm. La lumière laser est apportée à la chambre MBE avec une fibre optique du laser, qui est situé dans une autre pièce.
- Allumez le pistolet de diffraction d'électron à haute énergie de réflexion (RHEED), le générateur de plasma de fréquence radio de 13.56 Mhz (rf) et le système de microbalance de cristal de quartz (QCM).
3. Chargement de substrat
- Verrouillage d'entrée rapide
- Monter un substrat MgO propre sur le porte-échantillons de molybdène (Figure 2A) à l'aide d'agrafes à ressorts de tungstène.
- Éteignez la pompe turbo sur la serrure d'entrée rapide (FEL) et éventez la chambre FEL avec de l'azote. Ouvrez le FEL lorsque la pression de la chambre atteint la pression atmosphérique.
- Retirez la cassette du porte-échantillonneur de la FEL et chargez le porte-échantillon avec le substrat dans la cassette.
- Chargez la cassette dans le FEL et rallumez la pompe turbo.
- Attendez que la pression dans le FEL tombe à 10-6 Torr.
- Augmenter la température de la serrure d'entrée rapide à 100 oC sur une période de 5 min et dégazer les substrats avec les supports pendant 30 min dans la serrure d'entrée rapide.
- Assurez-vous que la pression dans le verrou d'entrée rapide est inférieure à 10-7 Torr avant d'ouvrir la soupape à vide à la chambre de préparation. Transférer le support à l'aide du mécanisme de transfert de bâton de oscillation à la chambre de préparation, puis monter la station de dégazage à 400 oC et lui permettre de se dégazer pendant 5 h.
- Transférer le support dégazé par le mécanisme de transfert de chariot au manipulateur d'échantillon dans la chambre de croissance. Augmenter la température du substrat jusqu'à 750 oC sur une période de 30 min et permettre à l'échantillon de dégazer dans le manipulateur pendant 30 min. Assurez-vous que l'eau de refroidissement est allumée dans le cryoshroud pour éviter la surchauffe du cryoshroud.
- Baisser la température du substrat à 150 oC pour la croissance du film Zn3N2 et à 330 oC pour la croissance du film Mg3N2 à l'aide du thermocouple dans le manipulateur de l'échantillon pour mesurer la température de l'échantillon.
- RHEED in situ
- Fixez la tension sur le canon à électrons à 15 kV et le courant de filament à 1,5 A une fois que la pression de la chambre de croissance est inférieure à 1 x 10-7 Torr.
- Faire pivoter le support du substrat jusqu'à 1) le canon à électrons est aligné le long d'un axe cristallographique principal du substrat et 2) un modèle clair de diffraction d'électron de cristal unique est visible.
- Prenez une photo du motif RHEED et enregistrez l'image.
- Fermez l'obturateur sur la cellule d'épanchement et arrêtez le flux d'azote. Mesurez le motif RHEED pour le film déposé lorsque la pression de la chambre est inférieure à 10-7 Torr.
4. Mesures de flux métalliques
- Utilisez des cellules d'épanchement de type type III standard ou des cellules d'épanchement à basse température pour Mg et Zn.
- Chargez les creusets avec 15 g et 25 g de tir de haute pureté Mg et Zn, respectivement.
- Lorsque la chambre de croissance a atteint un vide de 10-8 Torr ou mieux, et avant de charger le support de substrat, dégaze les cellules d'épanchement de source Zn ou Mg jusqu'à 250 oC à un taux de rampe de 20 oC/min et lui permettre de dégazer pendant 1 h avec les volets fermés.
- Une fois que le substrat a été chargé dans le manipulateur de l'échantillon, chauffer les cellules d'épanchement Zn et/ou Mg à 350 oC ou 390 oC respectivement, à un taux de rampe de 10 oC/min, et attendre 10 min pour qu'elles se stabilisent avec les volets fermés.
- Utilisez le moniteur de cristal de quartz rétractable pour mesurer le flux métallique. Placez le capteur de cristal de quartz devant le substrat à l'intérieur de la chambre. Assurez-vous que le substrat est entièrement recouvert par le détecteur afin qu'aucun métal ne soit déposé sur le substrat.
- Entrez la densité du métal d'intérêt (zn à 7,14 g/cm3,mg 1,74 g/cm3) dans le contrôleur de quartz cristallin (QCM).
- Pour calibrer le flux, ouvrez l'obturateur pour l'une des sources métalliques et permettez à la cellule d'effusion de se déposer sur le capteur. Le système QCM convertit sa mesure interne de la masse en épaisseur.
- Calculez le flux élémentaire à partir de la pente de l'épaisseur croissante en fonction du temps indiqué sur le QCM. Le taux d'augmentation de l'épaisseur sur quelques minutes est proportionnel au flux élémentaire. Dans deux cas d'exemple, un flux Zn de 0,45 nm/s et un flux Mg de 1,0 nm/s sont obtenus.
- Modifier la température des cellules d'épanchement et répéter l'étape 4.8 si la dépendance à la température du flux est nécessaire. La dépendance à la température mesurée du flux Mg et Zn est indiquée à la figure 3 pour ce système de croissance spécifique.
- Lorsque les mesures de flux sont terminées, fermez les volets des cellules d'épanchement et rétractez le capteur de cristal de quartz.
5. Plasma d'azote
- Éteignez le courant de filament et la haute tension du canon RHEED pour éviter les dommages en présence d'une pression de gaz Élevée N2 dans la chambre de croissance.
- Ouvrez la soupape de gaz sur le cylindre N2 à haute pression.
- Ouvrez lentement la soupape de fuite lentement jusqu'à ce que la pression d'azote dans la chambre de croissance atteigne 3 x 10-5-4 x 10-5 Torr.
- Définir la puissance du générateur de plasma à 300 W.
- Allumez le plasma avec l'allumage sur la source plasmatique. Une lueur violette vive sera visible à partir du port de vision lorsque le plasma s'enflamme, comme le montre la figure 2B.
- Ajuster le contrôle sur la boîte d'appariement rf pour minimiser la puissance réfléchie autant que possible. Une puissance réfléchie de moins de 15 W est bonne; dans ce cas, la puissance réfléchie est réduite à 12 W.
6. Diffusion in situ de lumière laser
- Concentrez la lumière laser Argon hachée de 488 nm réfléchie par le substrat de la chambre de croissance sur le photodiode Si afin qu'un signal électrique puisse être détecté par l'amplificateur de verrouillage. Ceci est accompli en ajustant l'angle du substrat en tournant le support de substrat autour de deux axes et en ajustant la position du détecteur Si, puis en concentrant la lentille qui recueille la lumière réfléchie comme indiqué dans la figure 4.
- Ouvrez l'obturateur d'une des sources métalliques.
- Enregistrez la réflectivité dépendante du temps avec un enregistreur de données contrôlé par ordinateur. La croissance d'un film épitaxial produira un signal réfléchi oscillatoire avec le temps associé à l'interférence optique mince de film entre les surfaces avant et arrière du film.
- Pour protéger le film de l'oxydation dans l'air, déposez une couche d'encapsulation pour protéger le film de l'oxydation dans l'air. Ceci est particulièrement important pour Mg3N2 qui s'oxyde rapidement dans l'air.
- Afin de déposer une couche d'encapsulation MgO, fermer le gaz azoté, passer au gaz d'oxygène, répéter l'étape 5.3, et augmenter la pression d'oxygène à 1 x 10-5 Torr.
- Définir la puissance du générateur de plasma à 250 W et répéter l'étape 5.5. Le plasma commence à une puissance rf inférieure avec du gaz d'oxygène qu'avec le gaz azoté.
- Ouvrez l'obturateur sur la source Mg, et répétez l'étape 6.4 pendant 5-10 min.
REMARQUE: Cela produira un film MgO qui est d'environ 10 nm d'épaisseur. Les films Mg3N2 non plafonnés sont jaunes mais s'estompent rapidement pour atteindre une couleur blanchâtre dans les 20 s lors de l'exposition à l'air. Par conséquent, une couche d'encapsulation est nécessaire pour laisser le temps pour les mesures sur les films avant qu'ils ne s'oxydent après le retrait de la chambre à vide. - Fermez les soupapes de gaz, éteignez le laser et descendez le substrat et la température des cellules jusqu'à 25 oC en 30 min. Éteignez l'eau de refroidissement et l'alimentation de la source plasmatique.
- Après plusieurs courses de croissance, les fenêtres optiques deviennent couvertes de métal. Retirez le métal en enveloppant la fenêtre dans du papier d'aluminium et en le chauffant avec du ruban chauffant à 400 oC et un taux de rampe de température de 15 oC/min ou plus lentement au cours d'une fin de semaine.
7. Détermination du taux de croissance
- Utilisez l'équation 1 ci-dessous pour décrire la réflectivité optique de l'échantillon11,19.
 ①
①
où: (1 - a)
(1 - a) (1 - b)
(1 - b) (1 - c)
(1 - c) (1 - d)
(1 - d) - Et où: n2 - 1.747 est l'indice de réfraction du substrat MgO à une longueur d'onde de 488 nm; 0 est l'angle du faisceau incident mesuré par rapport à la surface normale du substrat; et t est le temps. Les constantes optiques du film (n1 et k1) et le taux de croissance sont obtenus en adaptant la réflectivité en fonction du temps dans l'équation 1.
Subscription Required. Please recommend JoVE to your librarian.
Representative Results
L'objet noir dans l'enset de la figure 5B est une photographie d'un film mince Zn3N2 de 2 nm. De même, l'objet jaune dans l'enset de la figure 5C est un film mince de 220 nm Mg3N2. Le film jaune est transparent dans la mesure où il est facile à lire le texte placé derrière le film10.
La surface du substrat et les films ont été surveillés in situ par RHEED. La figure 5A montre le motif RHEED d'un substrat nu avec l'incident du faisceau d'électrons le long de la direction [110] du substrat. Les motifs RHEED pour les films déposés dans la figure 5B,C montrent que les treillis de cristal des films minces Zn3N2 et Mg3N2 sont orientés dans le plan de la surface du substrat, comme prévu dans le cas de l'épitaxie croissance. L'inconvénient de RHEED pour la surveillance de la croissance dans les conditions utilisées ici est que le processus de croissance doit être arrêté pour permettre à la pression de tomber à 10-7 Torr et allumer le pistolet à électrons.
Contrairement à RHEED, les mesures de réflectivité optique in situ ne sont pas affectées par la pression dans la chambre. Pour obtenir le taux de croissance, la réflectivité optique in situ était adaptée en fonction du temps indiqué dans la figure 6 à l'aide de l'équation 1. Dans cette équation, le temps de croissance t est la variable indépendante, et les constantes optiques du film (n1, k1) et le taux de croissance sont des paramètres appropriés. Dans la figure 6, l'indice de réfraction du substrat MgO, l'angle d'incidence et la longueur d'onde sont n2 , 1,747,0 , 36,5 degrés, et 488 nm, respectivement. L'indice de réfraction équipé du film est n1 - 2,65, coefficient d'extinction est k1 - 0,54, et le taux de croissance est de 0,031 nm/s pour le Zn3N2 film mince comme indiqué dans la figure 6A. De même, l'indice de réfraction le mieux adapté pour le film Mg3N2 est n1 - 2,4, le coefficient d'extinction est k1 - 0,09, et le taux de croissance est de 0,033 nm/s comme le montre la figure 6B. On croit que la diminution globale de la réflexion spéculaire avec le temps dans la figure 6B est causée par une augmentation de la diffusion de la rugosité de surface à mesure que le film mince Mg3N2 devient plus épais. L'effet de la diffusion de la rugosité a été simulé en multipliant la réflectivité calculée avec un exponençant en décomposition, e-t, où 810 -5 s-1 et le temps de croissance t est mesuré en quelques secondes.
Lors de l'exposition à l'air, les films jaunes non plafonnés Mg3N2 se sont fanés en quelques minutes à une couleur blanche translucide. D'autre part, les films Mg3N2 qui ont été plafonnés avec MgO étaient relativement stables. Pour protéger davantage les films Mg3N2 plafonnés de l'oxydation, les hétérostructures Mg3N2/MgO ont été recouvertes d'une couche CaF2 déposée par évaporation du faisceau d'électrons. Zn3N2 non plafonné est plus stable; cependant, les films zn3N2 initialement noirs se sont également oxydés au fil du temps et sont devenus gris en quelques mois. La réaction d'oxydation est censée impliquer la formation de l'hydroxyde de magnésium et libérer l'ammoniac selon la réaction chimique suivante20. Une couche ZnO déposée à l'aide d'une méthode similaire au MgO peut également être utilisée comme couche protectrice pour prévenir l'oxydation.
Mg3N2 - 6H2O 3Mg(OH)2 '2NH3

Figure 1 : Vue de la chambre de croissance épitaxique à faisceau moléculaire VG V80H. Cette image montre la chambre de croissance MBE avec (dans le sens horaire) l'écran RHEED et le boîtier de la caméra, l'analyseur de gaz résiduel quadrupole, le matériel optique sur le port de diffusion de lumière laser, la cellule d'effusion Mg, la source N-plasma, rf boîte correspondant, et la cellule d'effusion Zn. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.

Figure 2 : Porte-substrat et lueur de la source plasmatique. (A) Plaque de support d'échantillon de molybdène avec deux agrafes de fil de tungstène retenant le substrat carré de MgO en place. (B) Lueur pourpre provenant de la fenêtre arrière de la source plasmatique lorsqu'il fonctionne avec du gaz N2. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
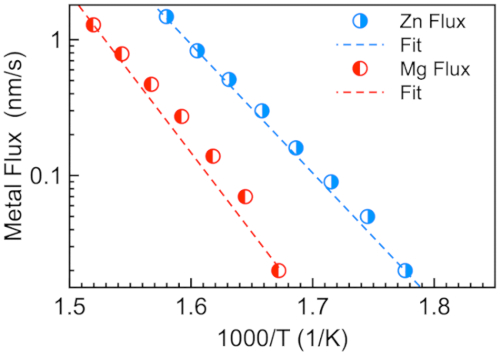
Figure 3 : Flux métallique en fonction de la température des cellules d'épanchement. Les lignes sont adaptées à la dépendance à la température des flux métalliques à l'aide d'une relation Arrhenius comme discuté dans le texte. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.

Figure 4 : Schéma de la configuration de diffusion de lumière laser in situ. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.

Figure 5 : Modèles RHEED. (A) Modèle de diffraction RHEED pour le substrat MgO. (B) Motif RHEED du film Zn3N2 avec photographie du film noir Zn3N2. (C) Motif RHEED de mg3N2 avec photographie du film jaune Mg3N2. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.

Figure 6 : Réflectivité spéculaire in situ. Réflectivité spéculaire in situ à 488 nm de (A) Zn3N2 et (B) Mg3N2 films pendant la croissance. La réflectivité calculée (ligne rouge) est la mieux adaptée aux données expérimentales (cercles bleus) telles que discutées dans le texte. Veuillez cliquer ici pour voir une version plus grande de ce chiffre.
Subscription Required. Please recommend JoVE to your librarian.
Discussion
Diverses considérations sont liées au choix des substrats et à l'établissement des conditions de croissance qui optimisent les propriétés structurelles et électroniques des films. Les substrats MgO sont chauffés à haute température dans l'air (1000 oC) afin d'éliminer la contamination par le carbone de la surface et d'améliorer l'ordre cristallin dans la surface du substrat. Le nettoyage par ultrasons en acétone est une bonne méthode alternative pour nettoyer les substrats MgO.
Le pic de diffraction des rayons X (400) pour les films Zn3N2 s'est avéré plus étroit lorsque le film a été cultivé sur des substrats MgO à haute température annelées par rapport à lorsqu'il est cultivé sur des substrats non annelés. La constante de treillis de MgO (0.421 nm) est significativement plus petite que (la moitié de) la constante de treillis de Zn3N2 (0.976 nm) ou Mg3N2 (0.995 nm) et pas bien assortie aux films semi-conducteurs. Les constantes de treillis des groupes disponibles dans le commerce IV, III-V et II-VI sont toutes plus grandes que les constantes de treillis de Mg3N2 et Zn3N2. Un substrat plus bien assorti est souhaitable. Le silicium, qui a une constante de treillis de 0.543 nm, est un peu plus bien assorti à Mg3N2 que MgO et vaut la peine d'être exploré. Zn3N2 films ont également été cultivés sur des substrats de saphir A-plan. La qualité structurelle de ces films n'était pas aussi bonne que celle observée dans les substrats MgO, comme l'indiquent les taches RHEED et la largeur du pic de diffraction des rayons X Zn3N2. Dans le cas des substrats de saphir, le dos a été recouvert de Cr (50 nm) et de Mo (200 nm) pour améliorer le couplage thermique entre le support du substrat et le substrat.
La température du substrat est mesurée pendant la croissance avec un thermocouple situé dans l'espace sous vide fermé entre le support du substrat et le radiateur, et il n'est pas en contact physique avec le support du substrat ou le substrat. Par conséquent, on s'attendait à ce que la température réelle du substrat soit inférieure à la température du capteur. Des croissances réussies de Mg3N2 et de Zn3N2 ont été obtenues avec des températures thermocouples dans les gammes de 300-350 oC et de 140-180 oC, respectivement.
La température de croissance élevée augmente la mobilité des atomes d'ad sur la surface croissante et on peut s'attendre à ce qu'elle produise des matériaux présentant moins de défauts structurels. Cependant, à des températures élevées du substrat, le taux de croissance est plus faible, ce qui est interprété comme étant dû à la réévaporation des atomes métalliques de la surface. À flux métallique élevé, le taux de croissance des pellicules est limité par l'approvisionnement en azote actif. L'azote actif est maximisé à haute puissance rf appliquée à la source plasmatique (300 W max) et à un débit d'azote élevé. Le débit N2 est limité par la pression maximale dans la chambre de croissance, qui dans ce cas était dans le milieu de 10-5 Torr gamme. L'ammoniac est une source alternative possible d'azote. Mg et Zn réagiront avec NH3 à une température élevée sans activation plasmatique; cependant, il n'est pas clair si le temps de résidence des atomes de Mg et Zn à la surface sera assez long pour soutenir la croissance du film à des températures pour lesquelles NH3 réagira avec les métaux.
Dans ces expériences, des cellules d'épanchement ont été utilisées avec des creusets pyrolytiques de nitride de bore (PBN) avec des capacités de 40 cc pour Mg et 25 cc pour Zn. Figure 3 montre la dépendance de température des flux de Mg et de Zn des cellules d'effusion. Les lignes droites de la figure 3 sont adaptées à la dépendance à la température mesurée des flux. Les ajustements ont la forme Flux -A exp(-B/kT), et les paramètres d'ajustement (A,B) sont (8,5 x 1017 nm/s, 2,3 eV) et (1,3 x 1015 nm/s, 1,9 eV) pour les sources Mg et Zn, respectivement. Le flux double approximativement avec chaque augmentation de 10 'C et de 12 'C de la température des cellules d'épanchement pour Mg et Zn, respectivement. Pour la croissance illustrée à la figure 6, les flux métalliques étaient proches des maxima de la figure 3 (1 nm/s avec flux Mg supérieur au flux De Zn), mais les taux de croissance du film n'étaient que de 0,03 nm/s. Cela montre que l'efficacité de l'utilisation des métaux est faible, avec Mg étant inférieur à Zn et la plupart des métaux ré-évaporer.
La pression de fond élevée n2 pendant la croissance empêche la surveillance continue de la croissance du film avec RHEED. Le pompage différentiel du canon RHEED peut résoudre ce problème. Les mesures de réflectivité optique in situ servent d'outil de surveillance complémentaire qui n'est pas affectée par la pression du gaz et fournit une technique précise et fiable pour déterminer le taux de croissance. La réflectivité non-spéculaire ou diffuse du substrat peut également être mesurée in situ et fournira des informations sur la rugosité de surface pendant la croissance.
La pression de base dans la chambre de croissance MBE est de 10-8 Torr avec le gaz N2 éteint. Le cryoshroud dans la chambre de croissance est refroidi avec de l'eau pendant la croissance du film. Dans ces conditions, on peut s'attendre à une certaine contamination résiduelle de l'oxygène dans les films. La pression résiduelle de vapeur d'eau dans la chambre de croissance peut être réduite avec un liquide de refroidissement à basse température dans le linceul, comme l'huile de silicone à -80 oC21.
En conclusion, ce protocole décrit comment cultiver des films en cristal simples de Mg3N2 et Zn3N2 par épitaxie à faisceau moléculaire assisté par plasma et fournit des suggestions sur la façon dont le processus de croissance peut être modifié pour améliorer encore le film qualité. Ces matériaux ne montraient pas de photoluminescence à température ambiante ou à basse température. Il est nécessaire de réduire davantage la densité des défauts dans les films. Les alliages Mg3N2-Zn3N2 peuvent également être cultivés par épitaxie à faisceau moléculaire assisté par plasma.
Subscription Required. Please recommend JoVE to your librarian.
Disclosures
Les auteurs n'ont rien à révéler.
Acknowledgments
Ces travaux ont été appuyés par le Conseil de recherches en sciences naturelles et en génie du Canada.
Materials
| Name | Company | Catalog Number | Comments |
| (100) MgO | University Wafer | 214018 | one side epi-polished |
| Acetone | Fisher Chemical | 170239 | 99.8% |
| Argon laser | Lexel Laser | 00-137-124 | 488 nm visible wavelength, 350 mW output power |
| Chopper | Stanford Research system | SR540 | Max. Frequency: 3.7 kHz |
| Lock-in amplifier | Stanford Research system | 37909 | DSP SR810, Max. Frequency: 100 kHz |
| Magnesium | UMC | MG6P5 | 99.9999% |
| MBE system | VG Semicon | V80H0016-2 SHT 1 | V80H-10 |
| Methanol | Alfa Aesar | L30U027 | Semi-grade 99.9% |
| Nitrogen | Praxair | 402219501 | 99.998% |
| Oxygen | Linde Gas | 200-14-00067 | > 99.9999% |
| Plasma source | SVT Associates | SVTA-RF-4.5PBN | PBN, 0.11" Aperture, Specify Length: 12" – 20" |
| Si photodiode | Newport | 2718 | 818-UV Enhanced, 200 - 1100 nm |
| Zinc | Alfa Aesar | 7440-66-6 | 99.9999% |
References
- Suda, T., Kakishita, K. Band-gap energy and electron effective mass of polycrystalline Zn3N2. Journal of Applied Physics. 99 (7), 076101.1-076101.3 (2006).
- Hu, J., Bando, Y., Zhan, J., Zhi, C., Golberg, D. Carbon nanotubes as nanoreactors for fabrication of single-crystalline Mg3N2 nanowires. Nano Letters. 6 (6), 1136-1140 (2006).
- Fang, C. M., Groot, R. A., Bruls, R. J., Hintzen, H. T., With, G. Ab initio band structure calculations of Mg3N2 and MgSiN2. Journal of Physics: Condensed Matter. 11 (25), 4833-4842 (1999).
- Yoo, S. H., Walsh, A., Scanlonc, D. O., Soon, A. Electronic structure and band alignment of zinc nitride, Zn3N2. RSC Advances. 4 (7), 3306-3311 (2014).
- Partin, D. E., Williams, D. J., O'Keeffe, M. The crystal structures of Mg3N2 and Zn3N2. Journal of Solid-State Chemistry. 132 (1), 56-59 (1997).
- Ullah, M., Murtaza, G., Ramay, S. M., Mahmood, A. Structural, electronic, optical and thermoelectric properties of Mg3X2 (X = N, P, As, Sb, Bi) compounds. Materials Research Bulletin. 91, 22-30 (2017).
- Li, C. T. Electrocatalytic zinc composites as the efficient counter electrodes of dye-sensitized solar cells: study on the electrochemical performance and density functional theory Calculations. ACS Applied Materials & Interfaces. 7 (51), 28254-28263 (2015).
- Sinha, S., Choudhury, D., Rajaraman, G., Sarkar, S. Atomic layer deposition of Zn3N2 thin films: growth mechanism and application in thin film transistor. RSC Advances. 5 (29), 22712-22717 (2015).
- Bhattacharyya, S. R., Ayouchi, R., Pinnisch, M., Schwarz, R. Transfer characteristic of zinc nitride based thin film transistors. Physica Status Solidi C. 9 (3-4), 469-472 (2012).
- Wu, P., Tiedje, T. Molecular beam epitaxy growth and optical properties of Mg3N2 films. Applied Physics Letters. 113 (8), 082101.1-082101.4 (2018).
- Wu, P., et al. Molecular beam epitaxy growth and optical properties of single crystal Zn3N2 films. Semiconductor Science and Technology. 31 (10), 10LT01.1-10LT01.4 (2016).
- Jiang, N., Georgiev, D. G., Jayatissa, A. H. The effects of the pressure and the oxygen content of the sputtering gas on the structure and the properties of zinc oxy-nitride thin films deposited by reactive sputtering of zinc. Semiconductor Science and Technology. 28 (2), 025009 (2013).
- Nakano, Y., Morikawa, T., Ohwaki, T., Taga, Y. Electrical characterization of p-type N-doped ZnO films prepared by thermal oxidation of sputtered Zn3N2 films. Applied Physics Letters. 88 (17), 172103.1-172103.3 (2006).
- Cao, X., Yamaguchi, Y., Ninomiya, Y., Yamada, N. Comparative study of electron transport mechanisms in epitaxial and polycrystalline zinc nitride films. Journal of Applied Physics. 119 (2), 025104.1-025104.10 (2016).
- Jia, J., Kamijo, H., Nakamura, S., Shigesato, Y. How the sputtering process influence structural, optical, and electrical properties of Zn3N2 films. MRS Communications. 8 (2), 314-321 (2018).
- Trapalis, A., Hefferman, J., Farrer, I., Sherman, J., Kean, A. Structural, electrical and optical characterization of as-grown and oxidized zinc nitride films. Journal of Applied Physics. 120 (20), 205102.1-205102.9 (2016).
- Núñez, C. G., et al. On the zinc nitride properties and the unintentional incorporation of oxygen. Thin Solid Films. 520 (6), 1924-1929 (2012).
- Oshima, T., Fujita, S. (111)-oriented Zn3N2 growth on a-plane sapphire substrates by molecular beam epitaxy. Japanese Journal of Applied Physics. 45 (111), 8653-8655 (2006).
- Heavens, O. S. Optical properties of thin solid films. , Butterworth, London. 46-48 (1955).
- Heyns, A. H., Prinsloo, L. C., Range, K. J., Stassen, M. The vibrational spectra and decomposition of α-calcium nitride (α-Ca3N2) and magnesium nitride (Mg3N2). Journal of Solid-State Chemistry. 137, 33-41 (1998).
- Lewis, R. B., Bahrami-Yekta, V., Patel, M. J., Tiedje, T., Masnadi-Shirazi, M. Closed-cycle cooling of cryopanels in molecular beam epitaxy. Journal of Vacuum Science Technology B. 32 (2), 02C102.1-02C102.7 (2014).



 ①
① (1 - a)
(1 - a) (1 - b)
(1 - b) (1 - c)
(1 - c) (1 - d)
(1 - d)