Summary
本稿では、窒素源および光学成長モニタリングとしてN2ガスを用いる血漿支援分子ビームエピタキシーによるMgO基板上のMg3N2及びZn3N2のエピタキシャルフィルムの増殖について述べた。
Abstract
本論文では、血漿支援分子ビームエピタキシー(MBE)によりMg3N2およびZn3 N2フィルムを増伸する手順について説明する。フィルムは窒素源としてN2ガスを使用して100指向MgO基板上で成長する。基板およびMBE成長プロセスを準備する方法について説明する。基板および膜表面の向きおよび結晶順序は、成長前および成長中の反射高エネルギー電子回折(RHEED)によって監視される。試料表面の鏡面反射率は、488nmの波長を持つAr-イオンレーザーによる成長時に測定されます。反射率の時間依存性を数学モデルに適合させ、屈折率、光消滅係数、およびフィルムの増殖速度が決定される。金属フラックスは、水晶モニターを用いて流出細胞温度の関数として独立して測定されます。典型的な成長率は、Mg 3 N 2およびZn3N 2フィルムの成長温度150°Cおよび330°Cでそれぞれ0.028 nm/sである。
Introduction
II3-V2材料は、III-VおよびII-VI半導体1に比べて半導体研究コミュニティから比較的注目を集めている半導体クラスです。MgおよびZn窒化物、Mg3N2およびZn3N2は、豊富で非毒性の元素で構成されているため、ほとんどのIII-VおよびII-VIとは異なり、安価でリサイクルしやすいため、消費者向けアプリケーションに魅力的です。化合物半導体。それらはCaF2構造に類似した反ビクスバイト結晶構造を示し、1つは中間占有されたfcc F-sublatticesの1つが半分占有された2、3、4、5である。 それらは両方とも直接バンドギャップ材料6であり、光学用途7、8、9に適している。Mg3N2のバンドギャップは可視スペクトル(2.5eV)10にあり、Zn3N2のバンドギャップは近赤外(1.25eV)11にある。これらの材料の物理的特性と電子および光学デバイスアプリケーションの可能性を調べるには、高品質の単結晶フィルムを得ることが重要です。これまでのこれらの材料に関するほとんどの作業は、反応性スパッタリング12、13、14、15、16、反応性スパッタリングによって作られた粉末または多結晶フィルム上で行われてきました。 17.
分子ビームエピタキシー(MBE)は、クリーンな環境と高純度元素源を用いて高品質の材料を得る可能性を有する単結晶化合物半導体フィルム18を成長させるための、十分に開発された汎用性の高い方法である。一方、MBEの急速なシャッター操作は原子層スケールのフィルムへの変更を可能にし、精密な厚さの制御を可能にする。本論文では、高純度ZnとMgを窒素源として高純度ZnおよびMgを用いて、MgO基板上のMg3N2およびZn3N2エピタキシャルフィルムの成長について報告する。
Subscription Required. Please recommend JoVE to your librarian.
Protocol
1. MgO基板製剤
注:市販の片面エピ研磨(100)指向単結晶MgO角基板(1cm x 1cm)は、X3N2(X=ZnおよびMg)薄膜成長に採用された。
- 高温アニール
- クリーンなサファイアウエハサンプルキャリアにMgOを置き、研磨された側を炉の上方に向け、1,000°Cで9時間のアニールを使用します。10分の間に温度を1000°Cに上げます。
注:高温アニールは、表面から炭素を除去し、MgO単結晶基板の表面結晶構造を再構築します。 - MgO基板を室温(RT)まで冷却します。
- クリーンなサファイアウエハサンプルキャリアにMgOを置き、研磨された側を炉の上方に向け、1,000°Cで9時間のアニールを使用します。10分の間に温度を1000°Cに上げます。
- 基板洗浄
- アニールされたMgO基板を収集し、きれいなホウケイ酸ガラスビーカーで脱イオン水中ですすぎます。
- MgO基板を250mLのホウケイ酸ガラスビーカーで100mLのアセトンで30分間沸騰させ、無機炭素汚染を取り扱いから除去します。
注:ビーカーをカバーし、アセトンを沸騰させて乾燥させないようにしてください。 - アセトンを排出し、メタノールの50 mLでMgO基板をすすいでいます。
- 窒素ガスで基板を吹き飛ばし、乾燥したクリーンな基板をクリーンチップトレイに保管します。
2. VG V80 MBEの動作
- 調製室用の冷却水を開き、成長室(図1参照)、噴出細胞、および石英結晶マイクロバランスセンサ上の凍結性を開きます。
- 488 nmの波長のAr-イオンレーザーをオンにします。レーザー光は別の部屋にあるレーザーからの光ファイバとMBEの部屋に持って来られる。
- 反射高エネルギー電子回折銃(RHEED)、13.56 Mhz無線周波数(rf)プラズマ発生器、および水晶マイクロバランス(QCM)システムをオンにします。
3. 基板積載
- 高速エントリロック
- タングステンスプリングクリップを使用して、モリブデンサンプルホルダー(図2A)にきれいなMgO基板を取り付けます。
- 高速エントリーロック(FEL)のターボポンプをオフにし、窒素でFELチャンバを排出します。チャンバー圧力が大気圧に達したら、FELを開きます。
- FELからサンプラーホルダーカセットを取り出し、基板をカセットにセットします。
- カセットをFELにロードし、ターボポンプをオンに戻します。
- FEL の圧力が 10-6 Torr に下がるのを待ちます。
- 5分間の間に速いエントリロックの温度を100 °Cに上げ、速いエントリロックの30分間のホルダーとの基板を脱ぐ。
- 真空弁を準備室に開く前に、速いエントリーロックの圧力が10-7 Torr以下であることを確認してください。ウォブルスティック転送機構を使用してホルダーを準備室に移し、脱気ステーションを400°Cに増やし、5時間の脱気を可能にします。
- 脱気ホルダーをトロリー搬送機構により、成長チャンバ内のサンプルマニピュレータに移します。30分間にわたって基板温度を750°Cまで上げ、サンプルがマニピュレータで30分間外ガスを出せるようにします。
- サンプルマニピュレータ内の熱電対を使用して、Zn3N2フィルムの増殖に対して基板の温度を150°C、Mg3 N2フィルム成長に対して330°Cに下げ、サンプル温度を測定します。
- インシッツ・リード
- 成長チャンバー圧力が1 x10-7 Torrを下回ると、電子銃の電圧を15kVに設定し、フィラメント電流を1.5Aに設定します。
- 1)電子銃が基板の原理結晶軸に沿って整列するまで基板ホルダーを回転させ、2)透明な単結晶電子回折パターンが見える。
- RHEEDパターンの写真を撮り、写真を保存します。
- 噴出セルのシャッターを閉じ、窒素の流れを止めてください。チャンバー圧力が10-7 Torrを下回った場合に、堆積膜のRHEEDパターンを測定します。
4. 金属フラックス測定
- MgおよびZnには、標準グループIII型の噴出細胞または低温の噴出細胞を使用する。
- 15gと25gの高純度MgとZnショットでるつぼをそれぞれロードします。
- 成長チャンバーが10-8 Torr以上の真空を達成し、基板ホルダーをロードする前に、ZnまたはMg源の噴出細胞を約20°C/分のランプレートで250°Cまでガスアウトし、シャッターを閉じた状態で1時間のアウトガスを可能にします。
- 基板をサンプルマニピュレータに積み込んだ後、Znおよび/またはMgの滲出細胞をそれぞれ350°Cまたは390°Cに加熱し、ランプレートで〜10°C/minで加熱し、シャッターを閉じたまま安定するのを10分間待ちます。
- 引き込み式の水晶モニターを使用して、金属フラックスを測定します。石英結晶センサーをチャンバ内の基板の前に置きます。基板に金属が堆積しないように、基板が検出器で完全に覆われていることを確認します。
- 対象の金属の密度(εZn = 7.14 g/cm3、εMg = 1.74 g/cm3)を水晶モニター(QCM)コントローラに入力します。
- フラックスを調整するには、金属源の1つにシャッターを開け、噴出セルがセンサーに沈着できるようにします。QCMシステムは質量の内部測定を厚さに変える。
- QCMに示す時間の関数として、増加する厚さの傾きから元素フラックスを計算します。数分の厚さの増加率は、元素フラックスに比例します。2 つの例の例では、0.45 nm/s の Zn フラックスと 1.0 nm/s の Mg フラックスが得られます。
- フラックスの温度依存性が必要な場合は、噴出細胞の温度を変更し、ステップ4.8を繰り返します。この特定の成長系について、MgおよびZnフラックスの測定温度依存性を図3に示す。
- フラックス測定が完了したら、噴出セルのシャッターを閉じ、水晶センサーを引き込みます。
5. 窒素プラズマ
- 成長チャンバー内の高N2ガス圧の存在下で損傷を防ぐために、RHEED銃のフィラメント電流と高電圧をオフにします。
- 高圧N2シリンダーのガスバルブを開きます。
- 成長チャンバー内の窒素圧力が3 x 10-5 -4x 10-5 Torrに達するまで、リークバルブをゆっくりと開きます。
- プラズマ発電機の電力を300Wに設定します。
- プラズマ源のイグニッタでプラズマに点火します。図 2Bに示すように、プラズマが点火すると、ビューポートから明るい紫色の輝きが表示されます。
- RF マッチング ボックスのコントロールを調整して、反射電力を可能な限り最小限に抑えます。15 W 未満の反射力は良好です。この場合、反射電力は12Wに減少します。
6. その中のレーザー光散乱
- ロックインアンプで電気信号を検出できるように、成長チャンバー内の基板から反射した488nmアルゴンレーザー光をSiフォトダイオードに焦点を合わせます。これは、基板ホルダーを2軸周りに回転させ、Si検出器の位置を調整し、図4に示すように反射光を集めるレンズに焦点を合わせることによって基板の角度を調整することによって達成される。
- 金属源の1つのシャッターを開きます。
- 時間依存の反射率をコンピュータ制御データ ロガーで記録します。エピタキシャルフィルムの成長は、フィルムの前面と背面の間の薄膜光学干渉に関連する時間と振動反射信号を生成します。
- 空気中の酸化からフィルムを保護するために、空気中の酸化からフィルムを保護するためにカプセル化層を堆積します。これは、空気中で急速に酸化するMg3N2にとって特に重要です。
- MgO封入層を堆積させるために、窒素ガスを閉じ、酸素ガスに切り替え、ステップ5.3を繰り返し、酸素圧力を1 x 10-5 Torrに上げる。
- プラズマジェネレータの電源を250Wに設定し、ステップ5.5を繰り返します。プラズマは窒素ガスよりも酸素ガスで低いrf電力で始まります。
- Mg ソースのシャッターを開き、ステップ 6.4 を 5 ~ 10 分間繰り返します。
注:これは、約10 nmの厚さのMgOフィルムを生成します。上限のないMg3N2フィルムは黄色ですが、空気にさらされると20s以内に白っぽい色に素早くフェードします。その結果、真空チャンバから取り出した後に酸化する前にフィルムの測定に時間を費やすために封入層が必要です。 - ガスバルブを閉じ、レーザーをオフにし、基板とセル温度を30分で約25°Cに下げ、冷却水とrf電源をプラズマ源にオフにします。
- いくつかの成長が実行された後、光学窓は金属で覆われていく。アルミホイルで窓を包み、加熱テープで400°Cに加熱し、週末にかけて約15°C/分の温度ランプ速度で加熱して金属を取り除きます。
7. 成長率決定
- 以下の式1を使用して、サンプル11、19の光学反射率を説明する。
 (1)
(1)
どこ: (1 - a)
(1 - a) (1 - b)
(1 - b) (1 - c)
(1 - c) (1 - d)
(1 - d) - そして、どこ:n 2 = 1.747は488 nmの波長でMgO基板の屈折率です。θ0は、基板表面法線に対して測定された入射ビームの角度である。と tは時間です。フィルムの光学定数(n1およびk1)および成長率は、式1における時間の関数として反射率を適合することによって得られる。
Subscription Required. Please recommend JoVE to your librarian.
Representative Results
図5Bのインセット中の黒い物体は、成長した200nm Zn3N2薄膜の写真である。同様に、図5Cにおけるインセット中の黄色の物体は、成長した220nm Mg3N2薄膜である。黄色のフィルムは、フィルム10の後ろに置かれた読みやすいテキストである程度透明である。
基板およびフィルムの表面をRHEEDによってその場で監視した。図5Aは、基板の[110]方向に沿った電子ビーム入射を有する裸基板のRHEEDパターンを示す。図5Bにおける堆積膜のRHEEDパターンは、Cは、Zn3 N2およびMg3N2薄膜の結晶格子が基板表面の平面に配向していることを示し、エピタキシャルの場合に期待される成長。ここで使用される条件下での成長モニタリングのためのRHEEDの欠点は、圧力が10-7 Torrに低下し、電子銃をオンにするために成長プロセスを停止しなければならないことです。
RHEEDとは対照的に、その場で光学反射率測定はチャンバ内の圧力の影響を受けません。成長率を得るために、その場で光学反射率は、式1を用いて図6に示す時間の関数として適合した。この式では、成長時間tは独立変数であり、フィルムの光学定数(n1、k1)および成長率はフィッティングパラメータである。 図6では、MgO基板屈折率、入射角、波長はそれぞれn2=1.747、θ0=36.5°、λ= 488 nmである。 フィルムの適合屈折率はn1 = 2.65、絶滅係数はk1 =0.54、増殖速度は図6Aに示すようにZn 3N2薄膜の0.031 nm/sである。同様に、Mg3N2フィルムの最適適合屈折率はn1 = 2.4、絶滅係数はk1 = 0.09、成長率は図 6Bに示すように = 0.033 nm/s です。図6Bにおける時間に伴う鏡面反射の全体的な減少は、Mg3N2薄膜が厚くなるにつれて表面粗さの散乱が増加することによって引き起こされると考えられる。粗さの散乱の効果は、計算された反射率を減衰指数、e -βtで乗算することによってシミュレートされ、β = 810-5 s-1および成長時間tが秒単位で測定されます。
空気にさらされると、上限のない黄色のMg3N2フィルムは、半透明の白い色に数分以内に色あせた。一方、MgOでキャップしたMg3N2フィルムは比較的安定であった。キャップされたMg3N2フィルムを酸化からさらに保護するために、Mg3N2/MgOヘテロ構造体を電子ビーム蒸発によって堆積したCaF2層で被覆した。上限なし Zn3N2はより安定しています。しかし、最初の黒いZn3N2フィルムも時間の経過とともに酸化され、数ヶ月以内に灰色に変わりました。酸化反応は、以下の化学反応20に係る水酸化マグネシウムの形成およびアンモニア放出を伴うと考えられる。MgOと同様の方法で堆積したZnO層は、酸化を防ぐための保護層としても使用できます。
Mg3N2 + 6H2O → 3Mg(OH)2 + 2NH3

図 1:VG V80H分子ビームエピタキシー成長室の眺め。この写真は、RHEEDスクリーンとカメラハウジング、四重極残留ガスアナライザ、レーザー光散乱ポート上の光学ハードウェア、Mg発光セル、Nプラズマ源、rfマッチングボックス、およびZn発光セルを備えたMBE成長室を示しています。この図のより大きなバージョンを表示するには、ここをクリックしてください。

図 2:プラズマ源からの基板ホルダーとグロー。(A) 正方形のMgO基板を所定の位置に保持する2つのタングステンワイヤークリップを備えたモリブデンサンプルホルダープレート。(B)N2ガスで作動する場合、プラズマ源のバックウインドウから発生する紫色の輝き。この図のより大きなバージョンを表示するには、ここをクリックしてください。
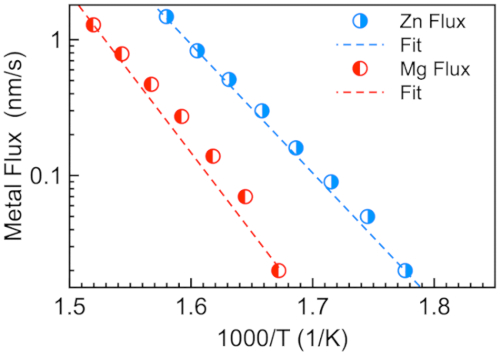
図 3:流出細胞温度の関数としての金属フラックス。線は、本文で説明されているように、アレニウス関係を使用して金属フラックスの温度依存性に適合します。この図のより大きなバージョンを表示するには、ここをクリックしてください。

図 4:その中のレーザー光散乱セットアップの回路図。この図のより大きなバージョンを表示するには、ここをクリックしてください。

図 5: リードパターン。(A) MgO基板のRHEED回折パターン。(B)黒Zn3N2フィルムの写真を含む成長したZn3N2フィルムのRHEEDパターン。 (C)黄色Mg3N2フィルムの写真を使用したMg3N2基板として成長したMg3N2基板のRHEEDパターン。 この図のより大きなバージョンを表示するには、ここをクリックしてください。

図 6:その中の鏡面反射率。(A)Zn3N2および(B)Mg3 N2フィルムの488nmでのその中の鏡面反射率は、成長中である。計算された反射率 (赤い線) は、テキストで説明されているように実験データ (青い円) に最適です。この図のより大きなバージョンを表示するには、ここをクリックしてください。
Subscription Required. Please recommend JoVE to your librarian.
Discussion
基板の選択とフィルムの構造および電子特性を最適化する成長条件の確立には、さまざまな考慮事項が含まれています。MgO基板は、空気中の高温(1000°C)で加熱され、表面からの炭素汚染を除去し、基板表面の結晶性の順序を改善します。アセトン中の超音波洗浄は、MgO基板をきれいにするための良い代替方法です。
Zn3N2フィルムに対する(400)X線回折ピークは、フィルムを高温で成長させた場合に狭く、未封状基板上で成長した場合に比べて、アニールされたMgO基板が狭くなることが判明した。MgO(0.421 nm)の格子定数は、Zn3N 2(0.976 nm)またはMg3 N2(0.995nm)の格子定数(半分)よりも有意に小さく、半導体フィルムとよく一致しません。 市販の基IV、III-V、およびII-VI基板の格子定数は、すべてMg3N2およびZn3N2の格子定数よりも大きい。よりよく一致した基板が望ましい。0.543 nmの格子定数を有するシリコンは、MgOよりもMg3 N2にややよく一致しており、探索する価値があります。Zn3N2フィルムもA面サファイア基板上で栽培した。これらのフィルムの構造品質は、(400)Zn 3N2 X線回折ピークのRHEEDスポットおよび幅によって示されるMgO基板に見られるほど良好ではなかった。サファイア基板の場合、裏面をCr(50nm)とMo(200nm)でコーティングし、基板ホルダーと基板間の熱結合を改善した。
基板温度は、基板ホルダーとヒーターの間の密閉された真空空間に位置する熱電対で成長中に測定され、基板ホルダーまたは基板と物理的に接触しません。その結果、実際の基板温度はセンサ温度よりも低くなることが予想された。成功したMg3N2およびZn3 N2成長は、それぞれ300-350°Cおよび140-180°Cの範囲で熱電対温度で得られた。
高成長温度は、成長面上のアド原子の移動性を増加させ、より少ない構造欠陥を持つ材料を生成することが期待される場合があります。しかし、高い基質温度では、成長率が低く、表面からの金属原子の再蒸発によるものと解釈されます。高い金属フラックスでは、フィルムの成長速度は活性窒素の供給によって制限される。活性窒素は、プラズマ源(最大300W)に適用される高rf電力と高い窒素流量で最大化されます。N2流量は成長チャンバー内の最大圧力によって制限され、この場合は中間10-5Torr範囲であった。アンモニアは、可能な代替窒素源です。Mg と Zn は、プラズマ活性化なしで高温で NH3と反応します。しかし、表面上のMgとZn原子の滞留時間が、NH3が金属と反応する温度でフィルムの成長を支えるのに十分な長さになるかどうかは不明である。
これらの実験では、発泡細胞を熱分解硝化ホウ素(PBN)るつぼで使用し、Mgは40cc、Zn.図3では、発泡細胞からのMgおよびZnフラックスの温度依存性を示した。図 3の直線は、フラックスの測定温度依存性に適合しています。フィットはFlux = A exp(-B/kT)で、フィッティングパラメータ(A,B)は Mg および Zn ソースの場合は(8.5 x 1017 nm/s、2.3 eV)、および Mg および Zn ソースの場合は (1.3 x 1015 nm/s、1.9 eV) になります。フラックスは、MgおよびZnの流出細胞温度がそれぞれ10°Cと12°C上昇するたびにほぼ倍増します。図6に示す成長については、金属フラックスは図3の最大値付近(ZnフラックスよりもMgフラックスが高い~1nm/s)でしたが、膜の成長率はわずか0.03nm/sでした。これは、金属使用率が低く、MgがZnよりも低く、ほとんどの金属が再蒸発していることを示しています。
成長中の高いN2バックグラウンド圧力は、RHEEDによるフィルム成長の連続的なモニタリングを妨げる。RHEED銃の差動ポンピングは、この問題を解決することができます。その場で光学反射率測定はガス圧の影響を受けない補完的な監視ツールとして機能し、成長率を決定するための正確で信頼性の高い技術を提供します。基板の非スペキュラまたは拡散反射率は、その場で測定することもでき、成長時の表面粗さに関する情報を提供します。
MBE成長チャンバのベース圧力は、N2ガスをオフにした10-8 Torrです。成長室内の凍結水は、フィルムの成長中に水で冷却される。これらの条件下では、フィルム内のいくつかの残留酸素汚染が期待できます。成長チャンバ内の残留水蒸気圧は、-80°C21のシリコーン油などのシュラウド中の低温冷却剤で低減することができる。
結論として、このプロトコルは、血漿支援分子ビームエピタキシーによってMg3N2およびZn3 N2の単結晶膜を成長させる方法を説明し、成長過程を更に改善するためにどのように変化させることができるかについての提案を提供する品質。これらの材料は、室温または低温のいずれにおいても光発光を示さなかった。フィルム内の欠陥密度をさらに低減する必要がある。Mg3N 2-Zn3N2合金は、プラズマ支援分子ビームエピタキシーにより増殖することもできる。
Subscription Required. Please recommend JoVE to your librarian.
Disclosures
著者は何も開示していない。
Acknowledgments
この研究は、カナダの自然科学工学研究評議会によって支援されました。
Materials
| Name | Company | Catalog Number | Comments |
| (100) MgO | University Wafer | 214018 | one side epi-polished |
| Acetone | Fisher Chemical | 170239 | 99.8% |
| Argon laser | Lexel Laser | 00-137-124 | 488 nm visible wavelength, 350 mW output power |
| Chopper | Stanford Research system | SR540 | Max. Frequency: 3.7 kHz |
| Lock-in amplifier | Stanford Research system | 37909 | DSP SR810, Max. Frequency: 100 kHz |
| Magnesium | UMC | MG6P5 | 99.9999% |
| MBE system | VG Semicon | V80H0016-2 SHT 1 | V80H-10 |
| Methanol | Alfa Aesar | L30U027 | Semi-grade 99.9% |
| Nitrogen | Praxair | 402219501 | 99.998% |
| Oxygen | Linde Gas | 200-14-00067 | > 99.9999% |
| Plasma source | SVT Associates | SVTA-RF-4.5PBN | PBN, 0.11" Aperture, Specify Length: 12" – 20" |
| Si photodiode | Newport | 2718 | 818-UV Enhanced, 200 - 1100 nm |
| Zinc | Alfa Aesar | 7440-66-6 | 99.9999% |
References
- Suda, T., Kakishita, K. Band-gap energy and electron effective mass of polycrystalline Zn3N2. Journal of Applied Physics. 99 (7), 076101.1-076101.3 (2006).
- Hu, J., Bando, Y., Zhan, J., Zhi, C., Golberg, D. Carbon nanotubes as nanoreactors for fabrication of single-crystalline Mg3N2 nanowires. Nano Letters. 6 (6), 1136-1140 (2006).
- Fang, C. M., Groot, R. A., Bruls, R. J., Hintzen, H. T., With, G. Ab initio band structure calculations of Mg3N2 and MgSiN2. Journal of Physics: Condensed Matter. 11 (25), 4833-4842 (1999).
- Yoo, S. H., Walsh, A., Scanlonc, D. O., Soon, A. Electronic structure and band alignment of zinc nitride, Zn3N2. RSC Advances. 4 (7), 3306-3311 (2014).
- Partin, D. E., Williams, D. J., O'Keeffe, M. The crystal structures of Mg3N2 and Zn3N2. Journal of Solid-State Chemistry. 132 (1), 56-59 (1997).
- Ullah, M., Murtaza, G., Ramay, S. M., Mahmood, A. Structural, electronic, optical and thermoelectric properties of Mg3X2 (X = N, P, As, Sb, Bi) compounds. Materials Research Bulletin. 91, 22-30 (2017).
- Li, C. T. Electrocatalytic zinc composites as the efficient counter electrodes of dye-sensitized solar cells: study on the electrochemical performance and density functional theory Calculations. ACS Applied Materials & Interfaces. 7 (51), 28254-28263 (2015).
- Sinha, S., Choudhury, D., Rajaraman, G., Sarkar, S. Atomic layer deposition of Zn3N2 thin films: growth mechanism and application in thin film transistor. RSC Advances. 5 (29), 22712-22717 (2015).
- Bhattacharyya, S. R., Ayouchi, R., Pinnisch, M., Schwarz, R. Transfer characteristic of zinc nitride based thin film transistors. Physica Status Solidi C. 9 (3-4), 469-472 (2012).
- Wu, P., Tiedje, T. Molecular beam epitaxy growth and optical properties of Mg3N2 films. Applied Physics Letters. 113 (8), 082101.1-082101.4 (2018).
- Wu, P., et al. Molecular beam epitaxy growth and optical properties of single crystal Zn3N2 films. Semiconductor Science and Technology. 31 (10), 10LT01.1-10LT01.4 (2016).
- Jiang, N., Georgiev, D. G., Jayatissa, A. H. The effects of the pressure and the oxygen content of the sputtering gas on the structure and the properties of zinc oxy-nitride thin films deposited by reactive sputtering of zinc. Semiconductor Science and Technology. 28 (2), 025009 (2013).
- Nakano, Y., Morikawa, T., Ohwaki, T., Taga, Y. Electrical characterization of p-type N-doped ZnO films prepared by thermal oxidation of sputtered Zn3N2 films. Applied Physics Letters. 88 (17), 172103.1-172103.3 (2006).
- Cao, X., Yamaguchi, Y., Ninomiya, Y., Yamada, N. Comparative study of electron transport mechanisms in epitaxial and polycrystalline zinc nitride films. Journal of Applied Physics. 119 (2), 025104.1-025104.10 (2016).
- Jia, J., Kamijo, H., Nakamura, S., Shigesato, Y. How the sputtering process influence structural, optical, and electrical properties of Zn3N2 films. MRS Communications. 8 (2), 314-321 (2018).
- Trapalis, A., Hefferman, J., Farrer, I., Sherman, J., Kean, A. Structural, electrical and optical characterization of as-grown and oxidized zinc nitride films. Journal of Applied Physics. 120 (20), 205102.1-205102.9 (2016).
- Núñez, C. G., et al. On the zinc nitride properties and the unintentional incorporation of oxygen. Thin Solid Films. 520 (6), 1924-1929 (2012).
- Oshima, T., Fujita, S. (111)-oriented Zn3N2 growth on a-plane sapphire substrates by molecular beam epitaxy. Japanese Journal of Applied Physics. 45 (111), 8653-8655 (2006).
- Heavens, O. S. Optical properties of thin solid films. , Butterworth, London. 46-48 (1955).
- Heyns, A. H., Prinsloo, L. C., Range, K. J., Stassen, M. The vibrational spectra and decomposition of α-calcium nitride (α-Ca3N2) and magnesium nitride (Mg3N2). Journal of Solid-State Chemistry. 137, 33-41 (1998).
- Lewis, R. B., Bahrami-Yekta, V., Patel, M. J., Tiedje, T., Masnadi-Shirazi, M. Closed-cycle cooling of cryopanels in molecular beam epitaxy. Journal of Vacuum Science Technology B. 32 (2), 02C102.1-02C102.7 (2014).



 (1)
(1) (1 - a)
(1 - a) (1 - b)
(1 - b) (1 - c)
(1 - c) (1 - d)
(1 - d)