Summary
本文介绍了以N2气体为氮源和光生长监测的等离子体辅助分子束外延在MgO基板上Mg3 N2和Zn3N2的外延膜的生长情况。
Abstract
本文介绍了通过等离子辅助分子束外延(MBE)生长Mg3N2和Zn3N2薄膜的过程。薄膜生长在100个定向MgO基板上,以N2气体为氮源。介绍了基板制备方法和MBE生长过程。基材和薄膜表面的方向和晶体顺序在生长前和生长过程中通过反射高能电子衍射(RHEED)进行监测。样品表面的镜面反射率在生长过程中使用波长为488nm的Ar-ion激光器进行测量。通过将反射率的时间依赖性与数学模型拟合,确定了薄膜的折射率、光消光系数和生长速率。使用石英晶体监测仪作为熔融细胞温度的函数独立测量金属助焊剂。Mg3N2和 Zn3N2薄膜的生长温度分别为 0.028 nm/s,生长温度为 330°C 和 330°C。
Introduction
II3-V2材料是一类半导体,与III-V和II-VI半导体1相比,受到半导体研究界的关注相对较少。Mg 和 Zn nititd、Mg3N2和 Zn3N2对消费者应用很有吸引力,因为它们由丰富且无毒的元素组成,与大多数 III-V 和 II-VI 不同,它们价格低廉且易于回收化合物半导体。它们显示了一种与CaF2结构相似的抗双比石晶体结构,其中一个穿插的fccF-sublattices是半占用的2,3,4,5。它们都是直接带隙材料6,使它们适用于光学应用7,8,9。Mg3N2的波段间隙在可见光谱 (2.5 eV)10中,Zn3N2的频段间隙在近红外 (1.25 eV)11中。要探索这些材料的物理特性及其在电子和光学器件应用方面的潜力,获得高质量的单晶膜至关重要。迄今为止,对这些材料的大部分工作都是在反应溅射12、13、14、15、16的粉末或多晶薄膜上进行的。 17.
分子束外延 (MBE) 是一种开发成熟且用途广泛的方法,用于种植单晶化合物半导体薄膜18,具有利用清洁环境和高纯度元素源生产高质量材料的潜力。同时,MBE 快速快门操作可在原子层比例下对胶片进行更改,并允许精确厚度控制。本文以高纯度锌和Mg作为蒸汽源,N2气体作为氮源,报道了等离子体辅助MBE在MgO基板上Mg3 N2和Zn3N2外延膜的生长情况。
Subscription Required. Please recommend JoVE to your librarian.
Protocol
1. MgO基板制备
注:用于X3N 2(X = Zn和Mg)薄膜生长的商用单面上抛光(100)定向单晶MgO方形基板(1厘米x1厘米)。
- 高温退火
- 将 MgO 放在干净的蓝宝石晶圆样品载体上,抛光面朝上,在 1,000 °C 下,退火 9 小时。在 10 分钟内将温度升高到 1000 °C。
注:高温退火可去除表面的碳,并重建MgO单晶基板的表面晶体结构。 - 将 MgO 基板冷却至室温 (RT)。
- 将 MgO 放在干净的蓝宝石晶圆样品载体上,抛光面朝上,在 1,000 °C 下,退火 9 小时。在 10 分钟内将温度升高到 1000 °C。
- 基板清洗
- 收集退火的MgO基板,在干净的硼硅酸盐玻璃烧杯中用去离子水冲洗。
- 将 MgO 基板在 250 mL 硼硅酸盐玻璃烧杯中用 100 mL 丙酮煮沸 30 分钟,以去除处理中的无机碳污染。
注:盖住烧杯,不要让丙酮变干。 - 排空丙酮,用50 mL的甲醇冲洗MgO基板。
- 用氮气吹干基板,然后将干燥、干净的基板存放在干净的芯片托盘中。
2. VG V80 MBE 的操作
- 打开制备室的冷却水,在生长室上打开低温罩(见图1),渗出电池和石英晶体微平衡传感器。
- 打开波长为 488 nm 的 Ar 型激光器。激光灯通过位于另一个房间的激光光纤带到 MBE 室。
- 打开反射高能电子衍射枪 (RHEED)、13.56 Mhz 射频 (rf) 等离子发生器和石英晶体微平衡 (QCM) 系统。
3. 基板加载
- 快速进入锁定
- 使用钨弹簧夹将干净的 MgO 基板安装在二氧化硫样品支架上(图 2A)。
- 关闭快速进入锁 (FEL) 上的涡轮泵,然后用氮气向 FEL 腔室排气。当腔室压力达到大气压力时,打开 FEL。
- 将取样器支架盒从 FEL 中取出,并将样品支架与基板一起装入盒式磁带中。
- 将盒式磁带装回 FEL 并重新打开涡轮泵。
- 等待 FEL 中的压力降至 10-6 Torr。
- 在 5 分钟内将快速进入锁的温度提高到 100°C,并在快速进入锁中与支架一起对基板进行 30 分钟的脱气。
- 在将真空阀打开到准备室之前,请确保快速进入锁中的压力低于 10-7 Torr。使用摆动杆转移机构将支架转移到准备室,然后将脱气站提升至 400°C,使其脱气 5 小时。
- 通过滑车转移机构将脱气支架转移到生长室中的样品操纵器。在 30 分钟内将基板温度提高到 750°C,让样品在操纵器中再流出气体 30 分钟。
- 将基板温度降至150°C,用于Zn3N2薄膜生长,Mg3N2薄膜生长温度降至330°C,使用样品操纵器中的热电偶测量样品温度。
- 原位 RHEED
- 一旦生长室压力低于 1 x10-7 Torr,将电子喷枪上的电压设置为 15 kV,将灯丝电流设置为 1.5 A。
- 旋转基板支架,直到 1) 电子枪沿基板的原理晶体轴对齐,2) 可见的透明单晶电子衍射模式可见。
- 拍摄 RHEED 图案并保存图片。
- 关闭液融合细胞上的快门并停止氮气流动。当腔室压力低于 10-7 Torr 时,测量沉积膜的 RHEED 模式。
4. 金属通量测量
- 使用标准组 III 型输液细胞或低温输液细胞用于 Mg 和 Zn。
- 分别装载15克和25克高纯度Mg和锌射砂。
- 当生长室达到10-8托或更高的真空时,在加载基板支架之前,以±20°C/min的斜坡速率将锌或Mg源液融合电池排出至250°C,并在百叶窗关闭时允许其排出气体1小时。
- 将基板加载到样品操纵器后,将锌和/或Mg液化电池分别加热至350°C或390°C,以±10°C/min的斜坡速率加热,并在百叶窗关闭时等待10分钟使其稳定。
- 使用可伸缩石英晶体监视器测量金属通量。将石英晶体传感器放置在造型室内的基板前面。确保基板完全被探测器覆盖,以免金属沉积在基板上。
- 将感兴趣的金属的密度(*Zn = 7.14 g/cm3, αMg = 1.74 g/cm3)输入石英晶体监视器 (QCM) 控制器。
- 要校准助焊剂,请打开其中一个金属源的快门,让液融合单元沉积在传感器上。QCM 系统将其内部质量测量转换为厚度。
- 计算增加厚度斜率的元素通量,作为 QCM 上显示的时间函数。几分钟内厚度的增加速率与元素通量成正比。在两个示例情况下,获得 0.45 nm/s 的锌通量和 1.0 nm/s 的 Mg 通量。
- 如果需要通量的温度依赖性,请更改输液细胞的温度并重复步骤 4.8。此特定生长系统的Mg和Zn通量的测量温度依从性如图3所示。
- 完成磁通量测量后,关闭液化电池上的百叶窗并收回石英晶体传感器。
5. 氮等离子体
- 关闭 RHEED 喷枪上的灯丝电流和高压,以防止生长室中存在高 N2气体压力时损坏。
- 打开高压 N2气缸上的气体阀。
- 缓慢打开泄漏阀,直到生长室中的氮气压力达到 3 x 10-5-4 x 10-5 Torr。
- 将等离子发电机的功率设置为 300 W。
- 用等离子源上的点火器点燃等离子体。当等离子体点燃时,视口将可见明亮的紫色发光,如图2B所示。
- 调整 rf 匹配框上的控件,以尽可能将反射功率降至最低。反射功率小于 15 W 良好;在这种情况下,反射功率降至 12 W。
6. 原位激光光散射
- 将生长室基板反射的切碎的 488 nm Argon 激光聚焦到 Si 光电二极管上,以便锁定放大器能够检测到电信号。这是通过调整基板的角度,旋转基板支架周围的两个轴和调整Si探测器的位置,然后对镜头的焦视收集反射光如图4所示。
- 打开其中一个金属源的快门。
- 使用计算机控制的数据记录器记录与时间相关的反射率。外延膜的生长会产生振荡反射信号,时间与薄膜前后表面之间的薄膜光学干扰相关。
- 为了保护薄膜在空气中不氧化,沉积一个封装层,以保护薄膜在空气中免受氧化。这对在空气中迅速氧化的Mg3N2尤其重要。
- 为了沉积MgO封装层,关闭氮气,切换到氧气,重复步骤5.3,并将氧压增加到1 x10-5托。
- 将等离子发生器的功率设置为 250 W,然后重复步骤 5.5。与氮气相比,等离子体从氧气的射频功率较低开始。
- 打开 Mg 源上的快门,然后重复步骤 6.4 5-10 分钟。
注:这将产生约10纳米厚的MgO薄膜。未封顶的 Mg3N2薄膜为黄色,但在暴露于空气中后,在 20 秒内迅速褪色为白色。因此,需要封装层,以便在薄膜从真空室中取出后氧化之前,有时间对薄膜进行测量。 - 关闭气体阀,关闭激光,并在 30 分钟内将基板和电池温度降低至 +25°C。 关闭冷却水和等离子源的 rf 电源。
- 经过几次生长运行,光学窗口变得覆盖着金属。将窗户包裹在铝箔中,用加热胶带加热至 400°C,在周末内温度升高速率为 ±15 °C/min 或较慢,从而去除金属。
7. 增长率确定
- 使用下面的公式1描述样本11,19的光学反射率。
 ⑴
⑴
地点: (1 - a)
(1 - a) (1 - b)
(1 - b) (1 - c)
(1 - c) (1 - d)
(1 - d) - 其中:n 2 = 1.747 是波长为 488 nm 的 MgO 基板的折射率;±0是相对于基板表面法线测量的射束角度;时间是时间。薄膜的光学常数(n1和k1)和生长速率是通过在方程1中拟合反射率作为时间的函数而获得的。
Subscription Required. Please recommend JoVE to your librarian.
Representative Results
图 5B中所处的黑色对象是一张已生长的 200 nm Zn3N2薄膜的照片。同样,图 5C中 INSET 中的黄色对象是生长的 220 nm Mg3N2薄膜。黄色胶片是透明的,因为它很容易阅读的文本放在电影10后面。
RHEED对基板和薄膜的表面进行了原位监测。图5A显示了裸基板的RHEED模式,其电子束事件沿基板的[110]方向。图5B、C中沉积膜的RHEED图案表明,Zn3N2和 Mg3N2薄膜的晶格在基板表面平面上定向,如外延情况所示增长。RHEED 在本文使用的条件下进行生长监测的缺点是必须停止生长过程,以使压力降至 10-7 Torr 并打开电子枪。
与 RHEED 相比,原位光学反射率测量不受腔室压力的影响。为了获得增长率,原位光学反射率适合作为时间函数,如图6所示,使用公式1。在此方程中,生长时间t是独立的变量,薄膜的光常数(n1,k 1)和增长率是拟合参数。在图 6中,MgO基板的折射率、入射角和波长分别为n2 = 1.747、±0 = 36.5°和 + = 488 nm。 胶片的拟合折射率为n 1= 2.65,消光系数为k1 = 0.54,Zn3N2薄膜的生长速率为±0.031 nm/s,如图6A所示。同样,Mg3N2薄膜的最佳拟合折射率为n1 = 2.4,消光系数为k1 = 0.09,增长率为 ± 0.033 nm/s,如图6B所示。图 6B中,镜面反射与时间一起的总体减少被认为是由于 Mg3N2薄膜变厚时表面粗糙度散射的增加造成的。通过将计算出的反射率与衰减指数 e -_t相乘,模拟粗糙散射的影响,其中= 810-5 s-1,生长时间t为以秒为单位。
在暴露于空气中时,未封顶的黄色 Mg3N2薄膜在几分钟内褪色为半透明白色。另一方面,用MgO盖住的Mg3 N2薄膜相对稳定。为了进一步保护封顶的Mg3N2薄膜免受氧化,Mg3N 2/MgO异质结构被涂覆了由电子束蒸发沉积的CaF2层。未封顶的锌3N2较为稳定;然而,最初的黑色Zn3N2薄膜也随着时间的推移氧化,并在几个月内变成灰色。氧化反应被认为涉及氢氧化镁的形成,并根据以下化学反应20释放氨。使用与 MgO 类似的方法沉积的 ZnO 层也可以用作保护层,以防止氧化。
镁3N2 + 6H2O = 3Mg(OH)2 = 2NH3

图 1:VG V80H 分子束外延生长室视图。图为MBE生长室(顺时针)RHEED屏幕和摄像机外壳、四极极残余气体分析仪、激光光散射端口上的光学硬件、Mg熔化电池、N-等离子源、rf匹配盒和Zn输液单元。请点击此处查看此图的较大版本。

图 2:基板支架和来自等离子源的发光。(A) 带两个钨丝夹的莫利布登姆样品支架板,将方形 MgO 基板固定到位。(B) 使用 N2 气体操作时,来自等离子源后窗的紫色发光。请点击此处查看此图的较大版本。
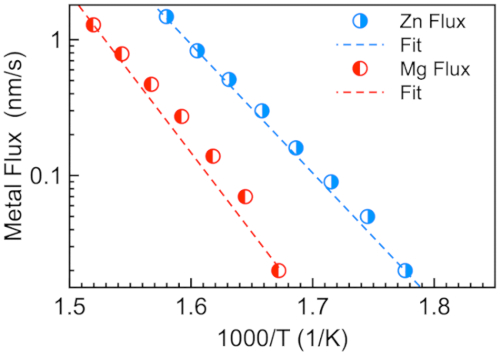
图 3:金属通量作为液融合细胞温度的函数。这些线条适合使用文本中讨论的Arrhenius关系对金属通量的温度依赖性。请点击此处查看此图的较大版本。

图 4:原位激光光散射设置的原理图。请点击此处查看此图的较大版本。

图 5:RHEED 模式。(A) MgO 基板的 RHEED 衍射模式.(B) 与黑色 Zn3N2胶片照片一起拍摄的成因的 Zn3N2胶片的 RHEED 图案。(C) 与黄色 Mg3N2薄膜照片的作为生长的 Mg3N2基板的 RHEED 图案。请点击此处查看此图的较大版本。

图 6:原位镜反射率。在生长过程中,在488nm的(A)锌3N2和(B)Mg3N2薄膜处的原位镜面反射率。 计算的反射率(红线)最适合实验数据(蓝色圆圈),如文中所述。请点击此处查看此图的较大版本。
Subscription Required. Please recommend JoVE to your librarian.
Discussion
在选择基材和建立优化薄膜结构和电子特性的生长条件时,需要考虑各种因素。MgO基板在高温下(1000°C)加热,去除表面的碳污染,改善基材表面的结晶顺序。丙酮的超声波清洗是清洁MgO基板的好方法。
当薄膜在高温退火MgO基板上生长时,Zn3N2薄膜的(400)X射线衍射峰值比在未发火基板上生长时更窄。MgO (0.421 nm) 的晶格常数明显小于 Zn3N2 (0.976 nm) 或 Mg3N2 (0.995 nm) 的晶格常数(一半),并且与半导体薄膜不匹配。市售组IV、III-V和II-VI基板的晶格常数均大于Mg3 N2和Zn3N2的晶格常数。更匹配的基板是可取的。硅的晶格常数为0.543 nm,与Mg3N2相比,其匹配度稍好,值得探索。Zn3N2薄膜也生长在 A 平面蓝宝石基板上。这些薄膜的结构质量不如MgO基板,如RHEED点和宽度(400)Zn3N2 X射线衍射峰所示。在蓝宝石基板的情况下,背面涂有Cr(50nm)和Mo(200nm),以改善基板支架和基板之间的热耦合。
基板温度在生长过程中使用位于基板支架和加热器之间的封闭真空空间的热电偶进行测量,并且与基板支架或基板没有物理接触。因此,预计实际基板温度将低于传感器温度。在300-350°C和140-180°C范围内的热电偶温度下,成功地获得了Mg3N2和Zn3N2的生长。
高生长温度增加了生长表面的原子的流动性,并可能期望产生结构缺陷较少的材料。然而,在高基板温度下,生长速率较低,这被解释为由于金属原子从表面重新蒸发所致。在高金属通量下,薄膜的生长速率受到活性氮供应的限制。在施加到等离子源的高射频功率(最大 300 W)和高氮流速率下,活性氮得到最大化。N2流速受生长室中最大压力的限制,在此例中为 10-5 Torr范围。氨是一种可能的替代氮源。Mg和Zn在高温下与NH3发生反应,没有等离子体激活;然而,目前还不清楚Mg和Zn原子在表面的停留时间是否足够长,以支持NH3与金属发生反应的温度下的薄膜生长。
在这些实验中,输液细胞与热解氮化硼(PBN)熔炉一起使用,其容量为40cc(Mg),25cc为Zn。图3显示了来自输液细胞的Mg和Zn通量的温度依赖性。图 3中的直线适合磁通量的测量温度依从性。拟合的格式为Flux = A exp(-B/kT),而用于镁和锌源的拟合参数(A、B)分别为(8.5 x 1010 17 nm/s、2.3 eV)和(1.3 x 1015 nm/s、1.9 eV)。随着Mg和Zn的渗出细胞温度每增加10°C和12°C,助焊量大约翻倍。对于图6所示的生长,金属通量接近图3中最大值(Mg通量高于锌通量±1纳米/s),但薄膜增长率仅为0.03 nm/s。结果表明,金属利用效率低,镁含量低于锌,大部分金属重新蒸发。
生长过程中的高N2背景压力排除了使用RHEED持续监测薄膜生长的可能性。RHEED 喷枪的差速泵可以解决此问题。原位光学反射率测量作为不受气体压力影响的辅助监测工具,为确定增长率提供了准确可靠的技术。基材的非镜面或漫反射率也可以原位测量,并提供生长过程中表面粗糙度的信息。
MBE 生长室中的基本压力为 10-8 Torr,N2气体关闭。在薄膜生长过程中,生长室中的低温罩用水冷却。在这些情况下,薄膜中可能会存在一些残留的氧气污染。生长室中的残余水蒸气压力可以通过护罩中的低温冷却液(如-80°C21的硅油)来降低。
最后,该协议描述了如何通过等离子辅助分子束外延生长Mg3N2和Zn3N2的单晶膜,并就如何改变生长过程以进一步提高薄膜提供建议质量。这些材料在室温或低温下均未显示光致发光。有必要进一步降低薄膜的缺陷密度。Mg3N 2-Zn3N2合金也可以通过等离子辅助分子束外延生长。
Subscription Required. Please recommend JoVE to your librarian.
Disclosures
作者没有什么可透露的。
Acknowledgments
这项工作得到了加拿大自然科学和工程研究理事会的支持。
Materials
| Name | Company | Catalog Number | Comments |
| (100) MgO | University Wafer | 214018 | one side epi-polished |
| Acetone | Fisher Chemical | 170239 | 99.8% |
| Argon laser | Lexel Laser | 00-137-124 | 488 nm visible wavelength, 350 mW output power |
| Chopper | Stanford Research system | SR540 | Max. Frequency: 3.7 kHz |
| Lock-in amplifier | Stanford Research system | 37909 | DSP SR810, Max. Frequency: 100 kHz |
| Magnesium | UMC | MG6P5 | 99.9999% |
| MBE system | VG Semicon | V80H0016-2 SHT 1 | V80H-10 |
| Methanol | Alfa Aesar | L30U027 | Semi-grade 99.9% |
| Nitrogen | Praxair | 402219501 | 99.998% |
| Oxygen | Linde Gas | 200-14-00067 | > 99.9999% |
| Plasma source | SVT Associates | SVTA-RF-4.5PBN | PBN, 0.11" Aperture, Specify Length: 12" – 20" |
| Si photodiode | Newport | 2718 | 818-UV Enhanced, 200 - 1100 nm |
| Zinc | Alfa Aesar | 7440-66-6 | 99.9999% |
References
- Suda, T., Kakishita, K. Band-gap energy and electron effective mass of polycrystalline Zn3N2. Journal of Applied Physics. 99 (7), 076101.1-076101.3 (2006).
- Hu, J., Bando, Y., Zhan, J., Zhi, C., Golberg, D. Carbon nanotubes as nanoreactors for fabrication of single-crystalline Mg3N2 nanowires. Nano Letters. 6 (6), 1136-1140 (2006).
- Fang, C. M., Groot, R. A., Bruls, R. J., Hintzen, H. T., With, G. Ab initio band structure calculations of Mg3N2 and MgSiN2. Journal of Physics: Condensed Matter. 11 (25), 4833-4842 (1999).
- Yoo, S. H., Walsh, A., Scanlonc, D. O., Soon, A. Electronic structure and band alignment of zinc nitride, Zn3N2. RSC Advances. 4 (7), 3306-3311 (2014).
- Partin, D. E., Williams, D. J., O'Keeffe, M. The crystal structures of Mg3N2 and Zn3N2. Journal of Solid-State Chemistry. 132 (1), 56-59 (1997).
- Ullah, M., Murtaza, G., Ramay, S. M., Mahmood, A. Structural, electronic, optical and thermoelectric properties of Mg3X2 (X = N, P, As, Sb, Bi) compounds. Materials Research Bulletin. 91, 22-30 (2017).
- Li, C. T. Electrocatalytic zinc composites as the efficient counter electrodes of dye-sensitized solar cells: study on the electrochemical performance and density functional theory Calculations. ACS Applied Materials & Interfaces. 7 (51), 28254-28263 (2015).
- Sinha, S., Choudhury, D., Rajaraman, G., Sarkar, S. Atomic layer deposition of Zn3N2 thin films: growth mechanism and application in thin film transistor. RSC Advances. 5 (29), 22712-22717 (2015).
- Bhattacharyya, S. R., Ayouchi, R., Pinnisch, M., Schwarz, R. Transfer characteristic of zinc nitride based thin film transistors. Physica Status Solidi C. 9 (3-4), 469-472 (2012).
- Wu, P., Tiedje, T. Molecular beam epitaxy growth and optical properties of Mg3N2 films. Applied Physics Letters. 113 (8), 082101.1-082101.4 (2018).
- Wu, P., et al. Molecular beam epitaxy growth and optical properties of single crystal Zn3N2 films. Semiconductor Science and Technology. 31 (10), 10LT01.1-10LT01.4 (2016).
- Jiang, N., Georgiev, D. G., Jayatissa, A. H. The effects of the pressure and the oxygen content of the sputtering gas on the structure and the properties of zinc oxy-nitride thin films deposited by reactive sputtering of zinc. Semiconductor Science and Technology. 28 (2), 025009 (2013).
- Nakano, Y., Morikawa, T., Ohwaki, T., Taga, Y. Electrical characterization of p-type N-doped ZnO films prepared by thermal oxidation of sputtered Zn3N2 films. Applied Physics Letters. 88 (17), 172103.1-172103.3 (2006).
- Cao, X., Yamaguchi, Y., Ninomiya, Y., Yamada, N. Comparative study of electron transport mechanisms in epitaxial and polycrystalline zinc nitride films. Journal of Applied Physics. 119 (2), 025104.1-025104.10 (2016).
- Jia, J., Kamijo, H., Nakamura, S., Shigesato, Y. How the sputtering process influence structural, optical, and electrical properties of Zn3N2 films. MRS Communications. 8 (2), 314-321 (2018).
- Trapalis, A., Hefferman, J., Farrer, I., Sherman, J., Kean, A. Structural, electrical and optical characterization of as-grown and oxidized zinc nitride films. Journal of Applied Physics. 120 (20), 205102.1-205102.9 (2016).
- Núñez, C. G., et al. On the zinc nitride properties and the unintentional incorporation of oxygen. Thin Solid Films. 520 (6), 1924-1929 (2012).
- Oshima, T., Fujita, S. (111)-oriented Zn3N2 growth on a-plane sapphire substrates by molecular beam epitaxy. Japanese Journal of Applied Physics. 45 (111), 8653-8655 (2006).
- Heavens, O. S. Optical properties of thin solid films. , Butterworth, London. 46-48 (1955).
- Heyns, A. H., Prinsloo, L. C., Range, K. J., Stassen, M. The vibrational spectra and decomposition of α-calcium nitride (α-Ca3N2) and magnesium nitride (Mg3N2). Journal of Solid-State Chemistry. 137, 33-41 (1998).
- Lewis, R. B., Bahrami-Yekta, V., Patel, M. J., Tiedje, T., Masnadi-Shirazi, M. Closed-cycle cooling of cryopanels in molecular beam epitaxy. Journal of Vacuum Science Technology B. 32 (2), 02C102.1-02C102.7 (2014).



 ⑴
⑴ (1 - a)
(1 - a) (1 - b)
(1 - b) (1 - c)
(1 - c) (1 - d)
(1 - d)