Summary
यह आलेख वर्णन करता है कि च्3छ2 तथा द द3छ2 की अधिअक्षीय फिल्मों की वृद्धि, प्जो पर प्जो उपस्थैत्य द्वारा प्यूज ण् 2 नाइट्रोजन स्रोत तथा प्रकाशिक वृद्धि निगरानी के रूप में छ2 गैस के साथ आण्विक किरण पुस् तककास द्वारा किया गया है।
Abstract
यह लेख प्लाज्मा की सहायता से आणविक बीम एपिटैक्सी (MBE) द्वारा वृद्धि करने के लिए एक प्रक्रिया का वर्णन करता है3छ2 और n3N2 फिल्मों. इन फिल्मों को नाइट्रोजन के स्रोत के रूप में छ2 गैस के साथ 100 उन्मुख एमजीओ सबस्ट्रेट्स पर उगाया जाता है। substrates और MBE विकास प्रक्रिया तैयार करने के लिए विधि का वर्णन कर रहे हैं. सब्सट्रेट और फिल्म की सतह के अभिविन्यास और क्रिस्टलीय क्रम की निगरानी वृद्धि से पहले और बाद में परावर्तन उच्च ऊर्जा इलेक्ट्रॉन विवर्तन (आरईडी) द्वारा की जाती है। नमूना सतह की विशिष्ट परावर्तकता 488 एनएम की तरंगदैर्ध्य के साथ एक अर आयन लेजर के साथ विकास के दौरान मापा जाता है। एक गणितीय मॉडल के लिए परावर्तकता की समय निर्भरता फिटिंग द्वारा, अपवर्तक सूचकांक, ऑप्टिकल विलुप्त होने गुणांक, और फिल्म की विकास दर निर्धारित कर रहे हैं. धातु फ्लक्स एक क्वार्ट्ज क्रिस्टल मॉनिटर का उपयोग कर बहाव सेल तापमान के एक समारोह के रूप में स्वतंत्र रूप से मापा जाता है। विशिष्ट वृद्धि दर क्रमशः 150 डिग्री सेल्सियस तथा 330 डिग्री सेल्सियसके वृद्धि ताप पर उ3 छ2 तथा द द 3 द 2 तथा द3द2 फिल्मों के लिए 0ण्028 दउ/
Introduction
II3-V2 पदार्थ अर्धचालकों का एक वर्ग है जिसे तृतीय-ट तथा द्वितीय-VI अर्धचालक1की तुलना में अर्धचालक अनुसंधान समुदाय से अपेक्षाकृत कम ध्यान प्राप्त हुआ है। च् और द नाइट्राइड्स, च्3छ2 तथा द 3 द2,उपभोक्ता अनुप्रयोगों के लिए आकर्षक होते हैं क्योंकि वे प्रचुर मात्रा में तथा गैर-विषाक्त तत्वों से बना होते हैं, जिससे उन्हें अधिकांश तृतीय-V तथा II-VI के विपरीत रीसायकल करना आसान हो जाता है। यौगिक अर्धचालक. वे एक विरोधी bixbyite क्रिस्टल संरचना CaF2 संरचना के समान प्रदर्शित करते हैं, interpenetrating एफसीसी एफ sublattices में से एक के साथ आधा कब्जा किया जा रहा है 2,3,4,5. ये दोनों प्रत्यक्ष बैंड अंतराल सामग्री6हैं , जो उन्हें ऑप्टिकल अनुप्रयोगों7,8,9के लिए उपयुक्त बनाते हैं . च्3छ2 का बैंड अंतराल दृश्य स्पेक्ट्रम (2ण्5 ईवी)10में है तथा द3छ2 का बैंड अंतराल निकट-अवरक्त (1ण्25 ईवी)11में है। इन सामग्रियों के भौतिक गुणों और इलेक्ट्रॉनिक और ऑप्टिकल डिवाइस अनुप्रयोगों के लिए उनकी क्षमता का पता लगाने के लिए, यह उच्च गुणवत्ता, एकल क्रिस्टल फिल्मों को प्राप्त करने के लिए महत्वपूर्ण है. इन सामग्रियों पर आज तक अधिकांश कार्य प्रतिक्रियाशील sputtering द्वारा बनाई गई पाउडर या बहुक्रिस्टलीय फिल्मों पर किया गया है12,13,14,15,16, 17.
आण्विक बीम epitaxy (MBE) एकल क्रिस्टल यौगिक अर्धचालक फिल्मों18 है कि एक स्वच्छ पर्यावरण और उच्च शुद्धता मौलिक स्रोतों का उपयोग कर उच्च गुणवत्ता सामग्री उपज की क्षमता है बढ़ने के लिए एक अच्छी तरह से विकसित और बहुमुखी विधि है. इस बीच, MBE तेजी से शटर कार्रवाई परमाणु परत पैमाने पर एक फिल्म में परिवर्तन सक्षम बनाता है और सटीक मोटाई नियंत्रण के लिए अनुमति देता है. इस पत्र में प्ज3छ2 तथा द द 3 द2एपिटैक्सियल फिल्मों के गुणब योग पर प्लाज्मा की सहायता से एम बी ई द्वारा उच्च शुद्धता तथा च्घ का उपयोग करते हुए नाइट्रोजन स्रोत तथा छ2 गैस के रूप में उच्च शुद्धता तथा च्ह का उपयोग करते हुए नाइट्रोजन स्रोत के रूप में दी गई है।
Subscription Required. Please recommend JoVE to your librarian.
Protocol
1. MgO सब्सट्रेट तैयारी
नोट: वाणिज्यिक एक तरफ epi-पॉलिश (100) उन्मुख एकल क्रिस्टल MgO वर्ग substrates (1 सेमी x 1 सेमी) X3N2 (X $ n और Mg) पतली फिल्म विकास के लिए कार्यरत थे.
- उच्च तापमान अनीलन
- एक साफ नीलम वेफर नमूना वाहक पर MgO रखें पॉलिश पक्ष एक भट्ठी में ऊपर की ओर का सामना करना पड़ रहा है और 1,000 डिग्री सेल्सियस पर 9 एच के लिए anneal. 10 मिनट की अवधि में तापमान को 1000 डिग्री सेल्सियस तक बढ़ाएं।
नोट: उच्च तापमान अनीलन सतह से कार्बन को हटा देता है और MgO एकल क्रिस्टल substrates की सतह क्रिस्टल संरचना reconstructs. - कमरे के तापमान (आरटी) के लिए MgO substrates ठंडा.
- एक साफ नीलम वेफर नमूना वाहक पर MgO रखें पॉलिश पक्ष एक भट्ठी में ऊपर की ओर का सामना करना पड़ रहा है और 1,000 डिग्री सेल्सियस पर 9 एच के लिए anneal. 10 मिनट की अवधि में तापमान को 1000 डिग्री सेल्सियस तक बढ़ाएं।
- सबस्ट्रेट सफाई
- annealed MgO substrates लीजिए और एक साफ borosilicate गिलास बीकर में deionized पानी में कुल्ला.
- से निपटने से अकार्बनिक कार्बन संदूषण को दूर करने के लिए 30 मिनट के लिए एक 250 एमएल बोरोसिलिकेट ग्लास बीकर में 100 एमएल एसीटोन में MgO substrates उबालें।
नोट: बीकर को कवर करें और एसीटोन को सूखे उबालने की अनुमति न दें। - एसीटोन को छान लें और एमजीओ को 50 एमएल मेथनॉल में धो लें।
- नाइट्रोजन गैस के साथ substrates उड़ा सूखी, तो साफ चिप ट्रे में सूखी, साफ substrates की दुकान.
2. वीजी वी 80 MBE का ऑपरेशन
- तैयारी कक्ष के लिए ठंडा पानी खोलें, विकास कक्ष पर cryoshroud (चित्रा 1देखें), बहाव कोशिकाओं, और क्वार्ट्ज क्रिस्टल microbalance सेंसर.
- 488 एनएम की तरंगदैर्ध्य के साथ अर-आयन लेजर चालू करें। लेजर प्रकाश लेजर, जो दूसरे कमरे में स्थित है से एक ऑप्टिकल फाइबर के साथ MBE कक्ष में लाया जाता है.
- परावर्तन उच्च ऊर्जा इलेक्ट्रॉन विवर्तन गन (RHEED), 13.56 मेगाहर्ट्ज रेडियो आवृत्ति (आरएफ) प्लाज्मा जनरेटर, और क्वार्ट्ज क्रिस्टल माइक्रोबैलेंस (QCM) प्रणाली चालू करें।
3. सबस्ट्रेट लोडिंग
- तेजी से प्रवेश ताला
- टंगस्टन स्प्रिंग क्लिप का उपयोग करते हुए मॉलिब्डेनम नमूना धारक (चित्र 2ए) पर एक स्वच्छ MgO सब्सट्रेट माउंट करें।
- तेजी से प्रवेश ताला (FEL) पर टर्बो पंप बंद करें और नाइट्रोजन के साथ FEL कक्ष वेंट. जब कक्ष दाब वायुमंडलीय दाब तक पहुँचता है तो फेल खोलें।
- FEL से बाहर नमूना धारक कैसेट निकालें और कैसेट में सब्सट्रेट के साथ नमूना धारक लोड.
- कैसेट को वापस फेल में लोड करें और टर्बो पंप को वापस चालू करें।
- FEL में दबाव के लिए प्रतीक्षा करें 10-6 Torr करने के लिए ड्रॉप करने के लिए.
- तेजी से प्रवेश ताला में 30 मिनट के लिए धारकों के साथ substrates 5 मिनट की अवधि में 100 डिग्री सेल्सियस के लिए तेजी से प्रवेश ताला के तापमान में वृद्धि।
- सुनिश्चित करें कि तैयारी कक्ष के लिए वैक्यूम वाल्व खोलने से पहले तेजी से प्रवेश ताला में दबाव 10-7 Torr नीचे है। तैयारी कक्ष के लिए लड़खड़ा छड़ी हस्तांतरण तंत्र का उपयोग कर धारक स्थानांतरण, तो 400 डिग्री सेल्सियस के लिए degassing स्टेशन रैंप और यह 5 एच के लिए degas करने के लिए अनुमति देते हैं।
- ट्रॉली स्थानांतरण तंत्र द्वारा degassed धारक विकास कक्ष में नमूना manipulator करने के लिए स्थानांतरण। 30 मिनट की अवधि में 750 डिग्री सेल्सियस तक सब्सट्रेट तापमान बढ़ाएं और नमूना को एक और 30 मिनट के लिए मैनिप्युलेटर में बाहर निकलने की अनुमति दें। यह सुनिश्चित करें कि क्रायोशप्रिट में ठंडा पानी चालू है ताकि क्रायोश्शकोश को गर्म होने से बचाया जा सके।
- नमूने के तापमान को मापने के लिए नमूना manipulator में थर्मोकपल का उपयोगकर 3 छ2 फिल्म वृद्धि के लिए n3N2 फिल्म वृद्धि के लिए सब्सट्रेट के तापमान को 150 डिग्री सेल्सियस तक गिराएं।
- इन-सीटू RHEED
- इलेक्ट्रॉन गन पर वोल्टता को 15 कव् तथा तंतु धारा को 1ण्5 क क क कक पर नितल तधक करदी जिए कि वृद्धि कक्ष दाब 1 x 10-7 तोर से नीचे हो जाए।
- सब्सट्रेट धारक को तब तक घुमाएँ जब तक कि इलेक्ट्रॉन गन को सब्सट्रेट के सिद्धांत क्रिस्टलीय अक्ष के साथ संरेखित किया जाता है और 2) एक स्पष्ट एकल क्रिस्टल इलेक्ट्रॉन विवर्तन पैटर्न दिखाई देता है।
- RHEED पैटर्न की एक तस्वीर ले लो और चित्र को बचाने के।
- बहाव कोशिका पर शटर बंद करें और नाइट्रोजन के प्रवाह को बंद करें। जमा फिल्म के लिए RHEED पैटर्न उपाय जब कक्ष दबाव 10-7 Torr से नीचे है.
4. धातु प्रवाह माप
- Mg और n के लिए मानक समूह III प्रकार बहाव कोशिकाओं या कम तापमान बहाव कोशिकाओं का उपयोग करें।
- क्रूसिबल को क्रमशः 15 ग्राम और 25 ह उच्च शुद्धता वाले गुण और द द शॉट के साथ लोड करें।
- जब विकास कक्ष 10-8 Torr या बेहतर का एक निर्वात हासिल किया है, और सब्सट्रेट धारक लोड करने से पहले, $ 20 डिग्री सेल्सियस / मिनट की एक रैंप दर पर 250 डिग्री सेल्सियस तक n या Mg स्रोत बहाव कोशिकाओं outgas और यह बंद शटर के साथ 1 एच के लिए outgas करने के लिए अनुमति देते हैं.
- सब्सट्रेट नमूना manipulator में लोड किया गया है के बाद, गर्मी n और / या Mg बहाव कोशिकाओं को क्रमशः 350 डिग्री सेल्सियस या 390 डिग्री सेल्सियस के लिए, $ 10 डिग्री सेल्सियस /मिनट की एक रैंप दर पर, और उनके लिए 10 मिनट प्रतीक्षा बंद शटर के साथ स्थिर करने के लिए.
- धातु प्रवाह को मापने के लिए वापस लेने योग्य क्वार्ट्ज क्रिस्टल मॉनिटर का उपयोग करें। कक्ष के अंदर सब्सट्रेट के सामने क्वार्ट्ज क्रिस्टल सेंसर स्थिति. सुनिश्चित करें कि सब्सट्रेट पूरी तरह से डिटेक्टर द्वारा कवर किया जाता है ताकि कोई धातु सब्सट्रेट पर जमा है।
- क्वार्ट्ज क्रिस्टल मॉनीटर (क्यूसीएम) नियंत्रक मेंब्याज की धातु का घनत्व (जद र्ं 7ण़् ़ ़ ़ ़ ़ ़ ़ ़ ़ 3 , र्उ द 1ण्74 हधब3) का घनत्व इनपुट करें।
- प्रवाह जांचना करने के लिए, धातु स्रोतों में से एक के लिए शटर खोलने के लिए और बहाव सेल सेंसर पर जमा करने के लिए अनुमति देते हैं। QCM प्रणाली मोटाई के लिए बड़े पैमाने पर अपनी आंतरिक माप धर्मान्तरित.
- QCM पर दिखाया समय के एक समारोह के रूप में बढ़ती मोटाई की ढलान से मौलिक प्रवाह की गणना. कुछ मिनट से अधिक मोटाई की वृद्धि की दर मौलिक प्रवाह के लिए आनुपातिक है. उदाहरण के दो मामलों में 0ण्45 दउ का दद फ्रलक्स तथा 1ण्0 दउ का डह फ्रफ्लक्स प्राप्त किया जाता है।
- बहाव कोशिकाओं के तापमान को बदलने और चरण 4.8 दोहराने यदि प्रवाह के तापमान निर्भरता की आवश्यकता है। इस विशिष्ट वृद्धि प्रणाली के लिए चित्र 3 में च् और द फ्लक्स की मापित ताप निर्भरता दर्शायी गई है।
- जब फ्लक्स माप पूरा कर रहे हैं, बहाव कोशिकाओं पर शटर बंद करें और क्वार्ट्ज क्रिस्टल सेंसर वापस ले.
5. नाइट्रोजन प्लाज्मा
- वृद्धि कक्ष में एक उच्च एन2 गैस दबाव की उपस्थिति में नुकसान को रोकने के लिए RHEED बंदूक पर फिलामेंट वर्तमान और उच्च वोल्टेज बंद कर दें।
- उच्च दबाव N2 सिलेंडर पर गैस वाल्व खोलें.
- धीरे धीरे रिसाव वाल्व खोलने के विकास कक्ष में नाइट्रोजन दबाव तक पहुँचता है 3 x 10-5-4 x 10-5 Torr.
- प्लाज्मा जनरेटर की शक्ति को 300 डब्ल्यू पर सेट करें।
- प्लाज्मा स्रोत पर प्रज्वालक के साथ प्लाज्मा प्रज्वलित. चित्र 2खमें दर्शाए अनुसार जब प्लाज्मा प्रज्वलित होती है तो दृश्यपोर्ट से एक चमकीली बैंगनी चमक दिखाई देगी।
- संभव के रूप में ज्यादा के रूप में परिलक्षित शक्ति को कम करने के लिए आरएफ मिलान बॉक्स पर नियंत्रण समायोजित करें। 15 W से कम की एक परिलक्षित शक्ति अच्छा है; इस मामले में, परिलक्षित शक्ति 12 W करने के लिए कम है।
6. इन सीटू लेजर लाइट प्रकीर्णन
- एक बिजली के संकेत ताला में एम्पलीफायर द्वारा पता लगाया जा सकता है ताकि सी photodiode पर विकास कक्ष में सब्सट्रेट से परिलक्षित कटा 488 एनएम आर्गन लेजर प्रकाश फोकस. यह सब्सट्रेट धारक को दो अक्षों के चारों ओर घुमाकर और सी डिटेक्टर की स्थिति को समायोजित करके, फिर उस लेंस को केंद्रित करके पूरा किया जाता है जो चित्र 4में दर्शाए अनुसार परावर्तित प्रकाश को एकत्र करता है।
- धातु स्रोतों में से एक का शटर खोलें.
- कंप्यूटर-नियंत्रित डेटा लकड़हारा के साथ समय-निर्भर परावर्तकता रिकॉर्ड करें. एक epitaxial फिल्म के विकास के सामने और पीछे की सतहों के बीच पतली फिल्म ऑप्टिकल हस्तक्षेप के साथ जुड़े समय के साथ एक दोलन परिलक्षित संकेत का उत्पादन होगा.
- फिल्म को हवा में ऑक्सीकरण से बचाने के लिए, फिल्म को हवा में ऑक्सीकरण से बचाने के लिए एक एनकैप्सुलेशन परत जमा करें। यह विशेष रूप से चह3छ2 के लिए महत्वपूर्ण है जो हवा में तेजी से ऑक्सीकरण करता है।
- एक MgO encapsulation परत जमा करने के लिए, नाइट्रोजन गैस बंद, ऑक्सीजन गैस के लिए स्विच, चरण 5.3 दोहराने, और 1 x 10-5 Torr करने के लिए ऑक्सीजन के दबाव में वृद्धि.
- 250 डब्ल्यू करने के लिए प्लाज्मा जनरेटर की शक्ति सेट और कदम 5.5 दोहराएँ. प्लाज्मा नाइट्रोजन गैस के साथ की तुलना में ऑक्सीजन गैस के साथ कम आरएफ शक्ति पर शुरू होता है.
- Mg स्रोत पर शटर खोलें, और 5-10 मिनट के लिए चरण 6.4 दोहराएँ.
नोट: यह एक MgO फिल्म है कि के बारे में 10 एनएम मोटी है का उत्पादन होगा. अनकप्ड Mg3N2 फिल्में पीले रंग की होती हैं, लेकिन हवा के संपर्क में आने पर 20 s के भीतर एक सफेद रंग के लिए जल्दी से फीका हो जाती हैं। नतीजतन, एक encapsulation परत फिल्मों पर माप के लिए समय की अनुमति से पहले वे वैक्यूम कक्ष से हटाने के बाद ऑक्सीकरण की आवश्यकता है. - गैस वाल्व बंद करें, लेजर बंद कर दें, और सब्सट्रेट और सेल तापमान को 30 मिनट में $ 25 डिग्री सेल्सियस तक नीचे रैम्प करें। प्लाज्मा स्रोत के लिए ठंडा पानी और आरएफ शक्ति को बंद कर दें।
- कई विकास रन के बाद, ऑप्टिकल खिड़कियां धातु के साथ कवर हो जाते हैं. एल्यूमीनियम पन्नी में खिड़की लपेटकर धातु निकालें और इसे गर्म करने वाले टेप के साथ 400 डिग्री सेल्सियस और $ 15 डिग्री सेल्सियस/मिनट की तापमान रैंप दर या एक सप्ताह के अंत में धीमी।
7. वृद्धि दर निर्धारण
- नमूने11,19 के प्रकाशिक परावर्तकता का वर्णन करने के लिए नीचे समीकरण 1 का उपयोग करें .
 ①
①
कहां: (1 - क)
(1 - क) (1 - ख)
(1 - ख) (1 - ग)
(1 - ग) (1 - घ)
(1 - घ) - और कहाँ: द 2 र् 1ण्747 488 दउ की तरंगदैर्घ्य पर द व् व् अधारत उपप्रणो का अपवर्तक सूचकांक है; 0 सब्सट्रेट सतह सामान्य के संबंध में मापा घटना बीम का कोण है; और टी समय है. फिल्म के प्रकाशिक स्थिरांक (द1 और ख1) तथा वृद्धि दर समीकरण 1 में समय के एक समारोह के रूप में परावर्तकता को फिट करके प्राप्त की जाती है।
Subscription Required. Please recommend JoVE to your librarian.
Representative Results
चित्र 5 B में इनसेट में काली वस्तु एक के रूप में विकसित 200 एनएम n3एन2 पतली फिल्म की एक तस्वीर है. इसी प्रकार चित्र 5C में इनसेट में पीली वस्तु एक लगभग 220 दउ डह3छ2 पतली फिल्म है। पीली फिल्म इस हद तक पारदर्शी है कि फिल्म10के पीछे आसान-से-पठन पाठ रखा गया है।
सब्सट्रेट की सतह और फिल्मों की निगरानी RHEED द्वारा situ में किया गया. चित्र 5क में उपस्तर की दिशा के साथ इलेक्ट्रॉन बीम घटना के साथ एक नंगे सब्सट्रेट के RHEED पैटर्न को दर्शाता है। चित्र 5खमें जमा की गई फिल्मों के लिए RHEED पैटर्न से पता चलता है कि द3छ2 और डह3छ2 पतली फिल्मों के क्रिस्टल जालक सब्सट्रेट सतह के तल में उन्मुख होते हैं, जैसा कि अधिक्षिप्त के मामले में अपेक्षित होता है विकास. यहाँ इस्तेमाल किया शर्तों के तहत विकास की निगरानी के लिए RHEED का नुकसान यह है कि विकास की प्रक्रिया को 10-7 Torr को ड्रॉप करने के लिए और इलेक्ट्रॉन बंदूक पर बारी करने के लिए दबाव की अनुमति के लिए बंद कर दिया जाना चाहिए.
RHEED के साथ इसके विपरीत, situ ऑप्टिकल परावर्तकता माप कक्ष में दबाव से प्रभावित नहीं होते हैं. वृद्धि दर प्राप्त करने के लिए, समीकरण 1का उपयोग करते हुए चित्र 6 में दर्शाए गए समय के एक समारोह के रूप में सिचुएशन ऑप्टिकल परावर्तकता में फिट थी। इस समीकरण में वृद्धि काल त स्वतंत्र चर है, तथा फिल्म के प्रकाशिक स्थिरांक (द1, छ1) तथा वृद्धि दर उपयुक्त मानदंड हैं। चित्र 6में, द 2 े 1ण्747 , 0 े 36ण्5 डिग्री तथा र् े 488 दउ क्रमशः ग्व् व् व् 747 हैं। फिल्म का संचित अपवर्तक सूचकांक द1 र् 2ण्65 है, विलुप्ति गुणांक ख्1 े 0ण्54 है तथा वृद्धि दर दद 3छ2 पतली फिल्म के लिए 0ण्031 दम् ध/स है जैसा कि चित्र 6कमें दर्शाया गया है। इसी प्रकार ट3छ2 फिल्म के लिए सबसे उपयुक्त अपवर्तक सूचकांक द1 र् 2ण्4 है, विलुप्ति गुणांक ख1 र् 0ण्09 है तथा वृद्धि दर चित्र 6ठमें दर्शाए अनुसार 0ण्033 दउध है। चित्र 6ख में समय के साथ विशिष्ट परावर्तन में समग्र कमी को पृष्ठ खुरदरापन प्रकीर्णन में वृद्धि के कारण माना जाता है क्योंकि डह3छ2 पतली फिल्म मोटी हो जाती है। खुरदरापन प्रकीर्णन का प्रभाव परिकलित परावर्तकता को क्षयी घातीय, ई-जेडटी के साथ गुणा करके अनुकरणित किया गया था, जहाँ र्ं े 810-5 s-1 और वृद्धि समय t सेकंड में मापा.
हवा के संपर्क में आने पर, अनकप्ड पीला Mg3N2 फिल्मों एक पारदर्शी सफेद रंग के लिए मिनट के भीतर फीका. दूसरी ओर, एमजी3छ2 फिल्में जो एमजीओ से सजी थीं, अपेक्षाकृत स्थिर थीं। अपक्की हुई च्घ 3छ2 फिल्मों को ऑक्सीकरण से बचाने के लिए चम् ब3छ2धम्मव् व् हृष्ट-व् यापम को इलेक्ट्रॉन किरण वाष्पन द्वारा जमा की गई केएफ2 परत से लेपित किया गया था। अनकैप्ड एन3एन2 अधिक स्थिर है; हालांकि, शुरू में काले n3एन2 फिल्मों को भी समय के साथ ऑक्सीकरण और कुछ ही महीनों के भीतर ग्रे हो गया. ऐसा माना जाता है कि ऑक्सीकरण अभिक्रिया में मैग्नीशियम हाइड्रॉक्साइड का निर्माण होता है और निम्नरासायनिक अभिक्रिया20के अनुसार अमोनिया छोड़ती है . MgO के लिए एक समान विधि का उपयोग कर जमा एक nO परत भी ऑक्सीकरण को रोकने के लिए एक सुरक्षात्मक परत के रूप में इस्तेमाल किया जा सकता है.
ज3छ2 ़ 6भ्2व् 3 एमजी (OH)2 + 2छ3

चित्र 1 : वीजी V80H आणविक बीम epitaxy विकास कक्ष का दृश्य. इस चित्र के साथ MBE विकास कक्ष से पता चलता है (घड़ी) RHEED स्क्रीन और कैमरा आवास, चौपाई अवशिष्ट गैस विश्लेषक, लेजर प्रकाश प्रकीर्णन बंदरगाह पर ऑप्टिकल हार्डवेयर, Mg बहाव सेल, एन-प्लाज्मा स्रोत, आरएफ मिलान बॉक्स, और n बहाव सेल. कृपया इस चित्र का एक बड़ा संस्करण देखने के लिए यहाँ क्लिक करें.

चित्र 2 : उपस्तर धारक और प्लाज्मा स्रोत से चमक. (क) मोलिब्डेनम नमूना धारक प्लेट जिसमें दो टंगस्टन तार क्लिप ों की होती है जो वर्ग एमजीओ सब्सट्रेट को धारण करती है। (बी) न2 गैस के साथ प्रचालन करते समय प्लाज्मा स्रोत की पिछली खिड़की से उत्पन्न होने वाली बैंगनी चमक। कृपया इस चित्र का एक बड़ा संस्करण देखने के लिए यहाँ क्लिक करें.
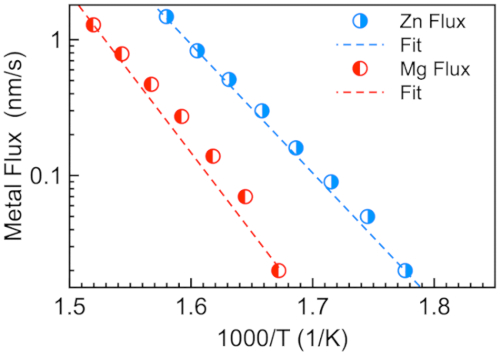
चित्र 3 : बहाव सेल तापमान के एक समारोह के रूप में धातु प्रवाह। रेखाएँ धातु के प्रवाहों की ताप निर्भरता के लिए उपयुक्त हैं, जैसा कि पाठ में चर्चा की गई है। कृपया इस चित्र का एक बड़ा संस्करण देखने के लिए यहाँ क्लिक करें.

चित्र 4 : इन-सीटू लेजर प्रकाश प्रकीर्णन सेटअप के Schematic. कृपया इस चित्र का एक बड़ा संस्करण देखने के लिए यहाँ क्लिक करें.

चित्र 5 : RHEED पैटर्न. (ए) MgO सब्सट्रेट के लिए RHEED विवर्तन पैटर्न. (ख) काले n 3 N 2 फिल्म की तस्वीर केसाथ के रूप में विकसित n3N2 फिल्म के RHEED पैटर्न. (ग) पीले डह 3 छ 2 फिल्म के फोटोग्राफ केसाथ उगी हुई एमजी3छ2 सब्सट्रेट का RHEED पैटर्न। कृपया इस चित्र का एक बड़ा संस्करण देखने के लिए यहाँ क्लिक करें.

चित्र 6 : सीटू में विशिष्ट परावर्तकता। ( क ) की 488 दउ परावर्तक परावर्तन में (क) छ3छ2 तथा (ठ) डह3छ 2 तथा वृद्धि के दौरान छ2 फिल्में। परिकलित परावर्तकता (लाल रेखा) प्रायोगिक डेटा (नीली वृत्त) के लिए सर्वोत्तम रूप से उपयुक्त है जैसा कि पाठ में चर्चा की गई है. कृपया इस चित्र का एक बड़ा संस्करण देखने के लिए यहाँ क्लिक करें.
Subscription Required. Please recommend JoVE to your librarian.
Discussion
विचारकी एक किस्म substrates के चुनाव में शामिल है और विकास की स्थिति है कि फिल्मों के संरचनात्मक और इलेक्ट्रॉनिक गुणों का अनुकूलन की स्थापना. MgO substrates सतह से कार्बन संदूषण को दूर करने और सब्सट्रेट सतह में क्रिस्टलीय क्रम में सुधार करने के लिए हवा (1000 डिग्री सेल्सियस) में उच्च तापमान पर गर्म कर रहे हैं। एसीटोन में अल्ट्रासोनिक सफाई MgO substrates साफ करने के लिए एक अच्छा वैकल्पिक तरीका है।
द द3छ2 फिल्मों के लिए (400) एक्स-रे विवर्तन शिखर तब संकीर्ण पाया गया जब फिल्म उच्च ताप पर उगाई गई थी, जब कि अनालेड सबस्टरेट्स पर उगाए जाने की तुलना में एनेलेड एमजीओ सबस्ट्राट्स। च्व्व् (0ण्421 दउ) की जालक स्थिरांक दद3द2 (0ण्976 दउ) अथवा डह3छ2 (0ण्9995 दउ) की जाली स्थिरांक से काफी कम है तथा अर्धचालक फिल्मों से अच्छी तरह मेल नहीं खाता है। व्यावसायिक रूप से उपलब्ध समूहों IV, III-V तथा II-VI सब्सट्रेट्स की जाली स्थिरांक ोंग3छ2 तथा द द 3 छ3छ2के जालांकों से सभी बड़े होते हैं। एक अधिक अच्छी तरह से मिलान सब्सट्रेट वांछनीय है. सिलिकॉन, जिसमें 0ण्543 दउ का जाली स्थिरांक है,कुछ अधिक अच्छी तरह से Mg3 N2 से MgO से मेल खाता है और इसका पता लगाया जाना उचित है। एन3एन2 फिल्मों को भी ए-प्लेन नीलम सबस्टरेट्स पर उगाया गया था। इन फिल्मों की संरचनात्मक गुणवत्ता उतनी अच्छी नहीं थी जितनी कि एमजीओ सबस्टरेट्स में देखी गई थी, जैसा कि RHEED स्पॉट और चौड़ाई (400) दएन 3छ2 एक्स-रे विवर्तन शिखर द्वारा दर्शाया गया है। नीलम substrates के मामले में, पीठ Cr (50 एनएम) और मो (200 एनएम) के साथ लेपित किया गया था सब्सट्रेट धारक और सब्सट्रेट के बीच थर्मल युग्मन में सुधार करने के लिए.
सब्सट्रेट तापमान सब्सट्रेट धारक और हीटर के बीच संलग्न निर्वात अंतरिक्ष में स्थित एक thermocouple के साथ विकास के दौरान मापा जाता है, और यह सब्सट्रेट धारक या सब्सट्रेट के साथ शारीरिक संपर्क में नहीं है। एक परिणाम के रूप में, यह वास्तविक सब्सट्रेट तापमान सेंसर तापमान से कम होगा कि उम्मीद की गई थी. सफल ठ3छ2 तथा द द3छ2 वृद्धि क्रमशः 300-350 डिग्री सेल्सियस तथा 140-180 डिग्री सेल्सियस श्रेणियों में तापयुग्म ताप ों के साथ प्राप्त की गई।
उच्च वृद्धि तापमान बढ़ती सतह पर विज्ञापन-परमाणुओं की गतिशीलता बढ़ जाती है और कम संरचनात्मक दोषों के साथ सामग्री का उत्पादन करने की उम्मीद की जा सकती है। हालांकि, उच्च सब्सट्रेट तापमान पर, वृद्धि दर कम है, जो सतह से धातु परमाणुओं के पुन: वाष्पीकरण के कारण होने के रूप में व्याख्या की है। उच्च धातु फ्रलक्स में, फिल्म वृद्धि दर सक्रिय नाइट्रोजन की आपूर्ति द्वारा सीमित है। सक्रिय नाइट्रोजन उच्च आरएफ शक्ति प्लाज्मा स्रोत के लिए लागू पर अधिकतम है (300 डब्ल्यू अधिकतम) और एक उच्च नाइट्रोजन प्रवाह दर पर. N2 प्रवाह दर वृद्धि कक्ष में अधिकतम दबाव द्वारा सीमित है, जो इस मामले में मध्य 10-5 Torr रेंज में था. अमोनिया एक संभावित वैकल्पिक नाइट्रोजन स्रोत है। Mg और n n प्लाज्मा सक्रियण के बिना एक उच्च तापमान पर एनएच3 के साथ प्रतिक्रिया होगी; तथापि, यह स्पष्ट नहीं है कि क्या सतह पर मिलीग्राम और दद परमाणुओं का निवास समय लंबे समय तक उन तापमानों पर फिल्म वृद्धि का समर्थन करेगा जिसके लिए एनएच3 धातुओं के साथ प्रतिक्रिया करेगा।
इन प्रयोगों में, उत्सर्जन कोशिकाओं का उपयोग पायरोलिटिक बोरोन नाइट्राइड (पीबीएन) क्रूसिबल के साथ किया जाता था, जिसकी क्षमता 40 सृग के लिए उग और द के लिए 25 सीसी होती थी। चित्र 3 यह दर्शाता है कि उंबरज तथा द फ्रलक्स की ताप निर्भरता बहाव कोशिकाओं से होती है। चित्र 3 में सीधी रेखाएँ फ्लक्सों की मापित ताप निर्भरता के लिए उपयुक्त होती हैं। फिट्स में फ्लक्स का रूप है - एक एक्सप (-बी/केटी), और फिटिंग पैरामीटर (ए, बी) क्रमशः (8.5 x 1017 एनएम, 2.3 ईवी) और (1.3 x 1015 एनएम/s, 1.9 ईवी) हैं। फ्रलक्स क्रमशः प्रत्येक 10 डिग्री सेल्सियस और 12 डिग्री सेल्सियस के साथ वृद्धि के साथ वृद्धि के लिए उब और द के लिए बहाव सेल तापमान में वृद्धि। चित्र 6में सचित्र वृद्धि के लिए, धातु फ्रलक्स चित्र 3 में अधिकतमा के निकट थे ($1 दउ/ यह दर्शाता है कि धातु उपयोग दक्षता कम है, के साथ एमजी से कम किया जा रहा है n और धातु के अधिकांश फिर से वाष्पित.
विकास के दौरान उच्च एन2 पृष्ठभूमि दबाव RHEED के साथ फिल्म विकास की निरंतर निगरानी precludes. RHEED बंदूक के विभेदक पम्पिंग इस समस्या को हल कर सकते हैं. situ ऑप्टिकल परावर्तकता माप में एक पूरक निगरानी उपकरण है कि गैस के दबाव से प्रभावित नहीं है और विकास दर का निर्धारण करने के लिए एक सटीक और विश्वसनीय तकनीक प्रदान करता है के रूप में सेवा करते हैं. सब्सट्रेट के गैर-स्पेलर या विसरित परावर्तकता को भी सीटू में मापा जा सकता है और विकास के दौरान सतह खुरदरापन के बारे में जानकारी प्रदान करेगा।
MBE विकास कक्ष में आधार दबाव है 10-8 Torr के साथ एन2 गैस बंद कर दिया. फिल्म विकास के दौरान विकास कक्ष में क्रायोश्वेशकोश को पानी से ठंडा किया जाता है। इन परिस्थितियों में, फिल्मों में कुछ अवशिष्ट ऑक्सीजन संदूषण की उम्मीद की जा सकती है। विकास कक्ष में अवशिष्ट जलवाष्प दाब को कफन में कम तापमान शीतलक के साथ कम किया जा सकता है, जैसे -80 डिग्री सेल्सियस21पर सिलिकॉन तेल ।
अंत में, इस प्रोटोकॉल का वर्णन कैसेएक क्रिस्टल फिल्मों के विकसित करने के लिए 3 एन2 और n3N2 प्लाज्मा की मदद से आणविक बीम epitaxy द्वारा और कैसे विकास की प्रक्रिया को आगे फिल्म में सुधार करने के लिए बदला जा सकता है के लिए सुझाव प्रदान करता है गुणवत्ता. इन सामग्रियों ने या तो कमरे के तापमान या कम तापमान पर प्रकाश-प्रकाशता नहीं दिखाई। फिल्मों में दोष घनत्व को और कम करने की आवश्यकता है। दं शह 3 छ2-द3छ2 मिश्र धातुओं को प्लाज्मा-सहायता प्राप्त आण्विक किरण-तापकरिता द्वारा भी उगाया जा सकता है।
Subscription Required. Please recommend JoVE to your librarian.
Disclosures
लेखकों को खुलासा करने के लिए कुछ भी नहीं है.
Acknowledgments
इस काम को कनाडा के प्राकृतिक विज्ञान और इंजीनियरिंग अनुसंधान परिषद द्वारा समर्थित किया गया था।
Materials
| Name | Company | Catalog Number | Comments |
| (100) MgO | University Wafer | 214018 | one side epi-polished |
| Acetone | Fisher Chemical | 170239 | 99.8% |
| Argon laser | Lexel Laser | 00-137-124 | 488 nm visible wavelength, 350 mW output power |
| Chopper | Stanford Research system | SR540 | Max. Frequency: 3.7 kHz |
| Lock-in amplifier | Stanford Research system | 37909 | DSP SR810, Max. Frequency: 100 kHz |
| Magnesium | UMC | MG6P5 | 99.9999% |
| MBE system | VG Semicon | V80H0016-2 SHT 1 | V80H-10 |
| Methanol | Alfa Aesar | L30U027 | Semi-grade 99.9% |
| Nitrogen | Praxair | 402219501 | 99.998% |
| Oxygen | Linde Gas | 200-14-00067 | > 99.9999% |
| Plasma source | SVT Associates | SVTA-RF-4.5PBN | PBN, 0.11" Aperture, Specify Length: 12" – 20" |
| Si photodiode | Newport | 2718 | 818-UV Enhanced, 200 - 1100 nm |
| Zinc | Alfa Aesar | 7440-66-6 | 99.9999% |
References
- Suda, T., Kakishita, K. Band-gap energy and electron effective mass of polycrystalline Zn3N2. Journal of Applied Physics. 99 (7), 076101.1-076101.3 (2006).
- Hu, J., Bando, Y., Zhan, J., Zhi, C., Golberg, D. Carbon nanotubes as nanoreactors for fabrication of single-crystalline Mg3N2 nanowires. Nano Letters. 6 (6), 1136-1140 (2006).
- Fang, C. M., Groot, R. A., Bruls, R. J., Hintzen, H. T., With, G. Ab initio band structure calculations of Mg3N2 and MgSiN2. Journal of Physics: Condensed Matter. 11 (25), 4833-4842 (1999).
- Yoo, S. H., Walsh, A., Scanlonc, D. O., Soon, A. Electronic structure and band alignment of zinc nitride, Zn3N2. RSC Advances. 4 (7), 3306-3311 (2014).
- Partin, D. E., Williams, D. J., O'Keeffe, M. The crystal structures of Mg3N2 and Zn3N2. Journal of Solid-State Chemistry. 132 (1), 56-59 (1997).
- Ullah, M., Murtaza, G., Ramay, S. M., Mahmood, A. Structural, electronic, optical and thermoelectric properties of Mg3X2 (X = N, P, As, Sb, Bi) compounds. Materials Research Bulletin. 91, 22-30 (2017).
- Li, C. T. Electrocatalytic zinc composites as the efficient counter electrodes of dye-sensitized solar cells: study on the electrochemical performance and density functional theory Calculations. ACS Applied Materials & Interfaces. 7 (51), 28254-28263 (2015).
- Sinha, S., Choudhury, D., Rajaraman, G., Sarkar, S. Atomic layer deposition of Zn3N2 thin films: growth mechanism and application in thin film transistor. RSC Advances. 5 (29), 22712-22717 (2015).
- Bhattacharyya, S. R., Ayouchi, R., Pinnisch, M., Schwarz, R. Transfer characteristic of zinc nitride based thin film transistors. Physica Status Solidi C. 9 (3-4), 469-472 (2012).
- Wu, P., Tiedje, T. Molecular beam epitaxy growth and optical properties of Mg3N2 films. Applied Physics Letters. 113 (8), 082101.1-082101.4 (2018).
- Wu, P., et al. Molecular beam epitaxy growth and optical properties of single crystal Zn3N2 films. Semiconductor Science and Technology. 31 (10), 10LT01.1-10LT01.4 (2016).
- Jiang, N., Georgiev, D. G., Jayatissa, A. H. The effects of the pressure and the oxygen content of the sputtering gas on the structure and the properties of zinc oxy-nitride thin films deposited by reactive sputtering of zinc. Semiconductor Science and Technology. 28 (2), 025009 (2013).
- Nakano, Y., Morikawa, T., Ohwaki, T., Taga, Y. Electrical characterization of p-type N-doped ZnO films prepared by thermal oxidation of sputtered Zn3N2 films. Applied Physics Letters. 88 (17), 172103.1-172103.3 (2006).
- Cao, X., Yamaguchi, Y., Ninomiya, Y., Yamada, N. Comparative study of electron transport mechanisms in epitaxial and polycrystalline zinc nitride films. Journal of Applied Physics. 119 (2), 025104.1-025104.10 (2016).
- Jia, J., Kamijo, H., Nakamura, S., Shigesato, Y. How the sputtering process influence structural, optical, and electrical properties of Zn3N2 films. MRS Communications. 8 (2), 314-321 (2018).
- Trapalis, A., Hefferman, J., Farrer, I., Sherman, J., Kean, A. Structural, electrical and optical characterization of as-grown and oxidized zinc nitride films. Journal of Applied Physics. 120 (20), 205102.1-205102.9 (2016).
- Núñez, C. G., et al. On the zinc nitride properties and the unintentional incorporation of oxygen. Thin Solid Films. 520 (6), 1924-1929 (2012).
- Oshima, T., Fujita, S. (111)-oriented Zn3N2 growth on a-plane sapphire substrates by molecular beam epitaxy. Japanese Journal of Applied Physics. 45 (111), 8653-8655 (2006).
- Heavens, O. S. Optical properties of thin solid films. , Butterworth, London. 46-48 (1955).
- Heyns, A. H., Prinsloo, L. C., Range, K. J., Stassen, M. The vibrational spectra and decomposition of α-calcium nitride (α-Ca3N2) and magnesium nitride (Mg3N2). Journal of Solid-State Chemistry. 137, 33-41 (1998).
- Lewis, R. B., Bahrami-Yekta, V., Patel, M. J., Tiedje, T., Masnadi-Shirazi, M. Closed-cycle cooling of cryopanels in molecular beam epitaxy. Journal of Vacuum Science Technology B. 32 (2), 02C102.1-02C102.7 (2014).



 ①
① (1 - क)
(1 - क) (1 - ख)
(1 - ख) (1 - ग)
(1 - ग) (1 - घ)
(1 - घ)