Summary
Questo articolo descrive la crescita delle pellicole epitassiali di Mg3N2 e n3N2 sui substrati MgO mediante epitassia molecolare assistita da plasma con gas N2 come fonte di azoto e monitoraggio della crescita ottica.
Abstract
Questo articolo descrive una procedura per la coltivazione di pellicole Mg3N2 e N2 n da epitassoia del fascio molecolare assistita da plasma (MBE). I film sono coltivati su 100 substrati MgO orientati con gas N2 come fonte di azoto. Vengono descritti il metodo per preparare i substrati e il processo di crescita MBE. L'orientamento e l'ordine cristallino del substrato e della superficie della pellicola sono monitorati dalla diffrazione degli elettroni ad alta energia di riflessione (RHEED) prima e durante la crescita. La riflettività speculare della superficie del campione viene misurata durante la crescita con un laser Ar-ion con una lunghezza d'onda di 488 nm. Adattando la dipendenza temporale della riflettività a un modello matematico, vengono determinati l'indice di rifrazione, il coefficiente di estinzione ottica e il tasso di crescita del film. I flussi metallici sono misurati in modo indipendente in funzione delle temperature delle cellule di effusione utilizzando un monitor a cristalli di quarzo. I tassi di crescita tipici sono pari a 0,028 nm/s a temperature di crescita rispettivamente di 150 e 330 gradi centigradi per i film Mg3N2 e n3N2.
Introduction
I materiali II3-V2 sono una classe di semiconduttori che hanno ricevuto relativamente poca attenzione da parte della comunità di ricerca dei semiconduttori rispetto ai semiconduttori III-V e II-VI1. I nitrati mg e n, Mg3N2 e n3N2, sono attraenti per le applicazioni dei consumatori perché sono composti da elementi abbondanti e non tossici, rendendoli poco costosi e facili da riciclare a differenza della maggior parte III-V e II-VI semiconduttori composti. Mostrano una struttura cristallina anti-bixbyite simile alla struttura CaF 2, con uno dei sublattici fcc F interpenetranti semi-occupati2,3,4,5. Sono entrambi materiali digap banda diretta6, che li rende adatti per applicazioni ottiche7,8,9. Il gap di banda di Mg3N2 è nello spettro visibile (2,5 eV)10, e il divario di banda di n3N2 è nel vicino infrarosso (1,25 eV)11. Per esplorare le proprietà fisiche di questi materiali e il loro potenziale per le applicazioni di dispositivi elettronici e ottici, è fondamentale ottenere pellicole a cristalli singoli di alta qualità. La maggior parte dei lavori su questi materiali è stata effettuata su polveri o pellicole policristalline realizzate da sputtering reattivi12,13,14,15,16, 17.
L'episale molecolare (MBE) è un metodo ben sviluppato e versatile per la crescita di pellicole semiconduttori composti monocristalli18 che hanno il potenziale per produrre materiali di alta qualità utilizzando un ambiente pulito e fonti elementali ad alta purezza. Nel frattempo, l'azione rapida dell'otturatore MBE consente modifiche a una pellicola su scala atomica e consente un controllo preciso dello spessore. Questo documento riporta la crescita delle pellicole epitassiali Mg3N2 e n3N2 sui substrati MgO da MBE assistiti dal plasma, utilizzando l'alta purezza di N e Mg come fonti di vapore e gas N2 come fonte di azoto.
Subscription Required. Please recommend JoVE to your librarian.
Protocol
1. Preparazione del substrato MgO
NOTA: per la crescita della pellicola sottile X 3 N 2 (X ) e Mg sono stati impiegati per la crescita della pellicola sottile X3N2 (X ) e Mg.
- Annessione ad alta temperatura
- Posizionare l'MgO su un portarone di cialco pulito con il lato lucido rivolto verso l'alto in un forno e anneal per 9 h a 1.000 gradi centigradi. Alzare la temperatura a 1000 gradi centigradi per un periodo di 10 min.
NOTA: l'annealing ad alta temperatura rimuove il carbonio dalla superficie e ricostruisce la struttura cristallina della MgO a singolo cristallo. - Raffreddare il MgO substrati alla temperatura ambiente (RT).
- Posizionare l'MgO su un portarone di cialco pulito con il lato lucido rivolto verso l'alto in un forno e anneal per 9 h a 1.000 gradi centigradi. Alzare la temperatura a 1000 gradi centigradi per un periodo di 10 min.
- Pulizia del substrato
- Raccogliere i substrati MgO annessi e risciacquare in acqua deionizzata in un bicchiere di vetro borosilicate pulito.
- Far bollire i substrati MgO in 100 mL di acetone in un bicchiere di vetro borosilicate da 250 ml per 30 min per rimuovere la contaminazione in organico dalla manipolazione.
NOTA: Coprire il becher e non lasciare che l'acetone si asciughi. - Scolare l'acetone e sciacquare i substrati MgO in 50 mL di metanolo.
- Asciugare a secco i substrati con gas di azoto, quindi conservare i substrati secchi e puliti nel vassoio del truciolo pulito.
2. Funzionamento di VG V80 MBE
- Aprire l'acqua di raffreddamento per la camera di preparazione, crioshroud sulla camera di crescita (vedere figura1), cellule di effusione, e sensore di microbilanciamento di cristallo di quarzo.
- Accendere il laser Ar-ion con una lunghezza d'onda di 488 nm. La luce laser viene portata alla camera MBE con una fibra ottica dal laser, che si trova in un'altra stanza.
- Accendere il fuoco di pistola di diffrazione di elettroni ad alta energia (RHEED), 13.56 Mhz radiofrequenza (rf) generatore di plasma, e sistema di microbilanciamento di cristallo di quarzo (QCM).
3. Caricamento substrato
- Blocco rapido dell'ingresso
- Montare un substrato MgO pulito sul supporto del campione molybdenum (Figura 2A) utilizzando le clip molla di tungsteno.
- Spegnere la pompa turbo sulla serratura ad ingresso veloce (FEL) e sfiatare la camera FEL con azoto. Aprire il FEL quando la pressione della camera raggiunge la pressione atmosferica.
- Rimuovere la cassetta del supporto del campionatore dal FEL e caricare il supporto del campione con il substrato nella cassetta.
- Caricare nuovamente la cassetta nel FEL e riaccendere la pompa turbo.
- Attendere che la pressione nel FEL scunisca a 10-6 Torr.
- Aumentare la temperatura della serratura di ingresso veloce a 100 gradi centigradi per un periodo di 5 min e degas i substrati con i supporti per 30 min nella serratura di ingresso veloce.
- Assicurarsi che la pressione nella serratura di entrata rapida sia inferiore a 10-7 Torr prima di aprire la valvola a vuoto nella camera di preparazione. Trasferire il supporto utilizzando il meccanismo di trasferimento del bastone oscillante alla camera di preparazione, quindi diramare la stazione di degassamento a 400 gradi centigradi e lasciarlo degas per 5 h.
- Trasferire il supporto degassato dal meccanismo di trasferimento del carrello al manipolatore del campione nella camera di crescita. Aumentare la temperatura del substrato fino a 750 gradi centigradi per un periodo di 30 min e lasciare che il campione esagi nel manipolatore per altri 30 min. Assicurarsi che l'acqua di raffreddamento sia accesa nel crioshroud per evitare di surriscaldare il crioshroud.
- Abbassate la temperatura del substrato a 150 gradi per la crescita della pellicolan 3N2 e di 330 gradi per la crescita della pellicola Mg3N2 utilizzando la termocoppia nel manipolatore campione per misurare la temperatura del campione.
- RHEED in loco
- Impostare la tensione sulla pistola elettronica a 15 kV e la corrente di filamento a 1,5 A una volta che la pressione della camera di crescita è inferiore a 1 x 10-7 Torr.
- Ruotare il supporto del substrato fino a 1) la pistola elettronica è allineata lungo un asse cristallografico principale del substrato e 2) è visibile un modello di diffrazione chiaro di elettroni a cristallo.
- Scattare una foto del modello RHEED e salvare l'immagine.
- Chiudere l'otturatore sulla cella di effusione e fermare il flusso di azoto. Misurare il modello RHEED per la pellicola depositata quando la pressione della camera è inferiore a 10-7 Torr.
4. Misurazioni del flusso metallico
- Utilizzare cellule effusioni di tipo tipo tipo III standard di gruppo III o cellule di effusione a bassa temperatura per Mg e N.
- Caricare i crogioli con 15 g e 25 g di alta purezza Mg e n colpo, rispettivamente.
- Quando la camera di crescita ha raggiunto un vuoto di 10-8 Torr o meglio, e prima di caricare il supporto del substrato, outgas le cellule di effusione di origine n o Mg fino a 250 gradi centigradi ad una velocità di rampa di 20 .
- Dopo che il substrato è stato caricato nel manipolatore del campione, riscaldare le cellule di effusione di N e/o Mg rispettivamente a 350 o 390 gradi centigradi, ad una velocità di rampa di 10 gradi centigradi/min, e attendere 10 minuti affinché si stabilizzino con le persiane chiuse.
- Utilizzare il monitor a cristalli di quarzo retrattile per misurare il flusso di metallo. Posizionare il sensore di cristallo di quarzo davanti al substrato all'interno della camera. Assicurarsi che il substrato sia completamente coperto dal rivelatore in modo che nessun metallo sia depositato sul substrato.
- Inserire la densità del metallo di interesse (7,14 g/cm3,MG - 1,74 g/cm3) nel controller del monitor di cristallo al quarzo (QCM).
- Per calibrare il flusso, aprire l'otturatore per una delle sorgenti metalliche e lasciare che la cella di effusione si depositi sul sensore. Il sistema QCM converte la sua misura interna della massa in spessore.
- Calcolare il flusso elementale dalla pendenza dello spessore crescente in funzione del tempo mostrato sul QCM. Il tasso di aumento dello spessore in pochi minuti è proporzionale al flusso elementare. In due casi di esempio, si ottiene un flusso di 0,45 nm/s e un flusso Mg di 1,0 nm/s.
- Modificare la temperatura delle cellule di effusione e ripetere il passaggio 4.8 se è necessaria la dipendenza di temperatura del flusso. La dipendenza di temperatura misurata del flusso di Mg e n è illustrata nella Figura 3 per questo specifico sistema di crescita.
- Una volta completate le misurazioni del flusso, chiudere le persiane sulle cellule di effusione e ritrarre il sensore di cristallo di quarzo.
5. Plasma di azoto
- Spegnere la corrente di filamento e l'alta tensione sulla pistola RHEED per evitare danni in presenza di un'alta pressione di gas N2 nella camera di crescita.
- Aprire la valvola di gas sull'alta pressione N2 cilindri.
- Aprire lentamente la valvola di perdita lentamente fino a quando la pressione dell'azoto nella camera di crescita raggiunge 3 x 10-5 -4x 10-5 Torr.
- Impostare la potenza del generatore di plasma su 300 W.
- Accendere il plasma con l'accensione sulla fonte del plasma. Un bagliore viola brillante sarà visibile dalla finestra quando il plasma si accende, come mostrato nella Figura 2B.
- Regolare il controllo sulla casella di corrispondenza rf per ridurre al minimo la potenza riflessa il più possibile. Una potenza riflessa inferiore a 15 W è buona; in questo caso, la potenza riflessa viene ridotta a 12 W.
6. Dispersione della luce laser in situ
- Concentrare la luce laser Argon tritata da 488 nm riflessa dal substrato nella camera di crescita sul fotodiodo Si in modo che un segnale elettrico possa essere rilevato dall'amplificatore lock-in. Ciò si ottiene regolando l'angolo del substrato ruotando il supporto del substrato intorno a due assi e regolando la posizione del rivelatore Si, quindi mettendo a fuoco l'obiettivo che raccoglie la luce riflessa come mostrato nella Figura 4.
- Aprire l'otturatore di una delle sorgenti metalliche.
- Registrare la riflettività dipendente dal tempo con un data logger controllato dal computer. La crescita di una pellicola epitassia leviale produrrà un segnale riflesso oscillato con il tempo associato all'interferenza ottica della pellicola sottile tra le superfici anteriore e posteriore della pellicola.
- Per proteggere la pellicola dall'ossidazione nell'aria, depositare uno strato di incapsulamento per proteggere la pellicola dall'ossidazione nell'aria. Questo è particolarmente importante per Mg3N2 che si ossida rapidamente in aria.
- Per depositare uno strato di incapsulamento MgO, chiudere il gas di azoto, passare al gas di ossigeno, ripetere il passaggio 5.3 e aumentare la pressione dell'ossigeno a 1 x 10-5 Torr.
- Impostare la potenza del generatore di plasma su 250 W e ripetere il passaggio 5.5. Il plasma inizia a una potenza rf inferiore con gas di ossigeno rispetto al gas di azoto.
- Aprire l'otturatore sulla sorgente Mg e ripetere il passaggio 6.4 per 5-10 min.
NOTA: Questo produrrà un film MgO che è di circa 10 nm di spessore. I film Mg3N2 non conseriti sono gialli ma svaniscono rapidamente a un colore biancastro entro 20 s dopo l'esposizione all'aria. Di conseguenza, è necessario uno strato di incapsulamento per consentire le misurazioni sulle pellicole prima che si ossichino dopo la rimozione dalla camera a vuoto. - Chiudere le valvole di gas, spegnere il laser e abbassare il substrato e le temperature delle cellule a 25 gradi centigradi in 30 min. spegnere l'acqua di raffreddamento e l'alimentazione rf alla fonte di plasma.
- Dopo diversi cicli di crescita, le finestre ottiche diventano ricoperte di metallo. Rimuovere il metallo avvolgendo la finestra in un foglio di alluminio e riscaldandolo con nastro riscaldante a 400 gradi centigradi e un tasso di rampa di temperatura di 15 s/min o più lento nel corso di un fine settimana.
7. Determinazione del tasso di crescita
- Utilizzare l'equazione 1 riportata di seguito per descrivere la riflettività ottica dell'esempio11,19.
 ①
①
dove: (1 - a)
(1 - a) (1 - b)
(1 - b) (1 - c)
(1 - c) (1 - d)
(1 - d) - E dove: n2 - 1.747 è l'indice di rifrazione del substrato MgO ad una lunghezza d'onda di 488 nm; 0 è l'angolo del fascio incidente misurato rispetto alla normale della superficie del substrato; e t è il tempo. Le costanti ottiche della pellicola (n1 e k1) e il tasso di crescita si ottengono adattando la riflettività in funzione del tempo nell'equazione 1.
Subscription Required. Please recommend JoVE to your librarian.
Representative Results
L'oggetto nero nell'insetto in Figura 5B è una fotografia di un come-cresciuto 200 nmn n 3N2 pellicola sottile. Allo stesso modo, l'oggetto giallo nell'insetto in Figura 5C è un come-cresciut2 Mg3N2 pellicola sottile. La pellicola gialla è trasparente nella misura in cui è di facile lettura del testo posto dietro la pellicola10.
La superficie del substrato e delle pellicole sono state monitorate in loco da RHEED. La figura 5A mostra il modello RHEED di un substrato nudo con l'incidente del fascio di elettroni lungo la direzione [110] del substrato. I modelli RHEED per le pellicole depositate in Figura 5B,C mostrano che i reticoli di cristallo delle pellicole sottili n.3N2 e Mg3N2 sono orientati nel piano della superficie del substrato, come previsto nel caso di epitassiali crescita. Lo svantaggio di RHEED per il monitoraggio della crescita nelle condizioni utilizzate qui è che il processo di crescita deve essere interrotto per consentire alla pressione di scendere a 10-7 Torr e accendere la pistola elettronica.
A differenza di RHEED, le misurazioni di riflettività ottica in situ non sono influenzate dalla pressione nella camera. Per ottenere il tasso di crescita, la riflettività ottica in situ era adatta in funzione del tempo illustrato nella Figura 6 utilizzando l'equazione 1. In questa equazione, il tempo di crescita t è la variabile indipendente e le costanti ottiche della pellicola (n1, k1) e il tasso di crescita sono parametri di adattamento. Nella Figura 6, l'indice di rifrazione del substrato MgO, l'angolo di incidenza e la lunghezza d'onda sono rispettivamente pari a 2x1,747, 0 , 0 , 36,5 e 488 nm. L'indice di refrattiva montato del film è n1 - 2,65, il coefficiente di estinzione è k1 - 0,54, e il tasso di crescita è di 0,031 nm/s per la pellicola sottile n3N2 come mostrato nella Figura 6A. Allo stesso modo, l'indice di rifrazione più adatto per il film Mg3N2 è n1 , 2,4, il coefficiente di estinzione è k1 e 0,09 e il tasso di crescita è di 0,033 nm/s come illustrato nella Figura 6B. Si ritiene che la diminuzione complessiva della riflessione speculare con il tempo in Figura 6B sia causata da un aumento della dispersione della rugosità superficiale man mano che la pellicola sottile Mg3N2 diventa più spessa. L'effetto della dispersione di rugosità è stato simulato moltiplicando la riflettività calcolata con un esponenziale decrescente, e-zt, dove il valore di 810-5 s-1 è misurate in pochi secondi.
Dopo l'esposizione all'aria, i film gialli Mg3N2 non ricoperti sbiadito in pochi minuti ad un colore bianco traslucido. D'altra parte, i film Mg3N2 che erano coronati da MgO erano relativamente stabili. Per proteggere ulteriormente le pellicole Mg3N2 dal limite di ossidazione, le eterostrutture Mg3N2/MgO sono state rivestite con uno strato CaF2 depositato dall'evaporazione del fascio di elettroni. Uncappedn 3N2 è più stabile; tuttavia, i film inizialmente neri n.3N2 si ossidarono nel tempo e divennero grigi nel giro di pochi mesi. Si ritiene che la reazione di ossidazione coinvolga la formazione di idrossido di magnesio e rilasci l'ammoniaca secondo la seguente reazione chimica20. Uno strato di nO depositato con un metodo simile all'MgO può anche essere utilizzato come strato protettivo per prevenire l'ossidazione.
Mg3N2 - 6H2O 3Mg(OH)2 - 2NH3

Figura 1 : Vista della camera di crescita epitaxy del fascio molecolare VG V80H. Questa immagine mostra la camera di crescita MBE con alloggiamento dello schermo e della fotocamera RHEED, l'analizzatore di gas residuo quadruplo, l'hardware ottico sulla porta di dispersione della luce laser, la cella di effusione Mg, la fonte N-plasma, la scatola di corrispondenza rf e la cella effusione di n. Fare clic qui per visualizzare una versione più grande di questa figura.

Figura 2 : Supporto del substrato e bagliore dalla fonte di plasma. (A) Piastra portacampione Molybdenum con due clip di filo di tungsteno che tengono in posizione il substrato MgO quadrato. (B) Bagliore viola proveniente dalla finestra posteriore della sorgente plasma quando si opera con gas N2. Fare clic qui per visualizzare una versione più grande di questa figura.
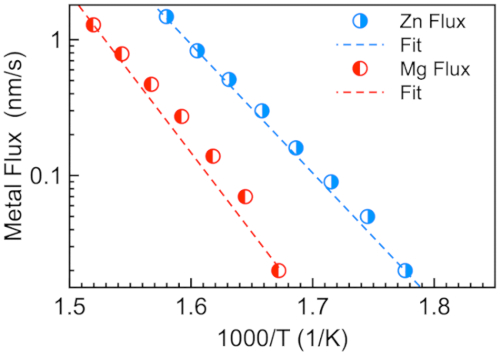
Figura 3 : flusso metallico in funzione della temperatura delle cellule di effusione. Le linee sono adattate alla dipendenza della temperatura dei flussi metallici utilizzando una relazione Arrhenius come discusso nel testo. Fare clic qui per visualizzare una versione più grande di questa figura.

Figura 4 : schematica dell'impostazione della dispersione della luce laser in situ. Fare clic qui per visualizzare una versione più grande di questa figura.

Figura 5 : modelli RHEED. (A) Modello di diffrazione RHEED per substrato MgO. (B) Modello RHEED del film as-grownn 3N2 con fotografia del film neron 3N2. (C) Modello RHEED del substrato Mg3N2 coltivato con fotografia della pellicola gialla Mg3N2. Fare clic qui per visualizzare una versione più grande di questa figura.

Figura 6 : Riflettività speculare in situ. Riflessione speculare in situ a 488 nm di (A) n3N2 e (B) Mg3N2 film durante la crescita. La riflettività calcolata (linea rossa) è adatta ai dati sperimentali (cerchi blu) come descritto nel testo. Fare clic qui per visualizzare una versione più grande di questa figura.
Subscription Required. Please recommend JoVE to your librarian.
Discussion
Una varietà di considerazioni è coinvolta nella scelta dei substrati e nello stabilire le condizioni di crescita che ottimizzano le proprietà strutturali ed elettroniche dei film. I substrati MgO vengono riscaldati ad alta temperatura nell'aria (1000 gradi centigradi) per rimuovere la contaminazione da carbonio dalla superficie e migliorare l'ordine cristallino nella superficie del substrato. La pulizia ad ultrasuoni in acetone è un buon metodo alternativo per pulire i substrati MgO.
Il picco di diffrazione a raggi X (400) per i film n.3N2 è risultato essere più stretto quando il film è stato coltivato su substrati MgO ad alta temperatura, annealed rispetto a quando coltivato su substrati non ananneggiati. La costante del reticolo di MgO (0,421 nm) è significativamente più piccoladella (metà) della costante del reticolo di N2 (0,976 nm) o Mg3N2 (0,995 nm) e non ben abbinata alle pellicole semiconduttori. Le costanti reticolare dei gruppi disponibili in commercio IV, III-V e II-VI sono tutte più grandi delle costanti del reticolo di Mg3N2 e n3N2. Un substrato più ben abbinato è auspicabile. Il silicio, che ha una costante reticolare di 0,543 nm, è un po 'più ben abbinato a Mg3N2 di MgO e vale la pena di essere esplorato. Sono stati coltivati anche film n.3N2 su substrati di zaffiro A-plane. La qualità strutturale di questi film non era buona come quella vista nei substrati MgO, come indicato dalle macchie RHEED e dalla larghezza del picco di diffrazione a raggi X (400) n3N2. Nel caso dei substrati di zaffiro, il retro era rivestito con Cr (50 nm) e Mo (200 nm) per migliorare l'accoppiamento termico tra il supporto del substrato e il substrato.
La temperatura del substrato viene misurata durante la crescita con una termocoppia situata nello spazio vuoto chiuso tra il supporto del substrato e il riscaldatore, e non è in contatto fisico con il supporto del substrato o il substrato. Di conseguenza, ci si aspettava che la temperatura effettiva del substrato fosse inferiore alla temperatura del sensore. Le escrescenze di successo di Mg3N2 e n3N2 sono state ottenute con temperature termoaccoppiate rispettivamente nelle gamme 300-350 e 140-180 gradi centigradi.
L'elevata temperatura di crescita aumenta la mobilità degli ad-atomi sulla superficie di crescita e ci si può aspettare di produrre materiale con meno difetti strutturali. Tuttavia, a temperature elevate del substrato, il tasso di crescita è più basso, che viene interpretato come dovuto alla rievaporazione degli atomi metallici dalla superficie. Ad alto flusso di metalli, il tasso di crescita della pellicola è limitato dalla fornitura di azoto attivo. L'azoto attivo è massimizzato ad alta potenza rf applicata alla fonte di plasma (300 W max) e ad un'elevata portata di azoto. La portata N2 è limitata dalla pressione massima nella camera di crescita, che in questo caso era nella fascia media 10-5 Torr. L'ammoniaca è una possibile fonte alternativa di azoto. Mg e N reagiranno con NH3 ad alta temperatura senza attivazione del plasma; tuttavia, non è chiaro se il tempo di residenza degli atomi di Mg e N sulla superficie sarà abbastanza lungo da sostenere la crescita della pellicola a temperature per le quali NH3 reagirà con i metalli.
In questi esperimenti, le cellule di effusione sono state utilizzate con crogioli di nitrato di boro pirolitico (PBN) con capacità di 40 cc per Mg e 25 cc per la figura 3 mostra la dipendenza dalla temperatura dei flussi di Mg e n dalle cellule di effusione. Le linee rette nella figura 3 sono adeguate alla dipendenza di temperatura misurata dei flussi. Le vestibilità hanno il formato Flusso - A exp(-B/kT)e i parametri di raccordo (A,B) sono (8,5 x 1017 nm/s, 2,3 eV) e (1,3 x 1015 nm/s, 1,9 eV) rispettivamente per le origini Mg e n. Il flusso raddoppia approssimativamente con ogni 10oC e 12 gradi centigradi aumentano la temperatura delle cellule di effusione rispettivamente per Mg e N. Per la crescita illustrata nella Figura 6, i flussi metallici erano vicini al massimo nella Figura 3 (1 nm/s con flusso Mg superiore a quello del flusso n), ma i tassi di crescita del film erano solo 0,03 nm/s. Questo dimostra che l'efficienza di utilizzo dei metalli è bassa, con Mg che è inferiore a .n e la maggior parte del metallo che rievapora.
L'elevata pressione di fondo N2 durante la crescita preclude il monitoraggio continuo della crescita del film con RHEED. Pompaggio differenziale della pistola RHEED può risolvere questo problema. Le misurazioni della riflettività ottica in situ fungono da strumento di monitoraggio complementare che non è influenzato dalla pressione del gas e fornisce una tecnica accurata e affidabile per determinare il tasso di crescita. La riflettività non speculare o diffusa del substrato può anche essere misurata in situ e fornirà informazioni sulla rugosità della superficie durante la crescita.
La pressione di base nella camera di crescita MBE è 10-8 Torr con il gas N2 spento. Il crioshroud nella camera di crescita viene raffreddato con acqua durante la crescita del film. In queste condizioni, ci si può aspettare una contaminazione residua dell'ossigeno nei film. La pressione residua del vapore acqueo nella camera di crescita può essere ridotta con un refrigerante a temperatura più bassa nel sudario, come l'olio di silicone a -80 gradi centigradi.
In conclusione, questo protocollo descrive come far crescere pellicole a cristallo singolo di Mg3N2 e n3N2 mediante epitassisia a fascio molecolare assistito da plasma e fornisce suggerimenti su come il processo di crescita può essere modificato per migliorare ulteriormente la pellicola qualità. Questi materiali non mostravano la fotoluminescenza a temperatura ambiente o a bassa temperatura. È necessario ridurre ulteriormente la densità dei difetti nelle pellicole. Le leghe Mg3N2- n3N2 possono anche essere coltivate mediante epitaxy del fascio molecolare assistito da plasma.
Subscription Required. Please recommend JoVE to your librarian.
Disclosures
Gli autori non hanno nulla da rivelare.
Acknowledgments
Questo lavoro è stato sostenuto dal Natural Sciences and Engineering Research Council del Canada.
Materials
| Name | Company | Catalog Number | Comments |
| (100) MgO | University Wafer | 214018 | one side epi-polished |
| Acetone | Fisher Chemical | 170239 | 99.8% |
| Argon laser | Lexel Laser | 00-137-124 | 488 nm visible wavelength, 350 mW output power |
| Chopper | Stanford Research system | SR540 | Max. Frequency: 3.7 kHz |
| Lock-in amplifier | Stanford Research system | 37909 | DSP SR810, Max. Frequency: 100 kHz |
| Magnesium | UMC | MG6P5 | 99.9999% |
| MBE system | VG Semicon | V80H0016-2 SHT 1 | V80H-10 |
| Methanol | Alfa Aesar | L30U027 | Semi-grade 99.9% |
| Nitrogen | Praxair | 402219501 | 99.998% |
| Oxygen | Linde Gas | 200-14-00067 | > 99.9999% |
| Plasma source | SVT Associates | SVTA-RF-4.5PBN | PBN, 0.11" Aperture, Specify Length: 12" – 20" |
| Si photodiode | Newport | 2718 | 818-UV Enhanced, 200 - 1100 nm |
| Zinc | Alfa Aesar | 7440-66-6 | 99.9999% |
References
- Suda, T., Kakishita, K. Band-gap energy and electron effective mass of polycrystalline Zn3N2. Journal of Applied Physics. 99 (7), 076101.1-076101.3 (2006).
- Hu, J., Bando, Y., Zhan, J., Zhi, C., Golberg, D. Carbon nanotubes as nanoreactors for fabrication of single-crystalline Mg3N2 nanowires. Nano Letters. 6 (6), 1136-1140 (2006).
- Fang, C. M., Groot, R. A., Bruls, R. J., Hintzen, H. T., With, G. Ab initio band structure calculations of Mg3N2 and MgSiN2. Journal of Physics: Condensed Matter. 11 (25), 4833-4842 (1999).
- Yoo, S. H., Walsh, A., Scanlonc, D. O., Soon, A. Electronic structure and band alignment of zinc nitride, Zn3N2. RSC Advances. 4 (7), 3306-3311 (2014).
- Partin, D. E., Williams, D. J., O'Keeffe, M. The crystal structures of Mg3N2 and Zn3N2. Journal of Solid-State Chemistry. 132 (1), 56-59 (1997).
- Ullah, M., Murtaza, G., Ramay, S. M., Mahmood, A. Structural, electronic, optical and thermoelectric properties of Mg3X2 (X = N, P, As, Sb, Bi) compounds. Materials Research Bulletin. 91, 22-30 (2017).
- Li, C. T. Electrocatalytic zinc composites as the efficient counter electrodes of dye-sensitized solar cells: study on the electrochemical performance and density functional theory Calculations. ACS Applied Materials & Interfaces. 7 (51), 28254-28263 (2015).
- Sinha, S., Choudhury, D., Rajaraman, G., Sarkar, S. Atomic layer deposition of Zn3N2 thin films: growth mechanism and application in thin film transistor. RSC Advances. 5 (29), 22712-22717 (2015).
- Bhattacharyya, S. R., Ayouchi, R., Pinnisch, M., Schwarz, R. Transfer characteristic of zinc nitride based thin film transistors. Physica Status Solidi C. 9 (3-4), 469-472 (2012).
- Wu, P., Tiedje, T. Molecular beam epitaxy growth and optical properties of Mg3N2 films. Applied Physics Letters. 113 (8), 082101.1-082101.4 (2018).
- Wu, P., et al. Molecular beam epitaxy growth and optical properties of single crystal Zn3N2 films. Semiconductor Science and Technology. 31 (10), 10LT01.1-10LT01.4 (2016).
- Jiang, N., Georgiev, D. G., Jayatissa, A. H. The effects of the pressure and the oxygen content of the sputtering gas on the structure and the properties of zinc oxy-nitride thin films deposited by reactive sputtering of zinc. Semiconductor Science and Technology. 28 (2), 025009 (2013).
- Nakano, Y., Morikawa, T., Ohwaki, T., Taga, Y. Electrical characterization of p-type N-doped ZnO films prepared by thermal oxidation of sputtered Zn3N2 films. Applied Physics Letters. 88 (17), 172103.1-172103.3 (2006).
- Cao, X., Yamaguchi, Y., Ninomiya, Y., Yamada, N. Comparative study of electron transport mechanisms in epitaxial and polycrystalline zinc nitride films. Journal of Applied Physics. 119 (2), 025104.1-025104.10 (2016).
- Jia, J., Kamijo, H., Nakamura, S., Shigesato, Y. How the sputtering process influence structural, optical, and electrical properties of Zn3N2 films. MRS Communications. 8 (2), 314-321 (2018).
- Trapalis, A., Hefferman, J., Farrer, I., Sherman, J., Kean, A. Structural, electrical and optical characterization of as-grown and oxidized zinc nitride films. Journal of Applied Physics. 120 (20), 205102.1-205102.9 (2016).
- Núñez, C. G., et al. On the zinc nitride properties and the unintentional incorporation of oxygen. Thin Solid Films. 520 (6), 1924-1929 (2012).
- Oshima, T., Fujita, S. (111)-oriented Zn3N2 growth on a-plane sapphire substrates by molecular beam epitaxy. Japanese Journal of Applied Physics. 45 (111), 8653-8655 (2006).
- Heavens, O. S. Optical properties of thin solid films. , Butterworth, London. 46-48 (1955).
- Heyns, A. H., Prinsloo, L. C., Range, K. J., Stassen, M. The vibrational spectra and decomposition of α-calcium nitride (α-Ca3N2) and magnesium nitride (Mg3N2). Journal of Solid-State Chemistry. 137, 33-41 (1998).
- Lewis, R. B., Bahrami-Yekta, V., Patel, M. J., Tiedje, T., Masnadi-Shirazi, M. Closed-cycle cooling of cryopanels in molecular beam epitaxy. Journal of Vacuum Science Technology B. 32 (2), 02C102.1-02C102.7 (2014).



 ①
① (1 - a)
(1 - a) (1 - b)
(1 - b) (1 - c)
(1 - c) (1 - d)
(1 - d)