Summary
Este artigo descreve o crescimento de películas de epitaxial do magnésio3n2 e do Zn3n2 em carcaças de MgO pelo Epitaxy molecular plasma-ajudado do feixe com gás de n2 como a fonte do nitrogênio e a monitoração ótica do crescimento.
Abstract
Este artigo descreve um procedimento para crescer películas do magnésio3n2 e do Zn3n2 pelo Epitaxy molecular plasma-ajudado do feixe (MBE). Os filmes são cultivados em 100 substratos MgO orientados com gás N2 como fonte de nitrogênio. O método para a preparação dos substratos e o processo de crescimento do MBE são descritos. A orientação e a ordem cristalina do substrato e da superfície do filme são monitoradas pela reflexão sobre a difração de elétrons de alta energia (RHEED) antes e durante o crescimento. A reflectividade especular da superfície da amostra é medida durante o crescimento com um laser de ar-Ion com um comprimento de onda de 488 nm. Ajustando a dependência do tempo da reflectividade a um modelo matemático, o índice refração, o coeficiente ótico da extinção, e a taxa de crescimento da película são determinados. Os fluxos metálicos são medidos de forma independente em função das temperaturas das células de efusão utilizando um monitor de cristal de quartzo. As taxas de crescimento típicas são 0, 28 nm/s em temperaturas de crescimento de 150 ° c e 330 ° c para mg3n2 e Zn3n2 filmes, respectivamente.
Introduction
Os materiais do II3-v2 são uma classe dos semicondutores que receberam relativamente pouca atenção da Comunidade da pesquisa do SEMICONDUTOR comparada aos semicondutores III-v e II-vi1. Os nitretos de MG e Zn, mg3n2 e Zn3n2, são atrativos para aplicações de consumo, pois são compostos por elementos abundantes e não tóxicos, tornando-os baratos e fáceis de reciclar ao contrário da maioria dos III-V e II-vi semicondutores compostos. Eles exibem uma estrutura de cristal anti-bixbyite semelhante à estrutura CaF2 , com um dos FCC interpenetrantes F-sublattices sendo meio ocupado2,3,4,5. São ambos os materiais diretos6da abertura da faixa, fazendo os apropriados para aplicações óticas7,8,9. A lacuna de banda de mg3n2 está no espectro visível (2,5 EV)10, e a lacuna de banda de Zn3N2 está no infravermelho próximo (1,25 EV)11. Para explorar as propriedades físicas destes materiais e seu potencial para aplicações eletrônicas e óticas do dispositivo, é crítico para obter a alta qualidade, únicas películas de cristal. A maioria dos trabalhos sobre estes materiais até à data foi realizada em pós ou filmes policristalinos feitos por sputtering reativa12,13,14,15,16, a 17.
O Epitaxy do feixe molecular (MBE) é um método bem desenvolvido e versátil para crescer películas compostas do semicondutor do único-cristal18 que tem o potencial render materiais da alta qualidade usando um ambiente limpo e umas fontes elementares da elevado-pureza. Entretanto, a ação rápida do obturador de MBE permite mudanças a uma película na escala da camada atômica e permite o controle preciso da espessura. Este trabalho relata o crescimento de mg3n2 e Zn3n2 filmes epitaxiais em substratos MgO por MBE assistida por plasma, utilizando Zn de alta pureza e mg como fontes de vapor e gás N2 como fonte de nitrogênio.
Subscription Required. Please recommend JoVE to your librarian.
Protocol
1. preparação do substrato MgO
Nota: um lado comercial EPI-polido (100) orientada único cristal MgO quadrado substratos (1 cm x 1 cm) foram empregadas para o X3N2 (x = Zn e mg) de crescimento da película fina.
- Recozimento de alta temperatura
- Coloc o MgO em um portador limpo da amostra da bolacha da safira com o lado lustrado que enfrenta para cima em uma fornalha e um recoze para 9 h em 1.000 ° c. Aumente a temperatura para 1000 ° c durante um período de 10 min.
Nota: o recozimento de alta temperatura remove o carbono da superfície e reconstrói a estrutura de cristal de superfície dos únicos substratos de cristal de MgO. - Fixe os substratos MgO à temperatura ambiente (RT).
- Coloc o MgO em um portador limpo da amostra da bolacha da safira com o lado lustrado que enfrenta para cima em uma fornalha e um recoze para 9 h em 1.000 ° c. Aumente a temperatura para 1000 ° c durante um período de 10 min.
- Limpeza do substrato
- Colete os substratos recozidos de MgO e enxague em água deionizada em uma taça de vidro de borosilicato limpo.
- Ferva os substratos MgO em 100 mL de acetona em uma taça de vidro de borosilicato de 250 mL por 30 min para remover a contaminação de carbono inorgânico do manuseio.
Nota: cubra o copo e não deixe que a acetona seque. - Drenar a acetona e enxaguar os substratos MgO em 50 mL de metanol.
- Seque os substratos com gás nitrogênio e, em seguida, armazene os substratos secos e limpos na bandeja de chips limpa.
2. operação de VG V80 MBE
- Abra a água de resfriamento para a câmara de preparação, cryoshroud na câmara de crescimento (ver Figura 1), células de derrame, e sensor de microequilíbrio de cristal de quartzo.
- Gire sobre o laser do ar-íon com um comprimento de onda de 488 nanômetro. A luz laser é trazida para a câmara MBE com uma fibra óptica do laser, que está localizado em outra sala.
- Gire sobre o injetor da difração de elétron da reflexão de alta energia (RHEED), gerador do plasma da radiofrequência (RF) de 13,56 megahertz, e sistema do microbalança do cristal de quartzo (QCM).
3. carga do substrato
- Fechamento rápido da entrada
- Monte um substrato MgO limpo no suporte da amostra de molibdênio (Figura 2a) usando clipes de mola de tungstênio.
- Desligue a bomba Turbo na trava de entrada rápida (FEL) e exale a câmara FEL com nitrogênio. Abra o FEL quando a pressão da câmara atinge a pressão atmosférica.
- Retire a gaveta do suporte do amostrador para fora do FEL e carregue o suporte da amostra com o substrato na gaveta.
- Volte a colocar a gaveta no FEL e volte a ligar a bomba Turbo.
- Aguarde a pressão no FEL para cair para 10-6 Torr.
- Aumente a temperatura do fechamento de entrada rápido a 100 ° c durante um período de 5 minutos e Degas os substratos com os suportes por 30 min no fechamento de entrada rápido.
- Certifique-se de que a pressão na trava de entrada rápida está abaixode 10-7 Torr antes de abrir a válvula de vácuo para a câmara de preparação. Transfira o suporte usando o mecanismo de transferência da vara da oscilação para a câmara de preparação, em seguida, aumente a estação de desgaseificação para 400 ° c e deixe-o a Degas por 5 h.
- Transfira o suporte desgaseificado pelo mecanismo de transferência do trole ao manipulador da amostra na câmara do crescimento. Aumente a temperatura da carcaça até 750 ° c durante um período de 30 minutos e permita que a amostra outgas no manipulador por outros 30 minutos. Certifique-se que a água refrigerando está ligada no cryoshroud para evitar o superaquecimento do cryoshroud.
- Solte a temperatura do substrato para 150 ° c para Zn3n2 crescimento de filme e 330 ° c para mg3n2 filme crescimento usando o termopar no manipulador de amostra para medir a temperatura da amostra.
- RHEED in situ
- Ajuste a tensão no injetor do elétron a 15 quilovolts e a corrente do filamento a 1,5 a uma vez que a pressão da câmara do crescimento está abaixo de 1 x 10-7 Torr.
- Gire o suporte do substrato até 1) a pistola de elétrons é alinhada ao longo de um eixo cristalográfico princípio do substrato e 2) um único padrão de difração de elétrons de cristal claro é visível.
- Tire uma foto do padrão RHEED e salve a imagem.
- Feche o obturador na célula de derrame e pare o fluxo de nitrogênio. Meça o teste padrão de RHEED para a película depositada quando a pressão da câmara está abaixode 10-7 Torr.
4. medições de fluxo de metal
- Use células de derrame tipo padrão do grupo III ou células de derrame de baixa temperatura para mg e Zn.
- Carregar os cadinhos com 15 g e 25 g de alta pureza mg e Zn tiro, respectivamente.
- Quando a câmara de crescimento atingiu um vácuo de 10-8 Torr ou melhor, e antes de carregar o suporte do substrato, outgas as células de derrame de origem Zn ou Mg até 250 ° c a uma taxa de rampa de ~ 20 ° c/min e permitir que ele outgas para 1 h com as persianas fechadas.
- Depois que o substrato foi carregado no manipulador da amostra, aqueça as células de derrame de Zn e/ou mg a 350 ° c ou 390 ° c respectivamente, a uma taxa de rampa de ~ 10 ° c/min, e aguarde 10 minutos para que elas se estabilizem com as persianas fechadas.
- Use o monitor de cristal de quartzo retrátil para medir o fluxo de metal. Posicione o sensor de cristal de quartzo na frente do substrato dentro da câmara. Certifique-se de que o substrato está totalmente coberto pelo detector para que nenhum metal seja depositado no substrato.
- Insira a densidade do metal de interesse (ρZn = 7,14 g/cm3, ρmg = 1,74 g/cm3) no controlador de cristal de quartzo (QCM) Controller.
- Para calibrar o fluxo, abra o obturador para uma das fontes metálicas e permita que a célula de derrame deposite no sensor. O sistema de QCM converte sua medida interna da massa à espessura.
- Calcule o fluxo elementar da inclinação da espessura crescente em função do tempo mostrado no QCM. A taxa de aumento da espessura ao longo de alguns minutos é proporcional ao fluxo elementar. Em dois casos de exemplo, um fluxo de Zn de 0,45 nm/s e um fluxo de mg de 1,0 nm/s são obtidos.
- Mude a temperatura das células de derrame e repita o passo 4,8 se a dependência de temperatura do fluxo é necessária. A dependência de temperatura medida do fluxo de MG e Zn é mostrada na Figura 3 para este sistema de crescimento específico.
- Quando as medições de fluxo estão completas, feche as persianas nas células de derrame e retrair o sensor de cristal de quartzo.
5. plasma do nitrogênio
- Desligue a corrente de filamento e a alta tensão na pistola RHEED para evitar danos na presença de uma pressão de gás N2 elevada na câmara de crescimento.
- Abra a válvula de gás no cilindro de alta pressão N2 .
- Lentamente, abra a válvula de vazamento lentamente até que a pressão de nitrogênio na câmara de crescimento atinja 3 x 10-5-4 x 10-5 Torr.
- Defina a potência do gerador de plasma para 300 W.
- Inflamar o plasma com o ignitor na fonte de plasma. Um brilho roxo brilhante será visível a partir da viewport quando o plasma inflama, como mostrado na Figura 2b.
- Ajuste o controle na caixa de harmonização do RF para minimizar tanto quanto possível a potência refletida. Um poder refletido de menos de 15 W é bom; Neste caso, a potência refletida é reduzida para 12 W.
6. espalhamento de luz laser in situ
- Concentre a luz de laser picada 488 nm Argon refletida do substrato na câmara de crescimento para o fotodiodo si para que um sinal elétrico pode ser detectado pelo bloqueio no amplificador. Isto é conseguido ajustando o ângulo do substrato girando o suporte do substrato em torno de dois eixos e ajustando a posição do detector si, em seguida, focando a lente que recolhe a luz refletida, como mostrado na Figura 4.
- Abra o obturador de uma das fontes de metal.
- Registre a refletividade dependente do tempo com um registrador de dados controlado por computador. O crescimento de uma película epitaxial produzirá um sinal refletido oscilatório com o tempo associado com a interferência ótica da película fina entre as superfícies dianteiras e traseiras da película.
- Para proteger a película da oxidação no ar, deposite uma camada de encapsulamento para proteger a película da oxidação no ar. Isto é especialmente importante para mg3N2 que oxida rapidamente no ar.
- A fim de depositar uma camada de encapsulamento MgO, fechar o gás nitrogênio, mudar para o gás de oxigênio, repita o passo 5,3, e aumentar a pressão de oxigênio para 1 x 10-5 Torr.
- Defina a potência do gerador de plasma para 250 W e repita o passo 5,5. O plasma começa com menor potência de RF com gás de oxigênio do que com gás nitrogênio.
- Abra o obturador na fonte de mg, e repita o passo 6,4 para 5-10 min.
Nota: isto irá produzir um filme MgO que é de cerca de 10 nm de espessura. As películas não tampadas do magnésio3N2 são amarelas mas desvanecem-se rapidamente a uma cor esbranquiçada dentro de 20 s em cima da exposição ao ar. Consequentemente, uma camada de encapsulamento é necessária para permitir o tempo para medições nos filmes antes de oxidar após a remoção da câmara de vácuo. - Feche as válvulas de gás, desligue o laser, e rampa para baixo o substrato e as temperaturas das células para ~ 25 ° c em 30 min. Desligue a água de arrefecimento e a potência de RF para a fonte de plasma.
- Depois de várias corridas de crescimento, as janelas ópticas ficam cobertas com metal. Retire o metal, envolvendo a janela em folha de alumínio e aquecendo-o com fita de aquecimento para 400 ° c e uma taxa de rampa de temperatura de ~ 15 ° c/min ou mais lento ao longo de um fim de semana.
7. determinação da taxa de crescimento
- Use a equação 1 abaixo para descrever a refletividade óptica da amostra11,12.
 1
1
Onde: (1-a)
(1-a) (1-b)
(1-b) (1-c)
(1-c) (1-d)
(1-d) - E onde: n2 = 1,747 é o índice de refração do substrato MgO em um comprimento de onda de 488 nm; θ0 é o ângulo do feixe incidente medido em relação à superfície do substrato normal; e t é o tempo. As constantes ópticas da película (n1 e k1) e a taxa de crescimento são obtidas ajustando a reflectividade em função do tempo na equação 1.
Subscription Required. Please recommend JoVE to your librarian.
Representative Results
O objeto preto no embutido na Figura 5b é uma fotografia de um filme fino de 200 nm Zn3N2 . Da mesma forma, o objeto amarelo no Inset na Figura 5C é um como-crescido 220 nm mg3N2 Thin Film. O filme amarelo é transparente na medida em que é fácil de ler o texto colocado atrás do filme10.
A superfície do substrato e os filmes foram monitorados in situ pela RHEED. A Figura 5a mostra o padrão RHEED de um substrato desencapado com o incidente do feixe de elétrons ao longo da direção [110] do substrato. Padrões RHEED para os filmes depositados na Figura 5b,C mostram que os grades de cristal dos filmes finos de Zn3n2 e mg3n2 são orientados no plano da superfície do substrato, como esperado no caso de epitaxial Crescimento. A desvantagem de RHEED para a monitoração do crescimento as circunstâncias usadas aqui é que o processo do crescimento deve ser parado para permitir que a pressão deixe cair a 10-7 Torr e gire sobre a pistola do elétron.
Em contraste com o RHEED, as medidas ópticas in situ da reflectividade não são afetadas pela pressão na câmara. Para a obtenção da taxa de crescimento, a refletividade óptica in situ foi adequada em função do tempo mostrado na Figura 6 usando a equação 1. Nesta equação, o tempo de crescimento t é a variável independente, e as constantes ópticas do filme (n1, k1) e a taxa de crescimento são parâmetros apropriados. Na Figura 6, o índice de refração do substrato MgO, o ângulo de incidência e o comprimento de onda são n2 = 1,747, θ0 = 36,5 ° e λ = 488 nm, respectivamente. O índice de refração ajustado do filme é n1 = 2,65, coeficiente de extinção é k1 = 0,54, e taxa de crescimento é = 0, 31 nm/s para o Zn3n2 fina filme como mostrado na Figura 6a. Da mesma forma, o melhor índice de refração de ajuste para o filme mg3n2 é n1 = 2,4, o coeficiente de extinção é k1 = 0, 9, e a taxa de crescimento é = 0, 33 nm/s, como mostrado na Figura 6B. Acredita-se que a diminuição global da reflexão especular com o tempo na Figura 6B seja causada por um aumento na dispersão da rugosidade superficial, pois o filme fino de mg3N2 torna-se mais espesso. O efeito do espalhamento de rugosidade foi simulado multiplicando-se a refletividade calculada com um exponencial em decomposição, e-βt, onde β = 810-5 s-1 e o tempo de crescimento t é medido em segundos.
Após a exposição ao ar, o amarelo não tampado mg3N2 Films desvaneceu-se em poucos minutos para uma cor branca translúcida. Por outro lado, os filmes de mg3N2 que foram tampados com MgO foram relativamente estáveis. Para proteger mais as películas tampadas do magnésio3n2 da oxidação, os heteroestruturas de mg3n2/MgO foram revestidos com uma camada de CaF2 depositada pela evaporação do feixe de elétron. Zn não tampado3N2 é mais estável; no entanto, o inicialmente preto Zn3N2 Films também oxidado ao longo do tempo e ficou cinza dentro de alguns meses. Acredita-se que a reação de oxidação envolva a formação de hidróxido de magnésio e libere amônia de acordo com a seguinte reação química20. Uma camada de ZnO depositada usando um método similar ao MgO pode igualmente ser usada como uma camada protetora para impedir a oxidação.
Mg3N2 + 6h2O → 3mg (Oh)2 + 2NH3

Figura 1 : Vista da câmara de crescimento Epitaxy do feixe molecular do VG V80H. Este retrato mostra a câmara do crescimento de MBE com (no sentido horário) a tela de RHEED e a carcaça da câmera, analisador residual do gás do Quadrupole, ferragem ótica no porto da dispersão da luz do laser, pilha da efusão do magnésio, fonte do N-plasma, caixa de harmonização do RF, e a pilha da efusão Por favor clique aqui para ver uma versão maior desta figura.

Figura 2 : Suporte de substrato e brilho da fonte de plasma. (A) placa do suporte da amostra do molibdênio com os dois grampos do fio de tungstênio que prendem a carcaça quadrada do MgO no lugar. (B) fulgor roxo originando da janela traseira da fonte de plasma ao operar-se com gás de N2 . Por favor clique aqui para ver uma versão maior desta figura.
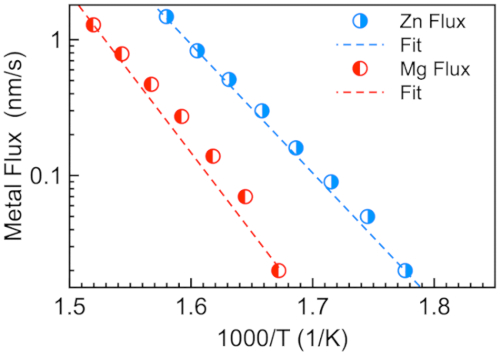
Figura 3 : Fluxo do metal em função da temperatura da pilha da efusão. As linhas são ajuste à dependência da temperatura dos fluxos do metal usando uma relação de Arrhenius como discutido no texto. Por favor clique aqui para ver uma versão maior desta figura.

Figura 4 : Esquema da instalação de espalhamento de luz laser in situ. Por favor clique aqui para ver uma versão maior desta figura.

Figura 5 : Padrões RHEED. (A) padrão de difração RHEED para substrato MgO. (B) padrão RHEED do filme as-grown do Zn3n2 com a fotografia do filme preto de Zn3n2 . (C) padrão RHEED do substrato mg3n2 com fotografia do filme amarelo mg3n2 . Por favor clique aqui para ver uma versão maior desta figura.

Figura 6 : Reflectividade especular in situ. Reflectividade especular in situ a 488 nm de (A) Zn3n2 e (B) mg3n2 filmes durante o crescimento. A reflectividade calculada (linha vermelha) é mais adequada para os dados experimentais (círculos azuis), conforme discutido no texto. Por favor clique aqui para ver uma versão maior desta figura.
Subscription Required. Please recommend JoVE to your librarian.
Discussion
Uma variedade de considerações está envolvida na escolha de substratos e estabelecendo as condições de crescimento que otimizam as propriedades estruturais e eletrônicas dos filmes. Os substratos MgO são aquecidos a alta temperatura no ar (1000 ° c) para remover a contaminação de carbono da superfície e melhorar a ordem cristalina na superfície do substrato. A limpeza ultra-sônica na acetona é um bom método alternativo para limpar os substratos do MgO.
O pico de difração de raios X (400) para o Zn3N2 Films foi encontrado para ser mais estreito quando o filme foi cultivado em substratos de MgO recozido de alta temperatura, comparado ao cultivado em substratos não recozidos. A constante de treliça de MgO (0,421 nm) é significativamente menor do que (metade da) a constante de treliça de Zn3n2 (0,976 nm) ou mg3n2 (0,995 nm) e não bem correspondida aos filmes de semicondutores. As constantes de estrutura dos substratos dos grupos IV, III-V e II-VI comercialmente disponíveis são todas maiores do que as constantes de treliça de mg3n2 e Zn3n2. Um substrato mais bem adaptado é desejável. O silício, que tem uma constante de treliça de 0,543 nm, é um pouco mais bem adaptado ao mg3N2 do que MgO e vale a pena ser explorado. Zn3N2 filmes também foram cultivados em substratos de safira de plano. A qualidade estrutural desses filmes não foi tão boa quanto a observada nos substratos do MgO, como indicado pelos pontos RHEED e largura do pico de difração de raios X (400) Zn3N2 . No caso dos substratos de safira, a parte traseira foi revestida com CR (50 nm) e mo (200 nm) para melhorar o acoplamento térmico entre o suporte do substrato e o substrato.
A temperatura do substrato é medida durante o crescimento com um termopar localizado no espaço de vácuo fechado entre o suporte do substrato e aquecedor, e não está em contato físico com o suporte do substrato ou o substrato. Como resultado, esperava-se que a temperatura real do substrato seria menor do que a temperatura do sensor. Os crescimentos bem sucedidos do magnésio3n2 e do Zn3n2 foram obtidos com temperaturas do par termoeléctrico nas escalas 300-350 ° c e 140-180 ° c, respectivamente.
A temperatura elevada do crescimento aumenta a mobilidade dos AD-átomos na superfície crescente e pode ser esperada produzir o material com menos defeitos estruturais. No entanto, em altas temperaturas de substrato, a taxa de crescimento é menor, o que é interpretado como sendo devido à re-evaporação de átomos de metal da superfície. No fluxo elevado do metal, a taxa de crescimento da película é limitada pela fonte de nitrogênio ativo. O nitrogênio ativo é maximizado em alta potência de RF aplicada à fonte de plasma (300 W máx) e a uma alta taxa de fluxo de nitrogênio. A taxa de fluxo de N2 é limitada pela pressão máxima na câmara do crescimento, que neste caso estava na escala média de 10-5 Torr. A amônia é uma fonte alternativa possível do nitrogênio. Mg e Zn reagirão com NH3 em alta temperatura sem ativação plasmática; no entanto, não está claro se o tempo de permanência dos átomos de MG e Zn na superfície será suficientemente longo para suportar o crescimento do filme em temperaturas para as quais o NH3 reagirá com os metais.
Nessas experiências, as células de derrame foram utilizadas com cadinhos pirolíticos de nitreto de boro (PBN) com capacidades de 40 CC para mg e 25 CC para Zn. a Figura 3 mostra a dependência de temperatura dos fluxos de MG e Zn das células de derrame. As linhas retas na Figura 3 são encaixadas na dependência de temperatura medida dos fluxos. Os ajustes têm a forma Flux = a exp (-b/KT), e os parâmetros de encaixe (a, b) são (8,5 x 1017 nm/s, 2,3 ev) e (1,3 x 1015 nm/s, 1,9 EV) para as fontes de MG e Zn, respectivamente. O fluxo aproximadamente dobra-se com cada 10 ° c e 12 ° c aumentam na temperatura da pilha da efusão para mg e Zn, respectivamente. Para o crescimento ilustrado na Figura 6, os fluxos metálicos estavam próximos ao Maxima na Figura 3 (~ 1 nm/s com fluxo de mg maior que o fluxo de Zn), mas as taxas de crescimento do filme foram de apenas 0, 3 Nm/s. Isto mostra que a eficiência da utilização do metal é baixa, com magnésio que é mais baixo do que Zn e a maioria do metal que re-evaporating.
A alta pressão de fundo N2 durante o crescimento impede a monitorização contínua do crescimento do filme com RHEED. O bombeamento diferencial do injetor de RHEED pode resolver este problema. As medições de refletividade óptica in situ servem como uma ferramenta de monitoramento complementar que não é afetada pela pressão do gás e fornece uma técnica precisa e confiável para determinar a taxa de crescimento. A reflectividade não especular ou difusa do substrato também pode ser medida in situ e fornecerá informações sobre a rugosidade superficial durante o crescimento.
A pressão de base na câmara de crescimento MBE éde 10-8 Torr com o gás N2 desligado. O cryoshroud na câmara do crescimento é refrigerado com água durante o crescimento da película. Nestas condições, pode ser esperada alguma contaminação residual de oxigénio nos filmes. A pressão residual de vapor de água na câmara de crescimento pode ser reduzida com um refrigerante de temperatura inferior na mortalha, como o óleo de silicone a-80 ° c21.
Em conclusão, este protocolo descreve como crescer películas de cristal únicas do magnésio3n2 e Zn3n2 pelo Epitaxy molecular plasma-ajudado do feixe e fornece sugestões para como o processo do crescimento pode ser mudado para melhorar mais a película Qualidade. Esses materiais não mostraram fotoluminescência em temperatura ambiente ou baixa temperatura. Há uma necessidade de reduzir ainda mais a densidade de defeitos nos filmes. As ligas do magnésio3n2-Zn3n2 podem igualmente ser crescidas pelo Epitaxy molecular plasma-ajudado do feixe.
Subscription Required. Please recommend JoVE to your librarian.
Disclosures
Os autores não têm nada a revelar.
Acknowledgments
Este trabalho foi apoiado pelo Conselho de pesquisa de ciências naturais e engenharia do Canadá.
Materials
| Name | Company | Catalog Number | Comments |
| (100) MgO | University Wafer | 214018 | one side epi-polished |
| Acetone | Fisher Chemical | 170239 | 99.8% |
| Argon laser | Lexel Laser | 00-137-124 | 488 nm visible wavelength, 350 mW output power |
| Chopper | Stanford Research system | SR540 | Max. Frequency: 3.7 kHz |
| Lock-in amplifier | Stanford Research system | 37909 | DSP SR810, Max. Frequency: 100 kHz |
| Magnesium | UMC | MG6P5 | 99.9999% |
| MBE system | VG Semicon | V80H0016-2 SHT 1 | V80H-10 |
| Methanol | Alfa Aesar | L30U027 | Semi-grade 99.9% |
| Nitrogen | Praxair | 402219501 | 99.998% |
| Oxygen | Linde Gas | 200-14-00067 | > 99.9999% |
| Plasma source | SVT Associates | SVTA-RF-4.5PBN | PBN, 0.11" Aperture, Specify Length: 12" – 20" |
| Si photodiode | Newport | 2718 | 818-UV Enhanced, 200 - 1100 nm |
| Zinc | Alfa Aesar | 7440-66-6 | 99.9999% |
References
- Suda, T., Kakishita, K. Band-gap energy and electron effective mass of polycrystalline Zn3N2. Journal of Applied Physics. 99 (7), 076101.1-076101.3 (2006).
- Hu, J., Bando, Y., Zhan, J., Zhi, C., Golberg, D. Carbon nanotubes as nanoreactors for fabrication of single-crystalline Mg3N2 nanowires. Nano Letters. 6 (6), 1136-1140 (2006).
- Fang, C. M., Groot, R. A., Bruls, R. J., Hintzen, H. T., With, G. Ab initio band structure calculations of Mg3N2 and MgSiN2. Journal of Physics: Condensed Matter. 11 (25), 4833-4842 (1999).
- Yoo, S. H., Walsh, A., Scanlonc, D. O., Soon, A. Electronic structure and band alignment of zinc nitride, Zn3N2. RSC Advances. 4 (7), 3306-3311 (2014).
- Partin, D. E., Williams, D. J., O'Keeffe, M. The crystal structures of Mg3N2 and Zn3N2. Journal of Solid-State Chemistry. 132 (1), 56-59 (1997).
- Ullah, M., Murtaza, G., Ramay, S. M., Mahmood, A. Structural, electronic, optical and thermoelectric properties of Mg3X2 (X = N, P, As, Sb, Bi) compounds. Materials Research Bulletin. 91, 22-30 (2017).
- Li, C. T. Electrocatalytic zinc composites as the efficient counter electrodes of dye-sensitized solar cells: study on the electrochemical performance and density functional theory Calculations. ACS Applied Materials & Interfaces. 7 (51), 28254-28263 (2015).
- Sinha, S., Choudhury, D., Rajaraman, G., Sarkar, S. Atomic layer deposition of Zn3N2 thin films: growth mechanism and application in thin film transistor. RSC Advances. 5 (29), 22712-22717 (2015).
- Bhattacharyya, S. R., Ayouchi, R., Pinnisch, M., Schwarz, R. Transfer characteristic of zinc nitride based thin film transistors. Physica Status Solidi C. 9 (3-4), 469-472 (2012).
- Wu, P., Tiedje, T. Molecular beam epitaxy growth and optical properties of Mg3N2 films. Applied Physics Letters. 113 (8), 082101.1-082101.4 (2018).
- Wu, P., et al. Molecular beam epitaxy growth and optical properties of single crystal Zn3N2 films. Semiconductor Science and Technology. 31 (10), 10LT01.1-10LT01.4 (2016).
- Jiang, N., Georgiev, D. G., Jayatissa, A. H. The effects of the pressure and the oxygen content of the sputtering gas on the structure and the properties of zinc oxy-nitride thin films deposited by reactive sputtering of zinc. Semiconductor Science and Technology. 28 (2), 025009 (2013).
- Nakano, Y., Morikawa, T., Ohwaki, T., Taga, Y. Electrical characterization of p-type N-doped ZnO films prepared by thermal oxidation of sputtered Zn3N2 films. Applied Physics Letters. 88 (17), 172103.1-172103.3 (2006).
- Cao, X., Yamaguchi, Y., Ninomiya, Y., Yamada, N. Comparative study of electron transport mechanisms in epitaxial and polycrystalline zinc nitride films. Journal of Applied Physics. 119 (2), 025104.1-025104.10 (2016).
- Jia, J., Kamijo, H., Nakamura, S., Shigesato, Y. How the sputtering process influence structural, optical, and electrical properties of Zn3N2 films. MRS Communications. 8 (2), 314-321 (2018).
- Trapalis, A., Hefferman, J., Farrer, I., Sherman, J., Kean, A. Structural, electrical and optical characterization of as-grown and oxidized zinc nitride films. Journal of Applied Physics. 120 (20), 205102.1-205102.9 (2016).
- Núñez, C. G., et al. On the zinc nitride properties and the unintentional incorporation of oxygen. Thin Solid Films. 520 (6), 1924-1929 (2012).
- Oshima, T., Fujita, S. (111)-oriented Zn3N2 growth on a-plane sapphire substrates by molecular beam epitaxy. Japanese Journal of Applied Physics. 45 (111), 8653-8655 (2006).
- Heavens, O. S. Optical properties of thin solid films. , Butterworth, London. 46-48 (1955).
- Heyns, A. H., Prinsloo, L. C., Range, K. J., Stassen, M. The vibrational spectra and decomposition of α-calcium nitride (α-Ca3N2) and magnesium nitride (Mg3N2). Journal of Solid-State Chemistry. 137, 33-41 (1998).
- Lewis, R. B., Bahrami-Yekta, V., Patel, M. J., Tiedje, T., Masnadi-Shirazi, M. Closed-cycle cooling of cryopanels in molecular beam epitaxy. Journal of Vacuum Science Technology B. 32 (2), 02C102.1-02C102.7 (2014).



 1
1 (1-a)
(1-a) (1-b)
(1-b) (1-c)
(1-c) (1-d)
(1-d)