Summary
La fabbricazione di elettricamente indirizzabili,-aspect-ratio elevato (> 1000:1) nanofili metallici separati da spazi vuoti delle singole nanometri utilizzando sia strati sacrificali di alluminio e argento o monostrati auto-assemblati come modelli è descritta. Queste strutture nanogap sono fabbricati senza una camera pulita o una foto-o fasci elettronici litografiche processi da una forma di spigolo litografia conosciuta come nanoskiving.
Abstract
Ci sono diversi metodi di fabbricazione nanogap con spaziature controllati, ma il controllo preciso della spaziatura sub-nanometrica tra due elettrodi-e che li generano in pratiche quantità-è ancora impegnativo. La preparazione di elettrodi nanogap utilizzando nanoskiving, che è una forma di litografia bordo, è un veloce, tecnica semplice e potente. Questo metodo è un processo interamente meccanico che non include alcuna foto-litografiche o passi a fascio elettronico e non richiede particolari attrezzature o infrastrutture come camere bianche. Nanoskiving viene utilizzato per fabbricare nanogap elettricamente indirizzabili con controllo su tre dimensioni, il lato minore di queste strutture è definita dallo spessore dello strato sacrificale (Al o Ag) o monostrati auto-assemblati. Questi cavi possono essere posizionati manualmente trasportandoli sulle gocce d'acqua e sono direttamente elettricamente indirizzabili; non sono necessarie ulteriori litografia per collegarli ad unelettrometro.
Introduction
Questo articolo descrive la realizzazione di elettricamente indirizzabili,-aspect-alto rapporto nanofili d'oro separate da spazi vuoti delle singole nanometri utilizzando sottovuoto depositato alluminio e argento come sacrificali strati spaziatori per le lacune> 5 nm e monostrati auto-assemblati (SAM) di alkanedithiols per lacune piccole come 1,7 nm. Abbiamo inventato queste nanostrutture senza una camera pulita o eventuali processi fotolitografici sezionando strutture sandwich di oro separati da un distanziatore sacrificale utilizzando un ultramicrotomo, una forma di spigolo litografia noto come nanoskiving. 1-3 Questo metodo è una combinazione della deposizione di metallo sottile film e sezionamento con un ultramicrotomo. Il passo principale in nanoskiving sta affettando sezioni sottili con un ultramicrotomo dotato di lama di diamante che è attaccato ad una barca piena di acqua per la produzione di lastre, che sono sottili come ~ 30 nm. Ultramicrotomi sono ampiamente utilizzati per la preparazione di campioni sottili per l'imaging con ottica o eleggereron microscopia e molti dei professionisti più esperienza di ultramicrotomia provengono da un background biologico o medico. Ci sono diversi metodi di nanogap fabbricare compreso giunzioni meccaniche di rottura, 4 elettroni-litografia a fascio 5, elettrochimica placcatura, 6, 7, 8 elettromigrazione fascio ionico focalizzato litografia, 9 ombra evaporazione, 10 sonda di scansione e microscopia a forza atomica, 11 sul filo litografia , governanti 12 e molecolare. 13 Tutti questi metodi hanno le proprie caratteristiche e le applicazioni, ma la produzione e affrontare nanogap sia a numeri utili e con un controllo preciso delle dimensioni del gap rimane una sfida. Inoltre questi metodi hanno costi di gestione elevati, sono limitati alla classe di materiali che possono sopravvivere i processi di incisione, e sono limitati in risoluzione. Nanoskiving consente la rapida realizzazione di nanofili elettricamente indirizzabili con Spacing di singoli nanometri sul banco. Ci interessa la prototipazione rapida di nanostrutture per l'elettronica molecolare, per il quale gli elettrodi nano-fabbricati non richiedono tecniche specializzate o in termini di tempo; 14 una volta un blocco è fatto, può produrre centinaia di migliaia di nanostrutture, (serialmente) su richiesta. Tuttavia, la tecnica non è limitato a SAM o Elettronica molecolare ed è un metodo generale per la preparazione di un divario tra due nanostrutture. In questo lavoro utilizziamo argento, alluminio, e SAM come strati sacrificali per produrre spazi vuoti di varie dimensioni tra i nanofili d'oro, ma la tecnica non è limitata a questi materiali (o di nanofili metallici). I fili sono pick-and-place e sono compatibili con l'allineamento magnetico, quindi possono essere collocati su supporti arbitrari. Altro punto di forza di 15 nanoskiving è che permette il controllo di tutte e tre le dimensioni. Le dimensioni dei campioni sono determinati dalla topografia del substrato (X), laspessore del film depositato (Y) e lo spessore della lastra prodotta dal ultramicrotomo (Z). Figura 1 riassume il procedimento usato per produrre i nanofili con la spaziatura definita. Funzionalità Gold (1-2 mm in lunghezza) sono depositati per evaporazione attraverso una maschera Teflon su un substrato di silicio. EPOFIX (Electron Microscopy Sciences) epossidica pre-polimero viene versato su tutto il wafer, che copre le caratteristiche d'oro, quando la resina epossidica è guarito, la resina epossidica è separata dal wafer (cioè tramite template stripping); le caratteristiche dell'oro rimangono rispettate la resina epossidica . Per strati sacrificali metallici, alluminio o argento viene evaporata con lo spessore desiderato attraverso la maschera Teflon con un offset di 200 - 500 micron sopra le caratteristiche oro. Per produrre sub-5 lacune nm, un SAM è formato immergendo le caratteristiche oro in una soluzione etanolica 1 mM del dithiol appropriata durante la notte. Un secondo insieme di oro (o altro metallo) viene depositato ponendo il shadowmask Teflon sulprimo strato di caratteristiche oro (rivestito in argento, alluminio o un SAM) con un offset di 200 - 500 micron rispetto alla prima evaporazione. Questo offset finirà per definire la dimensione più lunga del gap, e può essere misurata con precisione utilizzando un micro-righello prima di incorporare l'intera struttura in resina epossidica per il sezionamento. Poi l'intera struttura è incorporato in un blocco di resina epossidica che poi potrebbe essere pronto per il sezionamento con la ultramicrotomo. Il braccio campione contiene l'intero blocco preparato come la lama di diamante avanza verso di esso in passaggi controllati che definiranno lo spessore delle lastre. La sezione risultante galleggia sull'acqua in barca.
Subscription Required. Please recommend JoVE to your librarian.
Protocol
1. Preparazione di un blocco per il sezionamento
- Trattare un tecnico di livello 3 "wafer di silicio in un plasma un'aria più pulita in 30 sec e poi esporlo a (tridecafluoro-1, 1,2,2,-tetrahydrooctyl) vapore trichlorosilane per un'ora. Nota: Questo passaggio è necessario prima passo 1.4 per impedire la resina epossidica aderisca al wafer di silicio.
- Depositare uno strato di oro (generalmente 100 nm di spessore, che definisce la larghezza dei fili) attraverso una matrice di Teflon (che definisce la lunghezza dei fili risultanti, 0,5 mm, 1 mm o 1,5 mm) sul silicio pre-trattato wafer.
- Coprire l'intero wafer con ~ 8,5 ml di EPOFIX epossidica pre-polimero e la cura per tre ore a 60 ° C.
- Template-spogliare lo strato di oro dal peeling con cura la resina epossidica dal wafer in modo che l'oro rimane attaccato alla resina catalizzata. Inserire il bordo di una lama di rasoio all'interfaccia tra il wafer di silicio e resina epossidica e poi delicatamente sbucciare lo strato di resina dallail wafer di silicio. A causa della scarsa adesione di oro al wafer di silicio fluorurato (passo 1.1) le caratteristiche dell'oro rimangono rispettate la resina epossidica. NOTA: Fare attenzione a non rompere il wafer di silicio, altrimenti le particelle di silicio danneggerà il coltello di diamante nella fase di sezionamento.
- La stessa maschera teflon viene reinserito sulle caratteristiche oro, ma sfalsato lateralmente di ~ 80% della dimensione più corta delle caratteristiche oro e depositare uno strato di alluminio o argento attraverso il master Teflon. Lo spessore di questo strato definirà la spaziatura del nano-gap tra i fili d'oro. Il limite inferiore dipende dal metallo, ma è ~ 5 nm per alluminio e argento, sotto il quale gli strati diventano discontinui Nota:. Questa correzione utensile fine di definire la lunghezza della sovrapposizione tra due elettrodi d'oro e lo si può misurare con micro-righello .
- Per le lacune sotto i 5 nm: Immergere l'oro modello-stripped su resina epossidica in una soluzione 1 mM di un alkanedithiolin etanolo (o qualsiasi solvente che non gonfia la epossidica) durante la notte in una camera chiusa che viene spurgata con azoto (per mitigare la formazione spontanea di disolfuri). (In questo lavoro utilizziamo 1,12-dodecanedithiol, 1,14-tetradecanedithiol o 1,16-hexadecanedithiol per produrre spazi vuoti di varie larghezze inferiori 3 nm.) Togliere il substrato di oro su base epossidica template-stripping dalla SAM-forming soluzione. Risciacquare con etanolo e asciugare con azoto prima di essiccazione a 60 per 2 min.
- Se si utilizza un SAM, riposizionare la maschera Teflon sul substrato epossidico ma sfalsato lateralmente di ~ 80% della dimensione più corta delle caratteristiche oro. Se si utilizza un metallo, la maschera è già in posizione dopo passo 1.5, per non cambiare la posizione della maschera dopo la deposizione del alluminio o argento.
- Depositare un secondo strato di oro o qualsiasi altro metallo attraverso la maschera. Questo strato sarà generalmente composto dallo stesso metallo allo spessore del primo (100 nm di spessore in questo caso).
- Rimuoverela maschera di Teflon, facendo attenzione a non graffiare le caratteristiche, che si tradurrà in nanofili rotti.
- Re-incorporare l'intero substrato in EPOFIX pre-polimero (~ 8,5 ml) e curarla per almeno tre ore a 60.
- Tagliare le caratteristiche utilizzando sega di un gioielliere (in ~ 4 x 10 pezzi mm) e collocare ciascuno in una ben distinta in polietilene'' bara'' stampo microtomo.
- Riempire lo stampo con EPOFIX pre-polimero, e curarlo durante la notte a 60 ° C.
2. Sezionamento
- Rimuovere un blocco dallo stampo polietilene e montarlo nel supporto del campione.
- Fissare il supporto del campione per l'attaccamento rifilatura e montarlo nel ultramicrotomo.
- Pulire una lama di rasoio con etanolo per rimuovere il lubrificante e frammenti di metallo e ispezionare il bordo della lama di rasoio sotto l'stereoscopio del ultramicrotomo. Eventuali frammenti residui potrebbero danneggiare il coltello di diamante durante il sezionamento. Tagliare il blocco alla larghezza del coltello di diamante (we utilizzare 2 o 4 mm DIATOME Ultra 35 °) in una forma trapezoidale (perché è la forma più stabile per il sezionamento). Nota: alcuni ultramicrotomi usano rifilatura allegati che montano al braccio di taglio, ma ottenere risultati migliori con lame di rasoio .
- Allineare il bordo di un coltello vetro parallelo al bordo inferiore della faccia del blocco.
- Avviare pre-taglio con la ultramicrotomo (abbiamo usato una Leica EMUC-6) dotato di una lama di vetro per definire una superficie liscia sulla faccia del blocco.
- Per fabbricare una struttura metallica, sostituire il coltello di vetro con un coltello di diamante, ri-allinearlo, e la sezione per il blocco o 100 nm a 1 mm / sec o 50 nm a 0.6 mm / sec. Sezioni EPOFIX sono stabili fino a circa 30 nm Nota: una verifica facile degli spessori delle sezioni è il loro colore, che varia prevedibile in funzione di spessore e non dipende la resina che è stata usata; schede di riferimento sono disponibili.. 16 Raccogliere sezioni epossidici contenenti le strutture dalla superficie dell'acqua nel serbatoio del coltello sia singolarmente utilizzando un loop perfetto (Sciences Electron Microscopy) o come nastri di vari punti ad un Si/SiO2 (per SEM) o SiO2 (per elettrico misurazioni) substrato ponendo substrato sotto la superficie dell'acqua e alzando lentamente.
- Essiccare le sezioni a 60 ° C per 3 ore per migliorare la loro adesione al substrato.
- Per cenere la resina epossidica, esporre i campioni ad un plasma di ossigeno (15 min a 1 mbar è sufficiente a rimuovere tutte le tracce di resina epossidica da 100 o 50 sezioni nm di spessore). Nota: Se fabbricare nanostrutture per misure elettriche, questo passaggio deve essere eseguita dopo Passo 4.
3. Acquaforte la strato sacrificale
- Per alluminio: Posto sezioni contenenti alluminio in una soluzione acquosa 2 M di HCl per 2 h. Per l'argento: esporre le sezioni di plasma di ossigeno per 10. min Nota: la selezione dei materiali permette sia wet-etching (usando HCl) o l'attacco a secco (usando plasma di ossigeno), tuttavia argento possono essere rimosse mediante attacco umido pure.
- Per SAM: trattamento al plasma incide parzialmente i SAM, ma noi abbiamo avuto successo nei nostri sforzi per caratterizzare in che misura.
4. Misure Elettriche
- Sezioni epossidiche posto su un substrato di SiO2 che è stata accuratamente pulita (ad esempio utilizzando soluzione Piraña) e asciugarli (punti 2.7 e 2.8).
- Montare il substrato sotto un microscopio ottico o lo stereoscopio collegato al ultramicrotomo.
- Applicare gocce di pasta d'argento (o inchiostro carbonio) su due estremità di fili in ogni sezione. Queste strutture metalliche incorporate saranno visibili sia come una linea nera (dall'interfaccia oro / epossidica) o, nel caso di strutture oro spessi (dalle fasi di deposizione), direttamente visibili. In entrambi i casi, le gocce dovrebbero essere applicatisufficientemente lontano dal centro a breve le nano-gap.
Subscription Required. Please recommend JoVE to your librarian.
Representative Results
Abbiamo preparato strutture nanogap incorporando due strati sacrificali metallici come il distanziatore: alluminio e argento. Noi acidato questi strati per ottenere lacune del desiderato spessori. Come descritto nella sezione Protocollo, dopo il sezionamento abbiamo esposto le strutture contenenti argento al plasma di ossigeno, e quelli contenenti alluminio per acquoso HCl. Figura 2 mostra la scansione al microscopio elettronico (SEM) dei nanofili risultanti con separazione su scala nanometrica. In entrambi i casi le lacune sono chiaramente visibili e direttamente misurabili. Per ottenere le lacune sotto 3 nm, abbiamo usato SAM di 1,12 - dodecanedithiol (SC12S), 1,14-tetradecanedithiol (SC14S) e 1,16-hexadecanedithiol (SC16S). Le corrispondenti SEMs sono mostrati in Figura 3. Le lacune formate da queste molecole sono chiaramente visibili, ed è evidente che la dimensione del gap aumenta come lunghezza dell'aumento molecole. Le lunghezze di tali molecole nella loro conformazione estesa (AM1 minimizzata) è unas seguire: 2.17 (SC16S), 1.97 (SC14S) e 1.70 nm (SC12S). Se queste molecole servono come il modello ci aspettiamo che i gap-larghezze di essere l'ipotenusa del triangolo formato dalla superficie di oro e dorsali delle molecole, che sono inclinato a 30 ° rispetto alla normale su oro. Tuttavia, a causa del limite di risoluzione del SEM, misurazioni dirette delle gap-larghezze non è possibile, quindi ci etichettiamo queste lacune come'' <4 nm.'' Abbiamo ripreso le lacune da STM, AFM e CP-AFM, ma in tutti i casi non siamo stati in grado di risolvere la larghezza del gap. Abbiamo quindi indirettamente misurato la dimensione del gap facendo misure elettriche. Per realizzare queste misure abbiamo preparato sezioni e applicato la pasta d'argento, come descritto nella sezione Protocollo. Abbiamo collegato un pad per una siringa con una punta acuminata di eutettico Ga-In (eGain) e l'altro pad per una sonda di tungsteno con una piccola goccia di eGain (messa a terra e la sonda). I dati per lacune SAM-templato sono tracciati nella Figura 4. Come la lunghezza of le molecole aumenta la corrente diminuisce in modo esponenziale, come previsto. Questa diminuzione esponenziale implica che le molecole sono intatte nella giunzione. Per dimostrare questa supposizione abbiamo utilizzato una forma di approssimazione Simmons ', J - J 0 e-dβ dove d è lo spessore della barriera di tunneling, J 0 è il valore teorico di J a d = 0 e β è la caratteristica decadimento tunneling, che può essere estratta da un adattamento lineare di ln J in funzione della larghezza di una giunzione (o il numero di atomi di carbonio, n c). Valori tipici di β per dorsali alcano sono nella gamma di Å-1 (0.71 -1.10 c n -1) ai 200-500 mV e dipende poco tensione. 17-20 L'inserto in Figura 4 è fit lineare di ln J a 500 mV (a partire dai dati in figura 4) rispetto alla lunghezza (A) per SC16S, SC14S e SC12S basati su modellinanogap strutture. Dalla pendenza di questa trama, β = 0.75 Å-1 (c 0.94n -1) che è nella gamma dei valori riportati in letteratura, concludiamo che la dimensione gap è definito da queste molecole con risoluzione di 2,5 Å e la corrente passa attraverso la spina dorsale delle molecole intatte.

Figura 1. Uno schema della procedura utilizzata per fabbricare strutture nanogap. A) Primo strato (100 nm di spessore) di oro viene depositato attraverso una maschera forata Teflon su un wafer di silicio fluorurato tramite evaporazione termica. B) Dopo la rimozione della maschera tutta la superficie della silicio è coperto in resina epossidica. C) Dopo le cure epossidiche, viene separato dal wafer tale che le caratteristiche di oro rimangonoaderito alla resina epossidica (Template strippaggio). Un SAM viene poi formata su queste caratteristiche oro D) La maschera Teflon è posta sopra le caratteristiche oro SAM-coperto con un offset di 250 -. 500 micron e altri 100 nm di spessore strato di oro (o di qualsiasi altro metallo) viene depositato. Nota:. nel caso di utilizzo di strati sacrificali di metalli (alluminio e argento), questi metalli sono depositati prima alla seconda deposizione con lo spessore che si desidera produrre larghezza finale gap E) La maschera viene rimosso e le caratteristiche risultanti sono ruvide- tagliare con la sega di un gioielliere e vengono poi incorporati in resina epossidica in stampo microtomo per produrre i blocchi per essere sezionato con un ultramicrotomo.
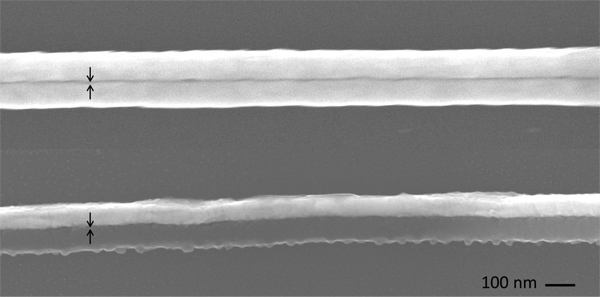
Figura 2. Scansione al microscopio elettronico delle nanogap prodotto con alluminio (in alto) e argento (in basso) come the distanziale. Inizio immagine mostra due strati di oro con il divario tra prodotto da incisione su strato di alluminio con HCl acquoso. Immagine inferiore mostra due strati di oro e alluminio con la discontinuità prodotta da incisione su strato d'argento con plasma di ossigeno. Il divario è chiaramente visibile in entrambi i casi.
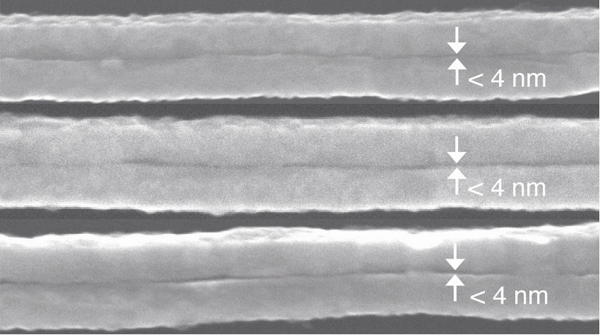
Figura 3. Scansione al microscopio elettronico delle lacune di tre diverse strutture nanogap preparati con diversi ditioli come modelli dopo l'incenerimento delle sostanze organiche con plasma di ossigeno Dall'alto in basso:. Nanogap prodotte utilizzando SC12S, SC14S e SC16S che mostrano un gap visibile tra gli strati d'oro. Le nanogap sono qualitativamente più grande come la lunghezza delle molecole aumenta. Tutte le gap-larghezze sono al di sotto del limite di risoluzione dello strumento (~ 4 nm), così essi sono etichettati come'' <4 nm ".
Figura 4. Entra trame attuale densità rispetto a potenziale di strutture nanogap fabbricate da tre diversi; ditioli. SC12S (quadrati neri), SC14S (triangoli rossi), e SC16S (cerchi blu) L'inserto è un grafico di ln (J) rispetto alla lunghezza (A) a 500 mV mostrando un adattamento lineare (R 2 = 0,99) con una pendenza corrispondente a β = 0.75 Å-1 (0,94 c n -1).
Subscription Required. Please recommend JoVE to your librarian.
Discussion
In questo lavoro abbiamo dimostrato la fabbricazione di strutture nanogap utilizzando nanoskiving. Questo metodo sperimentalmente semplice consente la produzione di nanostrutture al ritmo di circa uno al secondo, con controllo su tutte e tre le dimensioni. Il divario di dimensioni è definita da incorporare entrambi gli strati sacrificali di alluminio e argento o monostrati auto-assemblati di ditioli (che offre una risoluzione piccolo come una). Le nanostrutture possono essere posizionati a mano su qualsiasi substrato arbitrarie e sono direttamente indirizzabili elettricamente, che è una proprietà unica di nanoskiving. Questa tecnica produce anche strutture altamente uniformi, tuttavia, sezioni molto sottili (<50 nm) sono sensibili a vibrazioni che alterano lo spessore delle singole strutture. La qualità del coltello di diamante, che è la parte più importante della nanoskiving, è fondamentale per ottenere fili continui. Piccole scheggiature nel risultato coltello nei punteggi nelle sezioni di finale, mentre le scalfitture significativinel coltello producono fili rotti. Esempio di montaggio e l'allineamento del bordo coltello con la superficie del blocco richiede una certa pratica, ma la tecnica richiede addestramento speciale o abilità e il processo di nanofabbricazione si svolge interamente sul banco, al di fuori di una stanza pulita.
Subscription Required. Please recommend JoVE to your librarian.
Disclosures
Nessun conflitto di interessi dichiarati.
Acknowledgments
Questo lavoro è parte del programma Solar comune (JSP) di Hyet solare e la Stichting voor Fundamenteel Onderzoek der Materie FOM, che fa parte dei Paesi Bassi Organizzazione per la ricerca scientifica (NWO).
Materials
| Name | Company | Catalog Number | Comments |
| Reagent/Material | |||
| Epofix epoxy resin | Electron Microscopy | 1232 | |
| Sciences | |||
| Gold | Schone Edelmetaal B.V | ||
| Aluminum | Umicore Materials AG | ||
| Silver | Umicore Materials AG | ||
| (tridecafluoro-1,1,2,2, | ABCR GmbH co.KG | 78560-45-9 | |
| -tetrahydrooctyl) | |||
| trichlorosilane | |||
| ,12-dodecanedithiol | Home-synthesised | According to: Akkerman et. al., Nature. 441, 69-72 (2006) | |
| ,14-tetradecanedithiol | synthesized in house | According to: Akkerman et. al., Nature. 441, 69-72 (2006) | |
| ,16-hexadecanedithiol | synthesized in house | According to: Akkerman et. al., Nature. 441, 69-72 (2006) | |
| Equipment | |||
| Thermal deposition system | home-built | ||
| Ultramicrotome | Leica Microsystems | ||
| Dimanod knife ultra 35 | Diatome | DU3540 | |
| Dimanod knife ultra 45 | Scimed GMBH | ||
| Scanning electron microscope | JOEL | ||
| Source meter | Keithley | ||
| Table 1. Tables of Specific Reagents and Equipment. | |||
References
- Lipomi, D. J., Martinez, R. V., Whitesides, G. M. Use of thin sectioning (nanoskiving) to fabricate nanostructures for electronic and optical applications. Angew. Chem. Int. Ed. 50 (37), 8566-8583 (2011).
- Xu, Q., Rioux, R. M., Dickey, M. D., Whitesides, G. M. Nanoskiving: A new method to produce arrays of nanostructures. Acc. Chem. Res. 41 (12), 1566-1577 (2008).
- Xu, Q., Rioux, R. M., Whitesides, G. M. Fabrication of complex metallic nanostructures by nanoskiving. ACS Nano. 1 (3), 215-227 (2007).
- Reed, M. A., Zhou, C., Muller, C. J., Burgin, T. P., Tour, J. M. Conductance of a molecular junction. Science. 278 (5336), 252-254 (1997).
- Chen, W., Ahmed, H., Nakazoto, K. Coulomb blockade at 77 k in nanoscale metallic islands in a lateral nanostructure. Appl. Phys. Let. 66 (24), 3383-3384 (1995).
- Morpurgo, A. F., Marcus, C. M., Robinson, D. B. Controlled fabrication of metallic electrodes with atomic separation. Appl. Phys. Let. 74 (14), 2084-2086 (1999).
- Paska, Y., Haick, H. Systematic cross-linking changes within a self-assembled monolayer in a nanogap junction: A tool for investigating the intermolecular electronic coupling. J. Am. Chem. Soc. 132 (6), 1774-1775 (2010).
- Park, J., Pasupathy, A. N., Goldsmith, J. I., Chang, C., Yaish, Y., Petta, J. R., Rinkoski, M., Sethna, J. P., Abruna, H. D., McEuen, P. L., Ralph, D. C. Coulomb blockade and the kondo effect in single-atom transistors. Nature. 417 (6890), 722-725 (2002).
- Nagase, T., Kubota, T., Mashiko, S. Fabrication of nano-gap electrodes for measuring electrical properties of organic molecules using a focused ion beam. Thin Solid Films. 438-439, 374-377 (2003).
- Kubatkin, S., Danilov, A., Hjort, M., Cornil, J., Brédas, J. -L., Stuhr-Hansen, N., Hedegård, P., Bjørnholm, T. Single-Electron Transistor of a Single Organic Molecule with Access to Several Redox States. Nature. 425 (6959), 698-701 (2003).
- Notargiacomo, A., Foglietti, V., Cianci, E., Capellini, G., Adami, M., Faraci, P., Evangelisti, F., Nicolini, C. Atomic force microscopy lithography as a nanodevice development technique. Nanotechnology. 10 (4), 458-463 (1999).
- Qin, L., Park, S., Huang, L., Mirkin, C. A. On-wire lithography. Science. 309 (5731), 113-115 (2005).
- Hatzor, A., Weiss, P. S. Molecular rulers for scaling down nanostructures. Science. 291 (5506), 1019-1020 (2001).
- Pourhossein, P., Chiechi, R. C. Directly addressable sub-3 nm gold nano-gaps fabricated by nanoskiving using self-assembled monolayers as templates. ACS Nano. 6, 5566-5573 (2012).
- Lipomi, D. J., Ilievski, F., Wiley, B. J., Deotare, P. B., Lončar, M., Whitesides, G. M. Integrated fabrication and magnetic positioning of metallic and polymeric nanowires embedded in thin epoxy slabs. ACS Nano. 3 (10), 3315-3325 (2009).
- Mays, R. L., Pourhossein, P., Savithri, D., Genzer, J., Chiechi, R. C., Dickey, M. D. Thiol-containing polymeric embedding materials for nanoskiving. Journal of Materials Chemistry C. , (2013).
- Thuo, M. M., Reus, W. F., Nijhuis, C. A., Barber, J. R., Kim, C., Schulz, M. D., Whitesides, G. M. Odd-even effects in charge transport across self-assembled monolayers. J. Am. Chem. Soc. 133 (9), 2962-2975 (2011).
- Song, H., Kim, Y., Jeong, H., Reed, M. A., Lee, T. Coherent Tunneling Transport in Molecular Junctions. J. Phys. Chem. C. 114 (48), 20431-20435 (2010).
- Wang, W. Y., Lee, T., Reed, M. A. Mechanism of Electron Conduction in Self-Assembled Alkanethiol Monolayer Devices. Phys. Rev. B. 68 (3), 035416 (2003).
- Weiss, E. A., Chiechi, R. C., Kaufman, G. K., Kriebel, J. K., Li, Z., Duati, M., Rampi, M. A., Whitesides, G. M. Influence of defects on the electrical characteristics of Mercury-Drop junctions: Self-Assembled monolayers of n- Alkanethiolates on rough and smooth. 129 (14), 4336-4349 (2007).



