Summary
テンプレートとしてアルミニウムや銀または自己組織化単分子膜の犠牲層のいずれかを使用して、単一ナノメートルのギャップによって分離され、電気的にアドレス可能な、高アスペクト比(> 1000:1)金属ナノワイヤの製造が記載されている。これらのナノギャップ構造はnanoskivingとして知らエッジリソグラフィの形によってクリーンルームまたは任意の写真や電子ビームリソグラフィ工程なしで製造される。
Abstract
そこに管理された間隔でナノギャップを製造する方法はいくつかありますが、二つの電極と実用的でそれらを生成する間に、サブナノメートルの間隔を正確に制御それでも挑戦量が-です。エッジリソグラフィの一形態であるnanoskivingを使用してナノギャップ電極の製造は、高速、シンプルかつ強力な手法です。この方法では、任意の写真や電子ビームリソグラフィのステップが含まれていないと、クリーンルームなどの特別な機器やインフラストラクチャを必要としない、完全に機械的なプロセスである。 Nanoskivingは、すべての三次元の制御に電気的にアドレス可能なナノギャップを製造するために使用され、これらの構造の最小寸法は、犠牲層(Al又はAgの)又は自己組織化単分子膜の厚さによって規定される。これらのワイヤは、手動で水の滴にそれらを輸送して位置決めし、直接電気的にアドレス可能であることができる;それ以上のリソグラフィにそれらを接続する必要はありませんエレクトロ。
Introduction
本論文では、ギャップのために犠牲スペーサ層>アルカンジチオールの5 nmおよび自己組織化単分子膜(SAMの)などの真空蒸着アルミや銀を使用して単一のナノメートルのギャップによって分離され、金の電気的にアドレス、高アスペクト比のナノワイヤーの製造を説明します1.7 nmのような小さなギャップのために。私たちは、ウルトラミクロトームを用いた犠牲スペーサー、nanoskivingとして知らエッジリソグラフィの形で区切ら金の切片サンドイッチ構造によりクリーンルームまたはフォトリソプロセスなく、これらのナノ構造を作製した。1-3この方法は、薄い金属の堆積の組み合わせです映画やウルトラミクロトームを用いて切片。 nanoskivingの主なステップは〜30 nmのと同じくらい薄いスラブを生成する水の完全なボートに接続されているダイヤモンドナイフを装備ウルトラミクロトームで薄片をスライスされています。 Ultramicrotomesは、光学や選民とイメージングのための薄いサンプルの調製に広く使用されていますロン顕微鏡と超薄の中で最も経験の専門家の多くは、生物学的または医学的背景から来る。機械的なブレイク接合、4電子ビームリソグラフィ5、電気めっき、6,7エレクトロ、8集束イオンビームリソグラフィ、9シャドウ蒸着、10走査プローブおよび原子間力顕微鏡、11線リソグラフィを含む製造するナノギャップのいくつかの方法があります。 、12、分子定規13これらのメソッドはすべて自分の特性とアプリケーションを持っていますが、便利な数字で、ギャップの大きさを正確に制御して、両方のナノギャップを生成し、対処が課題である。加えて、これらの方法は、高い運用コストを有し、それらは、エッチング工程に耐えることができる材料のクラスに制限されており、解像度が制限される。 Nanoskivingはspacinと電気的にアドレス可能ナノワイヤの迅速な製造を可能にベンチトップ上の単一のナノメートルのGS。我々は、ナノ製作電極は特殊なまたは、時間のかかる技術を必要としないため、分子エレクトロニクスのためのナノ構造のラピッドプロトタイピングに興味を持っている、14のブロックが作られた後、それが(シリアル)、ナノ構造の数十万を生成することができます需要。しかし、この技術は、SAMの分子エレクトロニクスまたはこれらに限定されないであり、2つのナノ構造体との間の隙間を調製するための一般的な方法である。本稿では、金ナノワイヤーの間に様々な大きさのギャップを生成するために、銀、アルミニウム、犠牲層としてのSAMを使用するが、手法(または金属ナノワイヤに)これらの材料に限定されるものではない。ワイヤは、ピックアンドプレースであり、磁気整列と互換性があり、したがって、それらは任意の基板上に配置することができます。nanoskiving 15のもう一つの強みは、それはすべての3つの次元の制御を与えることです。試料の寸法は、基板のトポグラフィ(X)によって決定される堆積膜(Y)およびウルトラミクロトーム(Z)によって生成されたスラブの厚さの厚さを、図1に定義された間隔でナノワイヤを製造するために使用される手順をまとめたものである。ゴールド特徴(長さ1〜2 mm)をシリコン基板上にテフロン(登録商標)マスクを介して蒸着によって堆積される。 Epofix(電子顕微鏡科学)はエポキシプレポリマーエポキシ樹脂を硬化させたときに、金の機能をカバーし、全体のウェハ上に注がれ、エポキシ樹脂は、ウエハ(テンプレート経由つまりストリッピング)から分離され、金の特徴は、エポキシに付着したまま。金機能上500μmの - 金属犠牲層は、アルミニウムや銀が200のオフセットとテフロンマスクを介して所望の厚さで蒸発させる。サブ5nmのギャップを生成するために、SAMを一晩適切なジチオール、1mMのエタノール溶液中の金の機能を浸漬することによって形成される。金(または他の金属)の第二のセットは、テフロン(登録商標)上でシャドーマスクを配置することによって堆積される金の特徴(銀、アルミニウムまたはSAMで覆われ)の第一層200のオフセット - 最初の蒸発に関しては500μm。このオフセットは、最終的には間隙の最長寸法を定義し、それは正確に区画するエポキシ樹脂で全体の構造を埋め込む前に、マイクロ定規を用いて測定することができる。次いで、全体の構造は、その後、ウルトラミクロトームで切片化のための準備かもしれないエポキシ樹脂のブロックに埋め込まれている。サンプルアームは、スラブの厚さを定義する制御のステップでそれに向かってダイヤモンドナイフの進歩として調製ブロックを保持しています。結果のセクションでは、ボートに乗って水に浮く。
Subscription Required. Please recommend JoVE to your librarian.
Protocol
1。セクショニング用ブロックの調製
- 30秒間きれいな空気プラズマにおける技術グレード3 "シリコンウェハを治療した後、一時間(デカ-1、1,2,2、 -テトラヒドロ)トリクロロシランの蒸気にさらさ注:このステップでは、前に必要であるシリコンウェーハに付着するのを防止するために、エポキシ工程1.4。
- 前処理されたシリコン上に、テフロン(登録商標)マスタ(0.5ミリメートル、1ミリメートル、または1.5ミリメートル、得られたワイヤの長さを定義している)を介して(通常、100nmの厚さ、線の幅を定義する)、金の層を堆積させるウェハ。
- Epofixエポキシプレポリマーの約8.5ミリリットルでウェハ全体をカバーし、60℃で3時間硬化℃で
- 慎重に金が硬化エポキシに添付残るようウェハからエポキシ樹脂を剥離することにより金層をテンプレートストリップ。からエポキシ層はがし優しくその後シリコンウェハとエポキシの間の界面にカミソリの刃の先端を挿入し、シリコンウェーハ。金特長は、エポキシに付着したままフッ素シリコンウェハに金の接着不良(ステップ1.1)のために注意:シリコンウェハを壊さないように注意してください、そうでなければシリコン粒子は、切片のステップでダイヤモンドナイフを損傷します。
- 同じテフロンマスクは金の特徴を振り返っ置かれますが、横方向に金機能の最短寸法の約80%で、オフセットとテフロンマスターを通してアルミニウムや銀の層を堆積される。この層の厚さは、金ナノワイヤ間のギャップの間隔を定義する。下限は、金属に依存しますが、層が不連続になるアルミニウムと銀〜5nmで、その下にある注:これは、オフセット、最終的に2つの金電極間の重なりの長さを定義しますと、あなたは、マイクロ定規でそれを測定することができます。
- 浸しアルカンジチオール1mMの溶液中のエポキシでテンプレート最低限金:5 nm以下のギャップのために(ジスルフィドの自発的形成を軽減するために)を窒素でパージする密閉チャンバー中で一晩(またはエポキシ樹脂を膨潤しない任意の溶媒)エタノールである。 (本稿では3 nm以下の様々な幅のギャップを生成する1,12 - dodecanedithiol、1,14 - tetradecanedithiolまたは1,16 - hexadecanedithiolを使用しています。)SAM形成からテンプレート剥奪金オンエポキシ基板を取り外すソリューション。エタノールでそれをすすぎ、2分間60℃乾燥前窒素で乾かしてください。
- SAMを使用している場合は、エポキシ基板上にテフロンマスクを後ろに置くが、横方向に金の特徴の最短寸法の約80%により一部相殺された。金属を使用する場合は、マスクは、ステップ1.5後の位置に既にあるので、アルミニウムや銀の析出後のマスクの位置を変更しないでください。
- 金の第二の層またはマスクを介して任意の他の金属を堆積させる。この層は、典型的には、(ここでは厚さ100nm)と第厚さで同じ金属から構成される。
- 削除するテフロンマスクは、壊れたナノワイヤになり、これの機能を傷つけないように注意しながら。
- Epofixプレポリマー(〜8.5ミリリットル)で基板全体を再埋め込み、60で少なくとも3時間のためにそれを治す。
- 宝石商の鋸(〜4×10ミリメートルの部分に)を用いて機能をカットし、ポリエチレン''''棺ミクロトーム型に別々のウェルにそれぞれを配置。
- Epofixプレポリマーと金型を記入し、60℃で一晩それを治す
2。セクショニング
- ポリエチレンモールドからブロックを削除し、サンプルホルダーにマウントします。
- トリミングアタッチメントに試料ホルダーを取り付け、ウルトラミクロトームでそれをマウントします。
- 潤滑剤と金属片を除去し、ウルトラミクロトームのステレオスコープの下にカミソリの刃のエッジを検査するためにエタノールでかみそりの刃を清掃してください。残りのフラグメントは切片中にダイヤモンドナイフを損傷します。ダイヤモンドナイフ(Wの幅にブロックをトリミングE(それは切片のために最も安定した形状であるため)台形形状に)2mm以上4ミリメートルDiatomeウルトラ35°を使用注:一部ultramicrotomesはカッティングアームにマウントトリミングアタッチメントを使用していますが、私たちは、かみそりの刃でより良い結果を達成。
- ブロックの一面の下端に平行ガラスナイフの刃の位置を合わせます。
- ブロックの一面に滑らかな表面を定義するためのガラスナイフを装備ウルトラミクロトーム(我々はライカEMUC-6を使用)であらかじめカット開始。
- ダイヤモンドナイフでガラスナイフを交換、金属構造物を製造するには、それを再調整し、1ミリメートル/秒または0.6ミリメートル/秒で50 nmの100 nmのいずれかにセクションブロック。 。Epofixセクションはダウン〜30nmでノートに安定しています:セクションの厚さの容易な検証は、厚さの関数として予測可能な変動や使用されている樹脂に依存していない彼らの色であり、リファレンスカードが利用可能です。 16 電気のためにインプラ(SEM)またはSiO2の(にパーフェクトループ(電子顕微鏡の科学)を使用して個別にどちらかナイフの貯水池の水の表面から構造を含有するエポキシセクションを収集したり、いくつかのセクションのリボンとして測定)水面下の基板を置き、ゆっくりとそれを高めることによって基板。
- 基材への密着性を向上させるために3時間60℃で切片を乾燥させる。
- 灰エポキシに、酸素プラズマにサンプルを公開する(1ミリバールで15分間100又は50nmの厚さの切片から、エポキシの全ての痕跡を除去するのに十分である) 注:電気的測定のためのナノ構造体を作製する場合は、このステップでなければなりませんステップ4の後に行った。
3。犠牲層をエッチング
- アルミニウム:場所2時間のHCl 2 M水溶液中のアルミニウムを含むセクション。銀の場合:10、酸素プラズマにセクションを公開分注:材料の選択のいずれかウェットエッチング(HClを用いて)またはドライエッチング(酸素プラズマを使用して)ことができ、しかし、銀も同様にウェットエッチングにより除去することができる。
- SAMの場合:プラズマ処理は、部分的にSAMのをエッチングするが、我々はどの程度に特徴づけるための私達の努力で成功していない。
4。電気測定
- 徹底的に洗浄(pirañaソリューションを使用してなど )と(ステップ2.7および2.8)、それらを乾燥されたSiO2の基板の上に置いてエポキシセクション。
- 光学顕微鏡またはウルトラミクロトームに取り付けるステレオスコープの下に基板を取り付けます。
- 各セクション内の電線の両端に銀ペースト(またはカーボンインク)の滴を適用します。これらの埋め込まれた金属構造のいずれか黒い線(ゴールド/エポキシインターフェースから)または、厚い金構造(堆積工程から)の場合には、直接目に見えるように表示されます。いずれの場合も、液滴が適用されなければならない十分遠い中心部からナノギャップショートへ。
Subscription Required. Please recommend JoVE to your librarian.
Representative Results
アルミニウムと銀:私たちは、スペーサーとして2つの金属の犠牲層を組み込むことによって、ナノギャップ構造を用意しました。我々は、目的の厚さのギャップを取得するために、これらの層をエッチングする。として我々はHCl水溶液に酸素プラズマに銀を含む構造体、およびそれらを含有するアルミニウム暴露切片後、プロトコルのセクションで説明し、図2は、ナノメートルスケールの分離を生じナノワイヤの走査型電子顕微鏡写真(SEMの)を示しています。どちらの場合も、ギャップがはっきりと見えるし、直接測定可能である。 dodecanedithiol(SC12S)、1,14 - tetradecanedithiol(SC14S)と1,16 - hexadecanedithiol(SC16S) - 3 nm以下のギャップを得るために、我々は、1,12のSAMのを使用していました。対応する長SEMを図3に示す。これらの分子によって形成される隙間がはっきりと見えるあり、それは、ギャップの大きさは分子の長さが増加するにつれて増加することは明らかである。その延長されたコンフォメーションにおけるこれらの分子の長さ(最小化AM1)はsが、次のとおりです。2.17(SC16S)、1.97(SC14S)と1.70 nmの(SC12S)。これらの分子はテンプレートとして使用する場合、我々はギャップ幅は〜30°金で法線から傾いている分子の金とバックボーンの表面によって形成された三角形の斜辺であることが予想されます。しかし、SEMの解像限界に起因し、ギャップ幅の直接測定が不可能である、このように我々は、'' <4 nmのようにこれらのギャップにラベルを付ける。''私たちは、STM、AFMとCP-AFMによってギャップをイメージしていますしかし、すべてのケースで我々はギャップの幅を解決することができませんでした。したがって、我々は間接的に電気的測定を行うことによってギャップサイズを測定した。これらの測定値を達成するために、我々は切片を作成し、プロトコルの項で説明したように銀ペーストを適用した。我々はEGAINの小滴(およびプローブを接地)を使用してタングステンプローブに晶のGaイン(EGAIN)と他のパッドの鋭い先端をシリンジに一つのパッドを接続。 SAM鋳型の隙間のデータは、 図4にプロットされている。長Oとして予想通りF分子は、指数関数的に電流が減少を増加させます。この指数関数的減少は、分子がジャンクションで無傷であることを意味します。我々はシモンズ'近似、Jの形を使用したこの仮説を証明するために- J 0 電子Dβdはトンネル障壁の厚さで、J 0を d = 0でJの理論値であり、βは特性トンネル崩壊であり、その接合(又は炭素数n c)に幅の関数としてLN Jの線形近似から抽出することができる。アルカンバックボーンのためにβの典型的な値は200から500 mVでA-1の範囲(0.71 -1.10 N C -1)にあり、電圧に弱く依存している。 図4の挿入図は17-20でLN Jの線形フィットですSC16S、SC14S、およびテンプレートSC12Sための500 mVに( 図4のデータから)対の長さ(A)構造をナノギャップ。このプロットの傾きから、βは、文献で 報告された値の範囲内にある= 113 A-1(0.94n C -1)、我々は、ギャップサイズが2.5オングストロームの分解能でこれらの分子によって定義され、電流と結論完全な分子のバックボーンを通過します。

図1。ナノギャップ構造を作製するために使用される手順の概略図。熱蒸発を介して、フッ素化シリコンウェハー上にテフロン(登録商標)シャドウマスクを介して堆積される金)まず層(厚さ100nm)、B)は、マスクを除去した後の全面シリコン、エポキシで覆われている。C)は 、エポキシ硬化後、それを金特徴が残るように、ウェハから分離されるエポキシ(テンプレート除去)に付着した。 SAMは、これらの金機能に形成されているD)テフロンマスク250のオフセットを有するSAM-覆われた金の特徴上に配置される- 500μmの金(または他の金属)の他の100nmの厚い層が堆積される。 注:金属の犠牲層(アルミニウムや銀)を用いた場合には、これらの金属は、最終的なギャップ幅を生成することが望ましい厚さを有する第2の堆積前に堆積されるE)マスクを除去し、得られた機能は、粗されている。宝石商の鋸で切断した後、ウルトラミクロトームで切片化するためにブロックを生成するためにミクロトーム金型内にエポキシ樹脂に埋め込まれている。
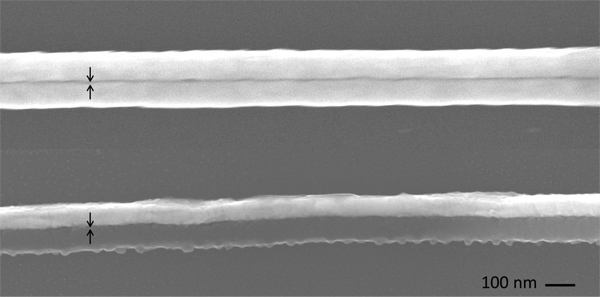
図2。ナノギャップの電子顕微鏡写真をスキャンすると目のようにアルミニウム(上)と銀(下)を使用して生産さ電子スペーサ。の周辺画像をHCl水溶液でアルミニウム層をエッチングすることによって製造さとの間のギャップを有する二つの金の層を示している。下部画像を酸素プラズマで銀層をエッチングすることにより製造ギャップを有する金とアルミニウムの二層を示す。ギャップは、どちらの場合もはっきりと見える。
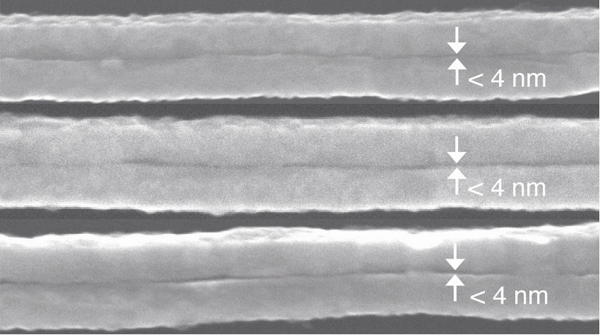
図3。酸素プラズマで有機物をアッシング後にテンプレートとして別のジチオールを用いて調製三つの異なるナノギャップ構造のギャップの走査電子顕微鏡写真を上から下へ:。生産ナノギャップ金の層の間の目に見えるギャップを見せるSC12S、SC14SとSC16Sを使用。ナノギャップは、分子の長さが増加として定性的に大きい。ギャップ幅の全ては、それらが'' <4波長としてラベル付けされているため、器具の解像限界(約4ナノメートル)以下である。 "
図4。三つの異なるジチオールから製造ナノギャップ構造に電流密度に対する潜在的なプロットをログに記録し、。SC12S(黒四角)、SC14S(赤い三角形)、およびSC16S(ブルーサークル)はめ込みがLNのプロット(J)対長さ(A) β= 0.75Å-1(0.94 N C -1)に対応したスロープの線形フィット(R 2 = 0.99)を示す500 mVで。
Subscription Required. Please recommend JoVE to your librarian.
Discussion
本稿ではnanoskivingを使ってナノギャップ構造の製造を実証した。この実験的に単純な方法は、すべての三次元の制御が、1秒に1回程度の速度でナノ構造体を製造することができる。ギャップサイズは、ジチオールのアルミニウム及び銀又は自己組織化単分子膜(オングストロームのような小さな分解能が得られるもの)のいずれかの犠牲層を組み込むことによって定義される。ナノ構造はnanoskivingのユニークな特性である、任意の基板上に手で配置し、彼らは直接、電気的にアドレス可能であることができます。また、この手法は、非常に均一な構造を生成するが、非常に薄い(<50 nm)の項では、個々の構造の厚さを変化させる振動に敏感である。 nanoskivingの最も重要な部分であるダイヤモンドナイフ、、の品質は、連続線を得ることが重要である。最終セクションのスコアの中でナイフ結果の小さな切り傷、しばらく重要ニックスナイフで壊れたワイヤを生産しています。ブロックの表面に取り付け、ナイフエッジの整列サンプルいくつかの練習が必要ですが、技術は、特別なトレーニングやスキルを必要とせず、微細加工プロセスはクリーンルームの外で、作業台の上に完全に行われます。
Subscription Required. Please recommend JoVE to your librarian.
Disclosures
利害の衝突は宣言されていない。
Acknowledgments
この作品はHyet太陽と科学研究費オランダ機構(NWO)の一部であり、開発元:Stichting voor Fundamenteel OnderzoekファンデMaterie FOM、共同太陽計画(JSP)の一部です。
Materials
| Name | Company | Catalog Number | Comments |
| Reagent/Material | |||
| Epofix epoxy resin | Electron Microscopy | 1232 | |
| Sciences | |||
| Gold | Schone Edelmetaal B.V | ||
| Aluminum | Umicore Materials AG | ||
| Silver | Umicore Materials AG | ||
| (tridecafluoro-1,1,2,2, | ABCR GmbH co.KG | 78560-45-9 | |
| -tetrahydrooctyl) | |||
| trichlorosilane | |||
| ,12-dodecanedithiol | Home-synthesised | According to: Akkerman et. al., Nature. 441, 69-72 (2006) | |
| ,14-tetradecanedithiol | synthesized in house | According to: Akkerman et. al., Nature. 441, 69-72 (2006) | |
| ,16-hexadecanedithiol | synthesized in house | According to: Akkerman et. al., Nature. 441, 69-72 (2006) | |
| Equipment | |||
| Thermal deposition system | home-built | ||
| Ultramicrotome | Leica Microsystems | ||
| Dimanod knife ultra 35 | Diatome | DU3540 | |
| Dimanod knife ultra 45 | Scimed GMBH | ||
| Scanning electron microscope | JOEL | ||
| Source meter | Keithley | ||
| Table 1. Tables of Specific Reagents and Equipment. | |||
References
- Lipomi, D. J., Martinez, R. V., Whitesides, G. M. Use of thin sectioning (nanoskiving) to fabricate nanostructures for electronic and optical applications. Angew. Chem. Int. Ed. 50 (37), 8566-8583 (2011).
- Xu, Q., Rioux, R. M., Dickey, M. D., Whitesides, G. M. Nanoskiving: A new method to produce arrays of nanostructures. Acc. Chem. Res. 41 (12), 1566-1577 (2008).
- Xu, Q., Rioux, R. M., Whitesides, G. M. Fabrication of complex metallic nanostructures by nanoskiving. ACS Nano. 1 (3), 215-227 (2007).
- Reed, M. A., Zhou, C., Muller, C. J., Burgin, T. P., Tour, J. M. Conductance of a molecular junction. Science. 278 (5336), 252-254 (1997).
- Chen, W., Ahmed, H., Nakazoto, K. Coulomb blockade at 77 k in nanoscale metallic islands in a lateral nanostructure. Appl. Phys. Let. 66 (24), 3383-3384 (1995).
- Morpurgo, A. F., Marcus, C. M., Robinson, D. B. Controlled fabrication of metallic electrodes with atomic separation. Appl. Phys. Let. 74 (14), 2084-2086 (1999).
- Paska, Y., Haick, H. Systematic cross-linking changes within a self-assembled monolayer in a nanogap junction: A tool for investigating the intermolecular electronic coupling. J. Am. Chem. Soc. 132 (6), 1774-1775 (2010).
- Park, J., Pasupathy, A. N., Goldsmith, J. I., Chang, C., Yaish, Y., Petta, J. R., Rinkoski, M., Sethna, J. P., Abruna, H. D., McEuen, P. L., Ralph, D. C. Coulomb blockade and the kondo effect in single-atom transistors. Nature. 417 (6890), 722-725 (2002).
- Nagase, T., Kubota, T., Mashiko, S. Fabrication of nano-gap electrodes for measuring electrical properties of organic molecules using a focused ion beam. Thin Solid Films. 438-439, 374-377 (2003).
- Kubatkin, S., Danilov, A., Hjort, M., Cornil, J., Brédas, J. -L., Stuhr-Hansen, N., Hedegård, P., Bjørnholm, T. Single-Electron Transistor of a Single Organic Molecule with Access to Several Redox States. Nature. 425 (6959), 698-701 (2003).
- Notargiacomo, A., Foglietti, V., Cianci, E., Capellini, G., Adami, M., Faraci, P., Evangelisti, F., Nicolini, C. Atomic force microscopy lithography as a nanodevice development technique. Nanotechnology. 10 (4), 458-463 (1999).
- Qin, L., Park, S., Huang, L., Mirkin, C. A. On-wire lithography. Science. 309 (5731), 113-115 (2005).
- Hatzor, A., Weiss, P. S. Molecular rulers for scaling down nanostructures. Science. 291 (5506), 1019-1020 (2001).
- Pourhossein, P., Chiechi, R. C. Directly addressable sub-3 nm gold nano-gaps fabricated by nanoskiving using self-assembled monolayers as templates. ACS Nano. 6, 5566-5573 (2012).
- Lipomi, D. J., Ilievski, F., Wiley, B. J., Deotare, P. B., Lončar, M., Whitesides, G. M. Integrated fabrication and magnetic positioning of metallic and polymeric nanowires embedded in thin epoxy slabs. ACS Nano. 3 (10), 3315-3325 (2009).
- Mays, R. L., Pourhossein, P., Savithri, D., Genzer, J., Chiechi, R. C., Dickey, M. D. Thiol-containing polymeric embedding materials for nanoskiving. Journal of Materials Chemistry C. , (2013).
- Thuo, M. M., Reus, W. F., Nijhuis, C. A., Barber, J. R., Kim, C., Schulz, M. D., Whitesides, G. M. Odd-even effects in charge transport across self-assembled monolayers. J. Am. Chem. Soc. 133 (9), 2962-2975 (2011).
- Song, H., Kim, Y., Jeong, H., Reed, M. A., Lee, T. Coherent Tunneling Transport in Molecular Junctions. J. Phys. Chem. C. 114 (48), 20431-20435 (2010).
- Wang, W. Y., Lee, T., Reed, M. A. Mechanism of Electron Conduction in Self-Assembled Alkanethiol Monolayer Devices. Phys. Rev. B. 68 (3), 035416 (2003).
- Weiss, E. A., Chiechi, R. C., Kaufman, G. K., Kriebel, J. K., Li, Z., Duati, M., Rampi, M. A., Whitesides, G. M. Influence of defects on the electrical characteristics of Mercury-Drop junctions: Self-Assembled monolayers of n- Alkanethiolates on rough and smooth. 129 (14), 4336-4349 (2007).



